曝光方式对负性光敏聚酰亚胺图形化的影响
张配荧, 尹玄文, 李 珍, 陆学民, 路庆华
(1. 上海交通大学化学化工学院, 上海 200240;2. 上海明士华新材料有限公司, 上海 201108;3. 同济大学化学科学与工程学院, 上海 200082)
光敏聚酰亚胺(Photosensitive Polyimide, PSPI)是先进芯片封装的关键材料,作为保留层在芯片封装中起到层间绝缘、应力缓冲和射线阻挡的作用,为了满足封装工艺要求PSPI还应具备光刻图形化功能[1-3]。PSPI的工作原理是在紫外光照射下树脂产生光化学反应,从而造成曝光区和非曝光区溶解度的差异,最终通过显影形成精确的设计图案。按照被曝光树脂溶解度的变化,PSPI光刻胶可分为正性光刻胶与负性光刻胶。正性光刻胶是曝光区的树脂发生分解从而向可溶性转变,曝光区域被溶解,获得和掩膜板一致的图案;负性光刻胶则相反,曝光区发生光交联反应,树脂从原来的可溶性转变为不溶性,显影时曝光区被保留下来,显影后形成和掩膜板互为凹凸结构的图案。PSPI负性胶(n-PSPI)由于留膜部分为光交联树脂,因此力学性能强、留膜率高,在大尺寸晶圆封装领域得到广泛应用。
将光活性基团(如甲基丙烯酸和肉桂酸等)通过酯键或离子型的方式引入到聚酰胺酸的分子链[4-6]或者通过化学键连接到可溶性PSPI的羟基或羧基的侧基[7]可制得n-PSPI光刻胶,也可以通过光酸(碱)剂在紫外光照射下形成酸或碱,在酸或碱催化下聚合物链段交联和异构化,从而改变其溶解性获得负性光刻胶图形[8,9]。在负性光刻胶中,丙烯酸酯化的聚酰胺酸光敏树脂是商业化最成功的一类n-PSPI光刻胶。
n-PSPI光刻胶由PSPI树脂、引发剂、助引发剂、交联剂、其他助剂和溶剂混合而成。负性光刻胶的图形化能力与光刻胶的配方(助剂的种类和用量)及光刻工艺(厚度、前烘温度或时间、曝光能量、显影条件等)密切相关。为了提高工作效率,工业上采用高功率(1 000~3 000 mW/cm2)、快扫描的步进式光刻机,每个曝光点的停留时间小于1 s;而实验室产品研发阶段一般采用接触式曝光机,高压汞灯的光强一般不超过30 mW/cm2。在n-PSPI光刻胶研制过程中我们发现:同一种光刻胶在相同的光刻工艺条件下,当采用不同的曝光机时,即使接受同样的曝光能量,也不具有相同的图形化能力。实验室最优的组成配方和最佳的工艺条件应用到步进式曝光机上不仅不能获得好的图形效果,甚至会发生“peeling”(漂胶)。这种现象给实验室成果的产业化应用带来了巨大的困难。为了寻找问题的症结,本文系统研究了使用不同引发剂的n-PSPI光刻胶分别在“高功率、短时间”和“低功率、长时间”两种曝光模式下的图形形成规律,分析了两种曝光模式下自由基的生成和扩散动力学机制,从而诠释了不同曝光模式下光刻胶图形化差异的原因和规律,为实现小试配方光刻胶向工业应用配方转型提供了理论指导。
1 实验部分
1.1 原料和试剂
N-甲基吡咯烷酮(NMP)、N,N-二甲基乙酰胺(DMAc)、γ-丁内酯、环戊酮、丙二醇甲醚乙酸酯(PGMEA)、甲醇(MT)、丙酮(CP)、异丙醇(IPA)、乙酸乙酯(EAC):分析纯,北京百灵威公司;3,3',4,4'-二苯醚二酐(ODPA)、4,4'-二氨基二苯醚(ODA):分析纯,天津众泰材料科技有限公司;甲基丙烯酸2-羟基乙酯(HEMA):分析纯,东京化成工业株式会社;光引发剂A(1-[4-(苯硫基)苯基]-1,2-辛烷二酮 2-(O-苯甲酰肟)):分析纯,巴斯夫公司;光引发剂B(苯甲酰甲酸甲酯):分析纯,北京百灵威公司。
1.2 设备与仪器
接触式光刻机:深圳市蓝星宇电子科技有限公司,URE-2000/35型;步进式光刻机:日本理光株式会社,NSR-1505 i7 a型;金相显微镜:上海舜宇恒平科学仪器有限公司,MXRT型;薄膜厚度分析仪:美国Filmetrics公司,F20型。
1.3 光刻胶制备
以ODPA和ODA为聚合物单体,参照文献[4]合成了PSPI树脂。然后将其和交联剂(SR-209,双缩乙二醇双甲基丙烯酸酚)、引发剂A(或引发剂B)、偶联剂(KH-570,γ-甲基丙烯酰氧基丙基三甲氧基硅烷)和溶剂NMP搅拌混合,其中引发剂、交联剂、偶联剂的添加质量分别为树脂质量的1.5%、15%、3%,溶剂NMP的质量则为树脂质量的2.125倍。将完全溶解的混合溶液进行压滤,除去不溶物,并在真空下脱泡得到光刻胶溶液。分别使用自由基产生速率不同的引发剂A和B制备n-PSPI,产物分别命名为PSPI-A和PSPI-B。
1.4 光刻工艺
取1 mL光刻胶滴在干净硅片表面,旋涂涂布得到厚度9~10 μm的光刻胶涂层,放置在110 ℃加热台上,烘2 min除去多余溶剂。然后在不同的光刻机上进行涂层曝光,不同的曝光机上使用的曝光剂量相同。将曝光的硅片放置在室温显影液中显影,并在淋洗液中定影。在显微镜下观察图形情况,并测定涂层的膜厚,通过显影前后膜厚变化计算留膜率(曝光区域显影后的膜厚与显影前的膜厚之比)。
2 结果与讨论
2.1 不同光强作用下自由基的形成和扩散动力学
图1为A和B两种光引发剂在紫外光激发下形成自由基的化学反应方程式。引发剂首先发生光分解形成过渡自由基,过渡自由基进一步分解为二氧化碳与甲基自由基(·CH3)。第一步反应为自由基生成速率的决定性步骤。由于引发剂A的裂解活化能较低,其自由基生成速率大于引发剂B。不同于溶液聚合,光引发剂分散在高分子涂层中,光引发生成的自由基会受到显著的“笼蔽效应”影响,即生成的自由基被高分子链包裹,导致自由基与自由基偶合的概率有所提高。Russell等[10]从理论计算上模拟了在“笼蔽效应”下自由基的生成速率,他认为引发剂分解形成自由基后会遭遇两种复合:在自由基生成后一个振动周期内(约10-18s)会发生“一级复合”,此时自由基存在时间小于自由基扩散位移时间(约10-11s),即“一级复合”发生在一个分子直径的距离内;“一级复合”实际上是引发剂裂解的逆反应。当自由基分开约一个分子的距离后,自由基“一级复合”的几率下降。此时的自由基游离和扩散,将发生“二级复合”,根据扩散距离的不同,可能出现几种复合方式,包括自由基的偶合终止和引发双键反应。图2列举了3种自由基的链引发和偶合终止反应,其中形成甲基丙烯酸酯自由基的反应可以引发双键之间的聚合,是一个有效的光引发自由基;而另外2个反应则使得自由基的偶合终止。
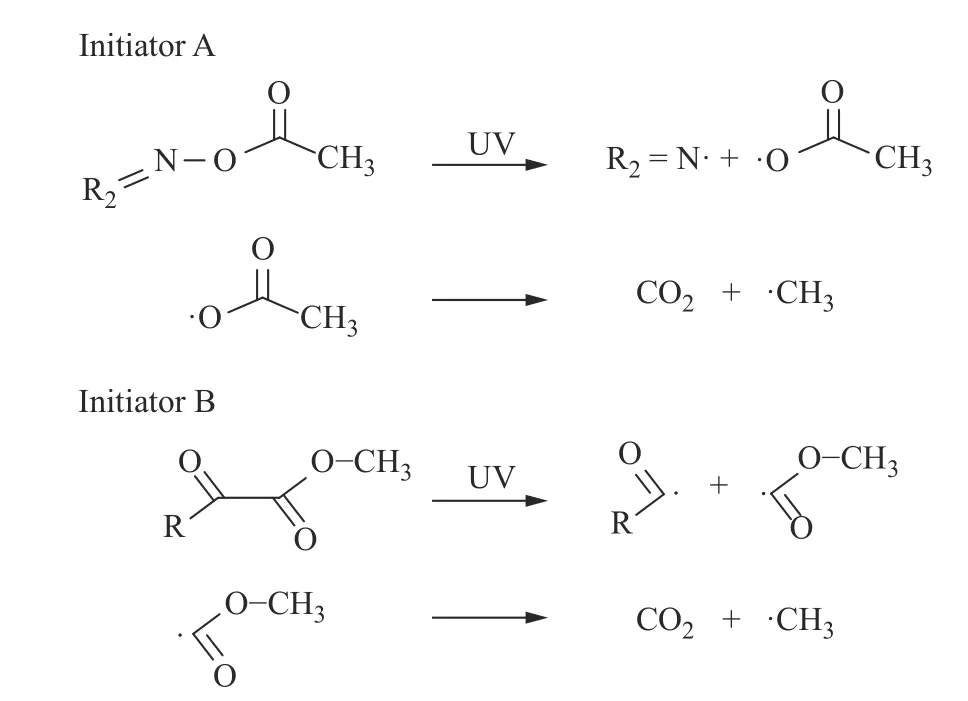
图 1 光引发剂A和B形成自由基的反应Fig. 1 Free radical formation of initiators A and B
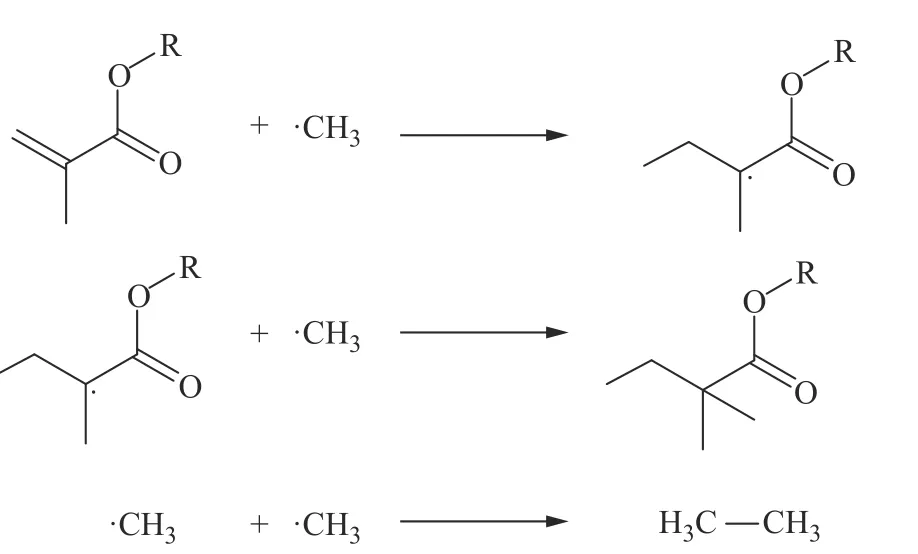
图 2 自由基的链引发和偶合终止反应Fig. 2 Chain initiation and coupling termination of free radicals
没有被“一级复合”的自由基继续扩散,其扩散距离与“二级复合”发生的时间成正比。在光引发的初期,聚合物上的甲基丙烯酸酯的双键和自由基的浓度都较高,引发聚合反应的概率较大。随着聚合反应的进行,双键和自由基的浓度下降,聚合反应的概率降低,自由基会继续向远处扩散,在新的区域引起聚合。另外,随着树脂交联程度增大,“笼蔽效应”也会使自由基扩散受到限制,最终发生偶合终止。对于弱光源来说,光的穿透深度有限,底部的薄膜没有足够的自由基生成,同时由于距离原因和“笼蔽效应”使得薄膜上层的自由基难以扩散抵达。因此,底部交联不充分,显影时出现漂胶现象,这就是工业应用中出现漂胶的原因。对于强光源来说,底部有足够的光引发自由基生成。多余自由基的扩散除了向纵深方向进行之外,也向水平方向进行,结果引起未曝光区域的部分交联,所以这种情形下会形成倒梯形状的光刻图案,甚至会发生过度交联、显影不净的问题,如图3所示。
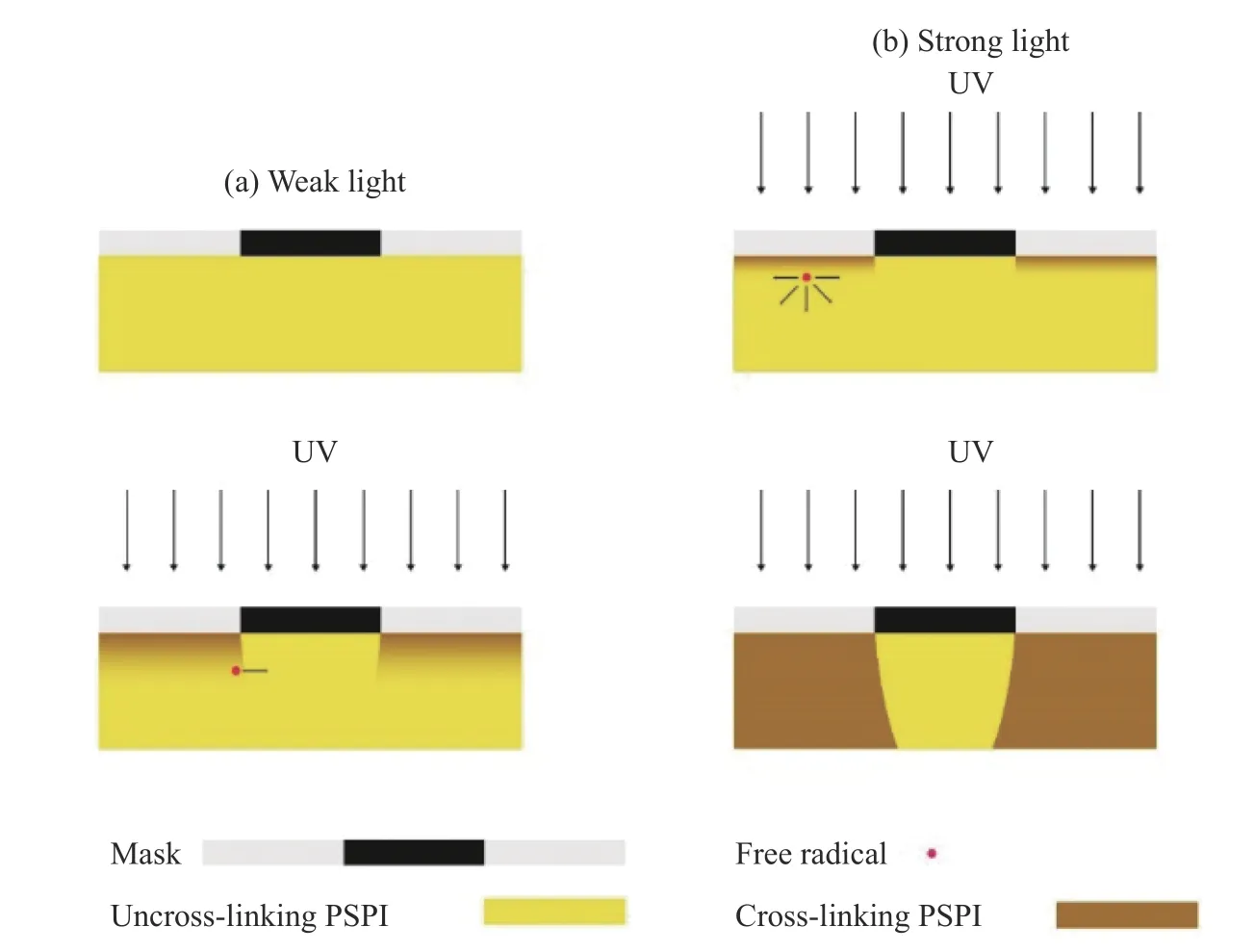
图 3 自由基的扩散对光刻图形的影响Fig. 3 Influence of free radical diffusion on photolithographic patterns
2.2 曝光模式对光刻图形化的影响与机制
结合Lambert-Beer定律,光引发自由基的生成速率(Ri)可以用式(1)表示[11]:

式中 ϕ表示光引发效率,即自由基的量子产率;I0表示光源辐射到涂层表面的光强度;ε和cM分别表示引发剂的摩尔吸光系数和浓度;l表示辐射光穿透薄膜的深度。由式(1)可见在引发剂用量一致的情况下,引发剂的光量子效率和辐射光源的光强对自由基的产生速率起到决定性的作用。
在其他光刻工艺不变的情况下,本课题组分别在两台不同方式的曝光机上进行光刻图形实验。将工业用步进曝光机(功率1 000 mW/cm2, 步进扫描方式,每点曝光停留时间约0.3 s)定义为“高功率、短时间”曝光模式(Mode Ⅰ),而一般实验室使用的接触式曝光机(功率15 mW/cm2,曝光时间20 s)定义为“低功率、长时间”曝光模式(Mode Ⅱ)。两种曝光模式的曝光量相同,均为300 mJ。图4给出了两种光刻胶分别在两种曝光模式下形成的光刻图形。对于PSPI-A来说,采用高功率、短时间的曝光模式,可获得清晰的图形,固化效果好(图4(a)),而使用低功率、长时间的曝光模式,图形化效果较差,存在明显的过度交联现象(图4(b))。相反,对于PSPI-B来说,采用高功率、短时间的曝光模式,尽管图形显影干净,但是曝光区的留膜率低(表1),薄膜出现干涉彩斑(图4(c)),且在开孔周围的树脂颜色有所不同,这是由树脂溶胀导致的。PSPI-B在低功率、长时间曝光的模式下,图形清晰,固化效果好(图4(d))。由以上结果可以得出:(1)实验室低功率下优化的PSPI光刻胶配方在工业曝光机上不能取得良好的图形化效果,反之亦然。(2)高功率曝光需要引发速率快的引发剂,而低功率曝光配合引发速率慢的引发剂才能获得良好的图形化效果。
由式(1)可知:高光强的光和引发速率快的引发剂组合,光辐射的厚度较深,上下表面同时产生较多的自由基,因此短时间内就可以引发薄膜上下快速交联,交联后的涂层反过来限制自由基的扩散,并发生耦合终止,因此可以形成良好的光刻图形(图4(a));低光强的光和引发速率快的引发剂组合,光强随着厚度方向指数级衰减,薄膜底部形成的自由基浓度较低,随着辐照时间延长,上层形成的自由基不断向下和向非光照区扩散,造成底部薄膜交联的同时邻近的非曝光区也部分交联,结果出现无法彻底显影干净而留下的底膜(图4(b))。对于高光强的光和引发速率慢的引发剂组合,尽管紫外光穿透深度厚,但是由于自由基产生速率慢,在步进扫描短暂的辐照时间内无法形成足够的自由基来完成树脂交联,因此,出现交联不充分,图形的留膜率低,且显影时出现曝光区的溶胀,造成图形的边缘发生钻刻(即溶剂钻入底层,导致形成的图形上宽下窄)(图4(c))。低光强的光和引发速率慢的引发剂组合,则有足够的时间引发自由基的形成,因此可以获得良好的光刻图形(图4(d))。

表 1 两种光刻胶分别在两种曝光模式、相同曝光量下的留膜率Table 1 Film retention rate of two photoresists in two exposure modes with the same exposure dose
2.3 调控曝光时间弥补交联不足或曝光过度改善图形质量的可行性
PSPI-A在低功率曝光模式下出现过度交联现象,我们将其曝光时间由20 s缩短到12 s,从而减小了自由基的扩散距离,尽管图形的底膜消失了,但是又出现树脂交联程度不足的问题,造成留膜率下降(留膜率为57%),且薄膜表面出现坑状缺陷(图5(a))。同样针对PSPI-B在高功率下无法完全固化、留膜率低的问题,我们在步进式曝光机上设定了4个区域,改变扫描速率,折算后的曝光时间分别为0.6 、1.2 、1.5 、1.8 s,发现树脂仍未完全交联,漂胶现象继续出现(图5(b)),原因是引发速率慢,延长曝光时间并不能提高自由基的形成速率,且交联后的聚合物限制了自由基扩散。因此,调控曝光时间不能解决交联不足与留膜率偏低的问题。可见对于引发剂的选择和曝光功率不匹配的体系,通过调控曝光时间并不能解决图形化质量的问题,所以引发剂和曝光模式的匹配是负性PSPI光刻胶开发过程中必须考虑的因素。
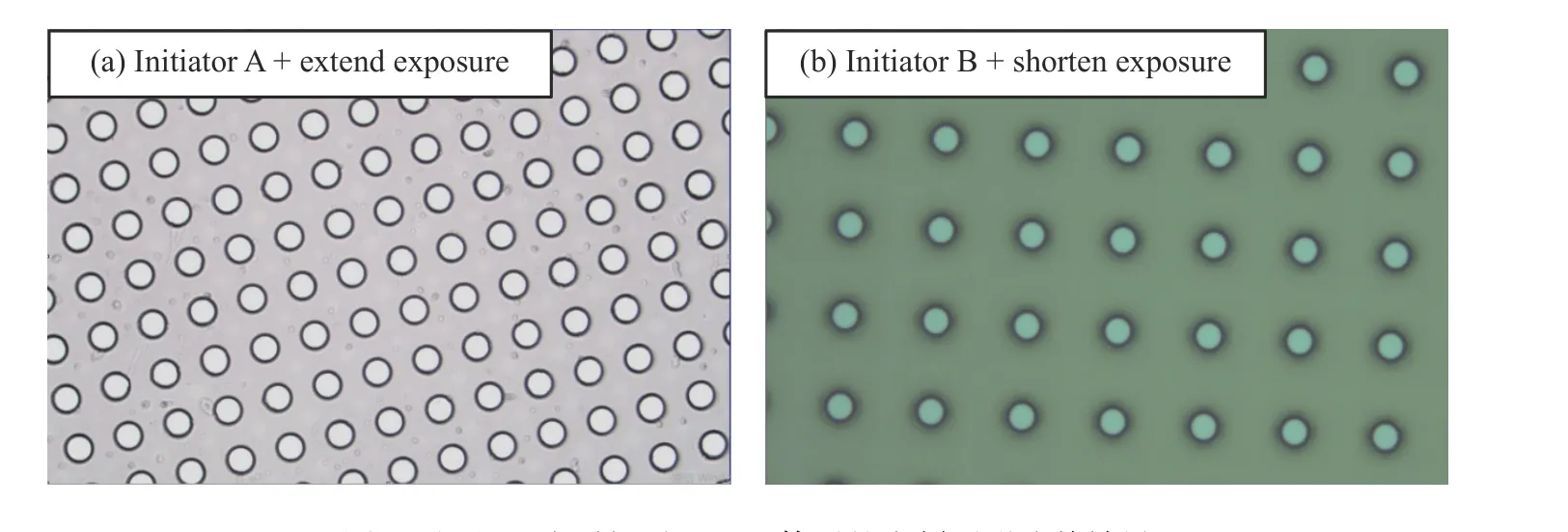
图 5 调整曝光时间对不匹配体系的光刻图形改善效果Fig. 5 Effect of adjusting exposure time on lithography pattern improvement for the mismatched systems
3 结 论
(1)从自由基产生和扩散动力学的角度,分析了不同引发剂体系的负性聚酰亚胺光刻胶在两种曝光模式下的图形化能力。
(2)工业用步进式光刻机的高光强和短时间的曝光模式,自由基扩散相对少,不容易形成光刻胶图形的底膜,但是会出现交联不足和漂胶现象,因此要求采用引发速率快的引发剂体系。
(3)实验室采用接触式曝光机的低能量、长时间的曝光模式,自由基容易扩散,容易出现底膜和留膜率不高的问题,因此,更适合使用引发速率慢的引发体系来获得理想的图形和留膜率。

