辐射效应易损性仿真能力建设的现状与展望
丁李利,王 坦,王晨辉,齐 超,吴 伟,陈 伟
(强脉冲辐射环境模拟与效应全国重点实验室;西北核技术研究所:西安710024)
电子器件辐射效应易损性是指辐射在电子器件中产生各类效应导致性能退化、功能异常、故障甚至损毁的概率或难易程度。随着空间技术、核技术与微电子技术的迅猛发展,越来越多的电子器件应用于辐射环境中,面临总剂量效应、位移损伤、单粒子效应及瞬时剂量率效应等威胁。为评价电子器件辐射效应易损性,仿真计算已成为重要手段之一。早在1962年,美国宾夕法尼亚大学首次通过计算分析认为宇宙射线会影响芯片的正常运行,10年后人们才首次在在轨运行的存储器中发现单粒子翻转(single event upset,SEU)[1]。1983年,美国圣地亚国家实验室(Sandia National Laboratories, SNL)通过对3 μm标准单元库的SPICE仿真,首次提出组合逻辑电路单粒子瞬态(single event transient,SET)的概念,还预测了SET可能是未来芯片的主要错误来源[2],这些仿真结果在随后的几十年里被证实。
随着电子器件在结构、尺寸、材料和电压等方面的不断变化,辐射效应和机理变得越来越复杂,各种影响因素间的相互耦合导致对辐射效应的响应变得难以估算,必须借助辐射效应易损性仿真软件和分析工具。
本文首先介绍电子器件辐射效应易损性仿真的基本流程;其次介绍电子器件辐射效应易损性分析软件的国内外发展现状;再次介绍本文作者团队取得的进展,重点介绍开发的瞬时辐射效应仿真软件TREES 1.0,TREES 2.0,SREES系列产品;最后展望了未来的发展方向。
1 基本流程
电子器件辐射效应易损性仿真的基本流程包括构建电子器件模型、引入辐射效应描述项、计算电子器件电学响应、甄别并记录效应现象及评估辐射效应易损性等。针对不同层次的电子器件模型,引入辐射效应描述项的方式存在明显差异,仿真分析中引入辐射效应描述项如表1所列。

表1 仿真分析中引入辐射效应描述项
结构体模型适用于粒子输运模拟,通常借助通用的蒙特卡罗软件,优点在于辐射粒子种类齐全,支持不同种类、能量、角度的粒子;数值仿真模型适用于器件级仿真,通常借助商用TCAD仿真工具,划分网格后求解载流子连续性方程、漂移扩散或流体动力学方程,利用数值方法研究器件内部载流子输运的微观过程,获取最底层晶体管内部载流子浓度、电势及电场强度等物理量分布。针对版图、网表、行为级描述等电子器件设计文件开展辐射效应易损性仿真时,通常需自行开发软件并编制辐射效应模型,定量构建辐射与扰动项之间的对应关系,自主开发或调用电路仿真或行为级仿真工具,实现计算电子器件电学响应、甄别并记录效应现象、评估辐射效应易损性的目的。
2 国内外发展现状
电子器件辐射效应易损性分析软件方面,美国开发了SEMM(soft error Monte Carlo model),MRED(Monte Carlo radiative energy deposition),Xyce等。
SEMM由IBM公司于1986年开发[3],第一代产品SEMM-1主要用于计算双极工艺电路SEU的敏感性,利用简化的结构体模型描述器件特征,只针对PN结电场区进行建模。假设辐射产生的过剩载流子基本不会改变器件中的电场分布,且直接入射的质子或中子核反应产生的重离子仅在径迹范围内沉积能量产生过剩载流子,记录每条穿越PN结电场区的径迹在对应节点沉积的电荷量,与预先设定的临界电荷数值进行对比,判定是否发生单粒子翻转。为适应对SEE更敏感的CMOS工艺电路,IBM于1996年报道了第二代产品SEMM-2,拓展了粒子输运模型的适用范围,可针对CMOS工艺电路中多层金属与钝化层组成的1维复合结构开展输运计算。图1为SEMM-2中典型晶体管的结构体模型示意图[4]。
MRED由美国范德堡大学团队于2010年首次报道[5],图2为MRED中入射质子在灵敏体积内沉积能量的示意图。MRED利用非常简化的平行六面体模型代表每个单元的灵敏体积,默认只有在灵敏体积内沉积的能量才可能引发SEE,优势在于能借助内嵌的粒子输运软件Geant4计算各种粒子在材料中的输运过程。
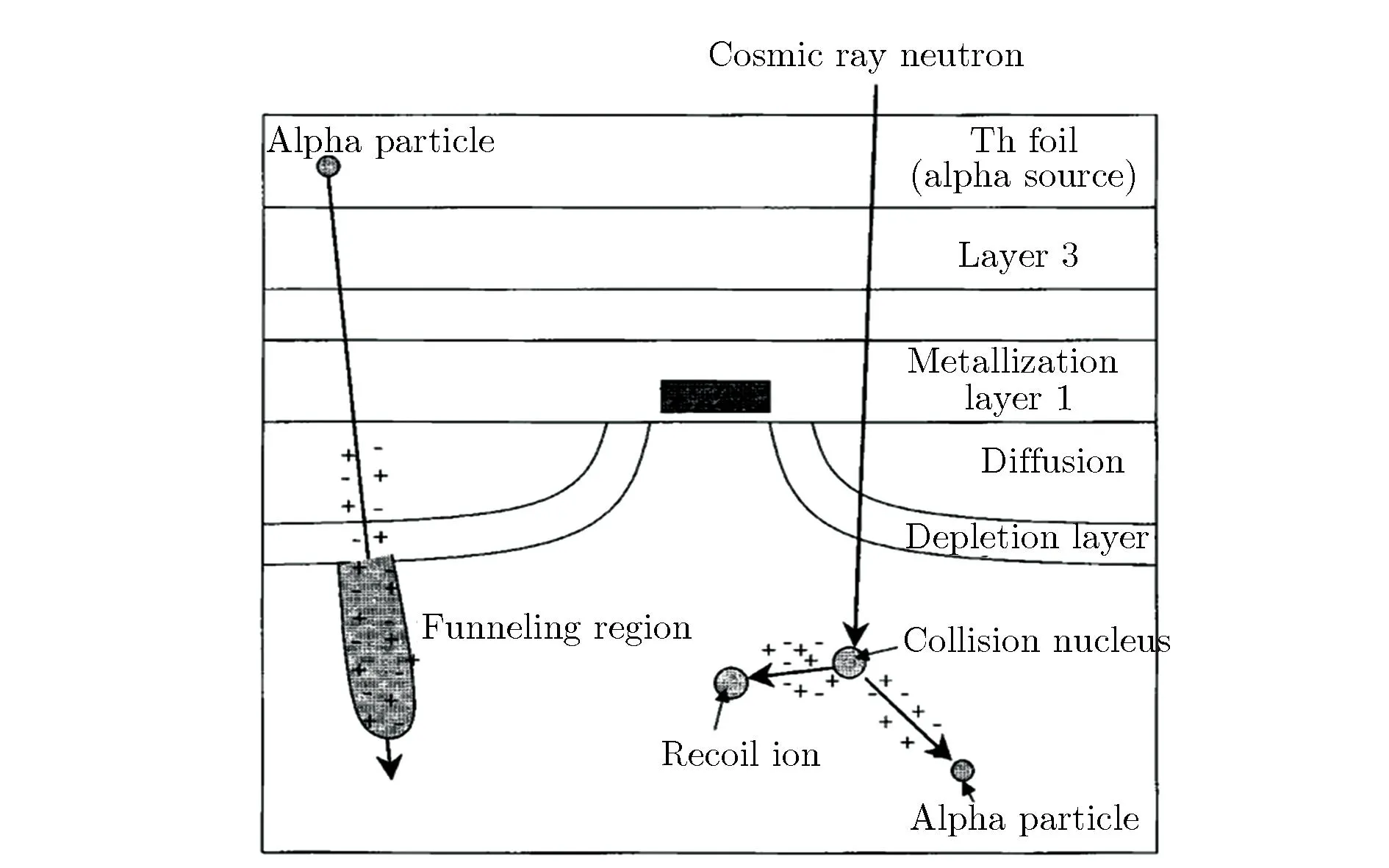
图1 SEMM-2中典型晶体管的结构体模型示意图[4]
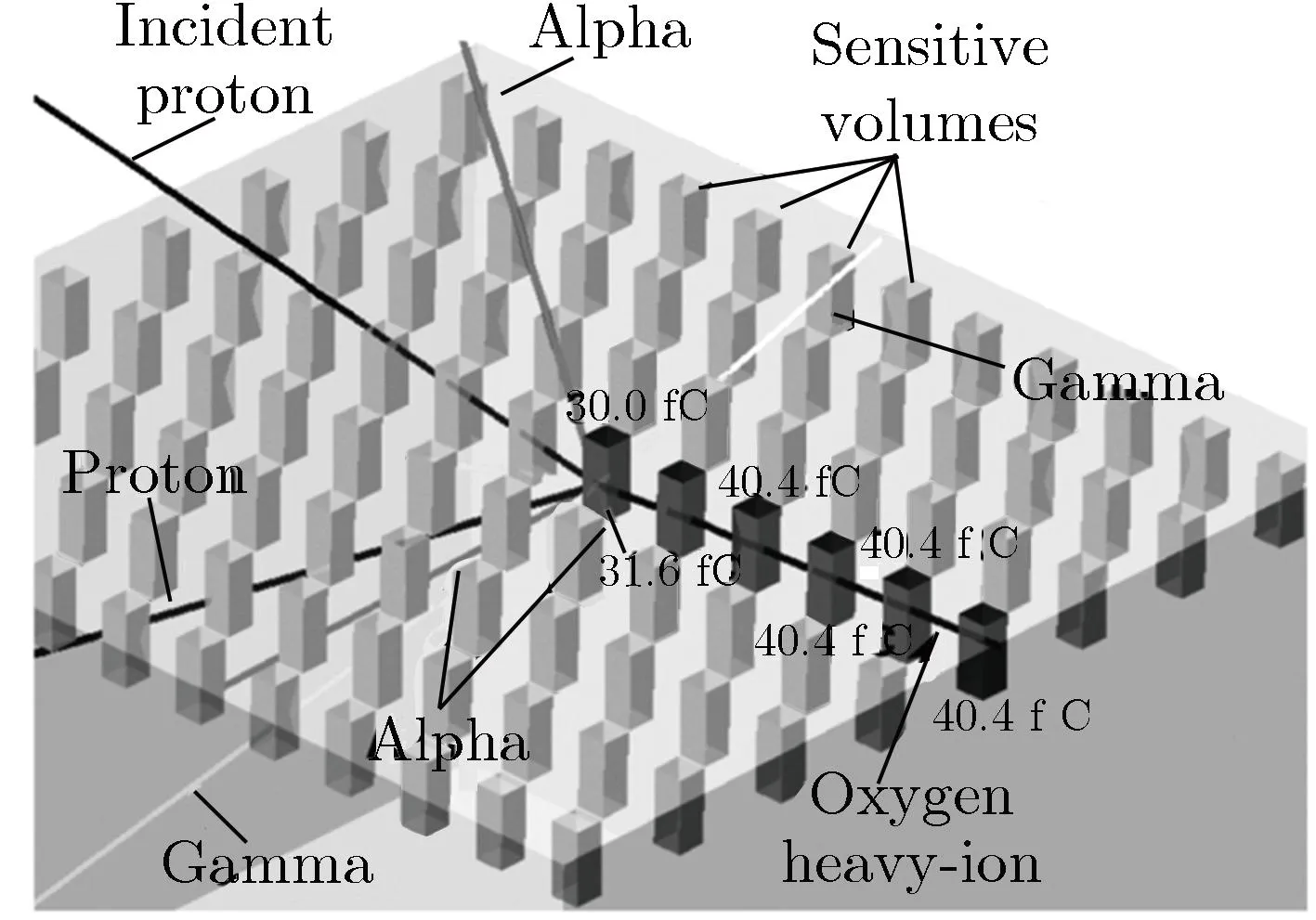
图2 MRED中入射质子在灵敏体积内沉积能量的示意图[5]
美国范德堡大学在2010~2020年发表的大量文章中给出了MRED的应用实例及模型更新,提出了复合灵敏体积的概念,用于更加准确地构建结构体模型,图3为MRED软件中利用实测单粒子效应截面数据构建复合灵敏体积结构体模型的示意图[6]。
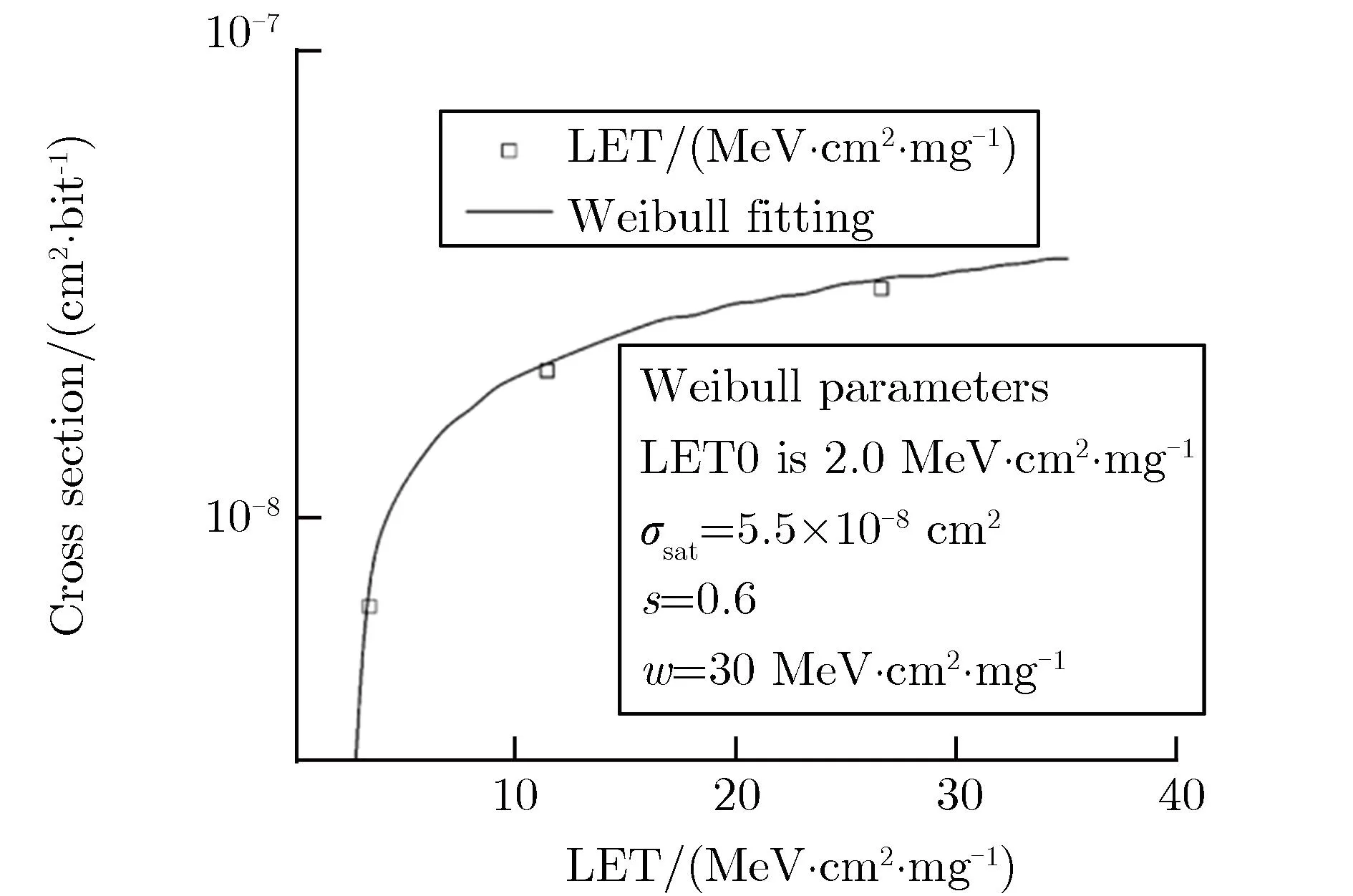
(a)SEE cross-section measurement results

(b)Arrangements of sensitive volumes in MRED
Xyce由SNL于1999年开始研发,主要目的是打造高速并行化电路仿真器,Xyce支持开展瞬时剂量率诱发的光电流注入仿真、瞬时中子诱发的位移损伤仿真,文献中报道了Xyce软件计算得到的差分放大器中考虑瞬时剂量率效应和位移损伤前后的电路输出信号[7],如图4所示。

(a)Before irradiation

(b)After irradiation by a pulse
法国、日本开发的相关软件也已多次见诸报道,在辐射效应易损性分析中发挥了重要作用。Multi-Scales Single Event Phenomena Predictive Platform (MUSCA-SEP3)软件由法国航空航天实验室于2009年首次报道,图5为MUSCA-SEP3计算单粒子效应敏感性的建模思路与计算流程[8]。与MRED相比,MUSCA-SEP3将处于反偏状态的漏区作为灵敏区域进行建模,每个单元中可能包含多个灵敏区域,灵敏区域的表面积等于漏区面积,深度代表耗尽区厚度,其结构体模型更加贴近实际版图。2009~2023年,欧洲多个科研机构联合法国航空航天实验室,利用MUSCA-SEP3软件计算了不同工艺节点存储器、SRAM型FPGA的单粒子效应敏感性,预测单粒子翻转与多位翻转的位图及敏感截面[9]。

图5 MUSCA SEP3计算单粒子效应敏感性的建模思路与计算流程[8]
Particle and Heavy Ion Transport code System (PHITS)-Hyper Environment for Exploration of Semiconductor Simulation (HyENEXSS)由日本九州大学于2012年报道[10],其主要思路是粒子输运与器件级仿真联合计算,首先借助PHITS代码计算不同类型粒子入射产生的次级重离子,其次将重离子LET分布转换为过剩载流子,随之将过剩载流子分布导入3维数值仿真模型,计算过剩载流子在电场作用下发生的漂移和扩散等电荷收集过程,获取最底层晶体管内部载流子浓度、电势及电场强度等物理量分布。PHITS-HyENEXSS软件的物理思路清晰,由于假设较少计算结果更加准确,其劣势在于数值仿真能够计算的器件规模非常有限,很难针对电路开展单粒子效应敏感性评价。图6为PHITS-HyENEXSS软件的计算流程[10]。

图6 PHITS-HyENEXSS软件的计算流程[10]
TFIT是法国IROC公司于2014年推出的单粒子效应敏感性评测软件,思路与Xyce类似,差异主要为针对单粒子效应而不是核辐射效应。通过在电路的敏感节点添加表征单粒子扰动项的瞬态电流源,执行电路仿真记录扰动项添加后的电路响应,即可判断是否发生单粒子翻转。
国内的相关研究中,电子芯片设计单位包括航天科技集团九院772所等采用双指数电流源评价单元电路的抗辐照性能[11],国防科技大学团队开发了0.13 μm CMOS体硅工艺的2维查找表模型[12],能够考虑实际电路中节点电压动态变化的影响,缺点为完全采用解析拟合的思路而忽略了电荷收集的实际物理过程,因此可拓展性存在不足。中国工程物理研究院构建了体硅二极管、BJT、MOSFET的瞬时剂量率效应单管模型,在线性稳压器和反相器链等电路中得到了应用,但未给出与实测数据的校验结果[13]。总的来说,现有研究的不足之处在于缺乏实测数据的校验,并且未能形成可推广应用的分析软件。
3 本文作者团队的研究进展
本文作者团队在辐射效应易损性仿真方面已开展了大量工作,所涉及的颗粒度包括结构体模型、数值仿真模型、版图、网表及系统级描述。针对如何构建电子器件模型、如何引入辐射效应扰动项、如何设定效应判据及判定计算结果是否准确等方面展开了系统研究。利用仿真手段,预测电子器件受不同类型辐射效应影响后发生性能退化、功能异常、故障甚至损毁的效应规律与失效阈值。
在基于数值仿真模型计算器件单粒子效应易损性方面,所开展的工作与日本PHITS软件类似,典型应用包括针对国产0.25 μm深亚微米30万门FPGA BQV300,实现了粒子输运与电场驱动下数值计算相结合的单粒子效应预测技术。图7为利用蒙特卡罗方法计算单粒子效应的模型与计算结果[14]。由图7可见,仿真结果与试验数据一致性较好。

(a)Model for Monte Carlo simulation method
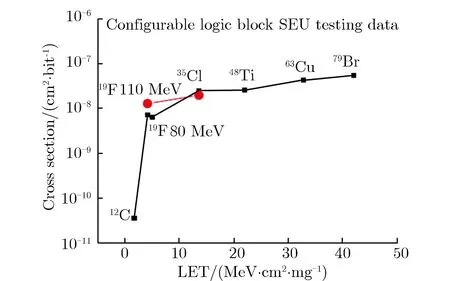
(b)Comparison of simulation and experimental results,with circles representing simulation results and blocks representing experimental results
基于结构体模型计算器件单粒子效应易损性方面,所达到的技术水平与美国MRED软件相近,典型应用包括开展40 nm商用SRAM中子诱发单粒子效应敏感性计算,可人为设定临界电荷值,灵敏区内收集电荷超过该阈值即判定发生单粒子翻转,图8为SRAM单元阵列结构体模型示意图[15]。
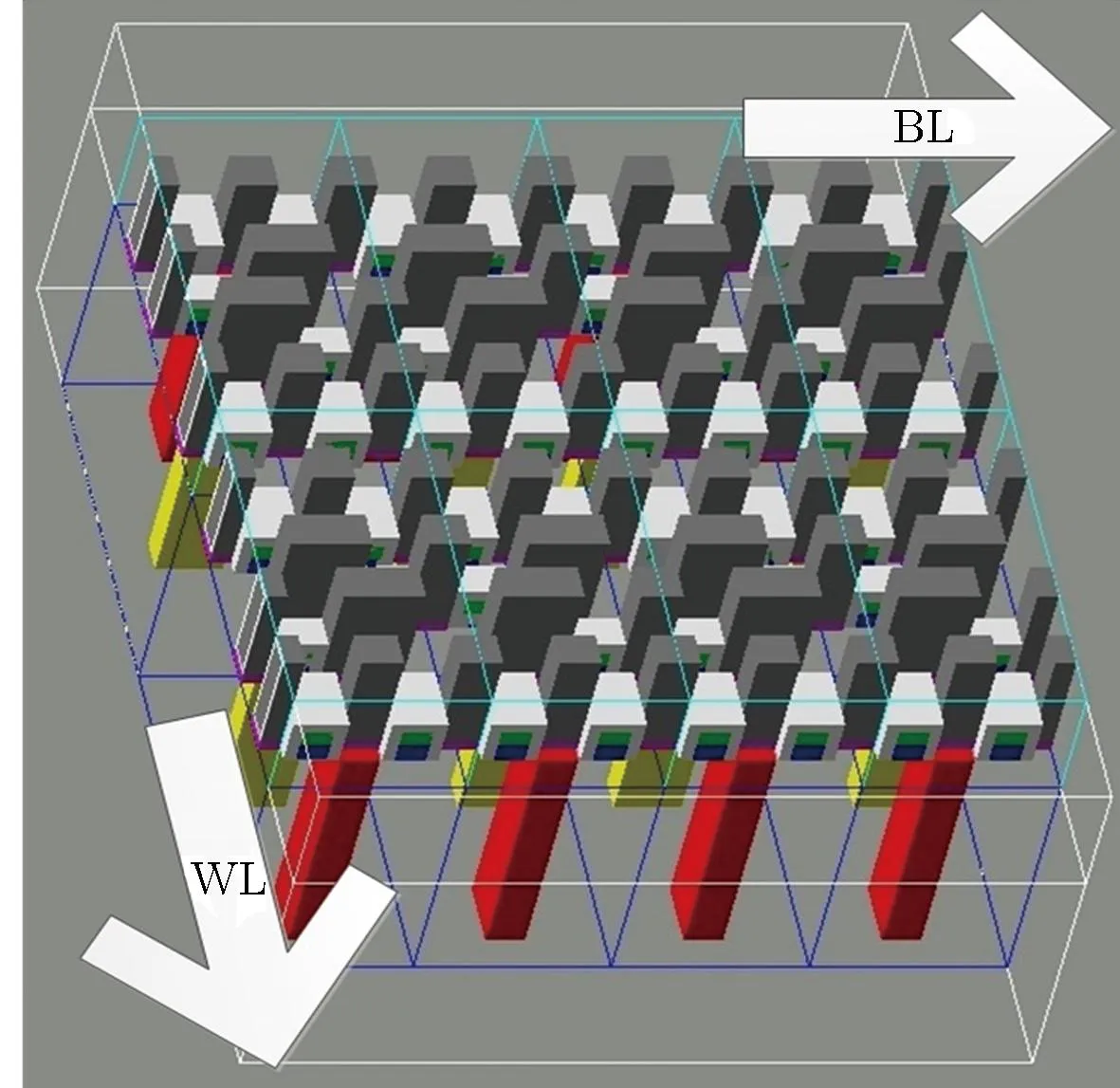
图8 SRAM单元阵列结构体模型示意图[15]
基于网表计算器件累积辐射损伤易损性方面,完成国产WX40工艺单管试验芯片设计和流片,获取晶体管中子位移损伤和总剂量效应测试数据,构建辐照后晶体管损伤模型;执行电路仿真,即可获得中子、γ辐照后电学参数退化情况[16]。
基于版图计算器件瞬时辐射效应易损性是近年来的研究热点,这种思路可集成于标准集成电路设计流程,无须单独构建电子器件模型,便于被设计人员直接调用,可在电路设计阶段快速评价是否满足抗辐照指标。针对单粒子瞬态效应,解决了底层器件瞬态强耦合与纳米尺度复杂机制影响的精确全面表述难题,提出并建立了逼真的辐射效应物理模型和高效实用的仿真方法[17]。针对纳米工艺电路尺寸变小导致电荷共享加剧、次级效应增强及电荷收集作用半径严重时可能覆盖上千个有源结区等现状,开展了一系列的相关研究,重点解决纳米尺度电路单粒子临界电荷已低至1 fC以下时扩散收集建模、电路反馈对单粒子瞬态脉冲的调制作用建模及寄生结构提取并对寄生结构外加的瞬时电压进行全时域描述等技术难题。创新性提出一种将实际有源区面积、形状与重离子入射位置合成,形成自定义无量纲漂移因子和扩散因子的方法,解决了采用有源区与重离子入射位置之间间距值作为自变量现有方法的不足,增强了对于实际电路中复杂版图的适应性。图9为漂移因子、扩散因子计算原理示意图。

(a)Drift factor

(a)Diffusion factor
通过开发子电路模型和构建有源电阻网络,实现对电路响应反馈、阱电势调制、双极放大收集及工作电压调制等次级效应的建模表达,实现了对于实际物理图像的无遗漏描述,有效提高了计算精度。图10为SEE模拟流程的示意图[18]。
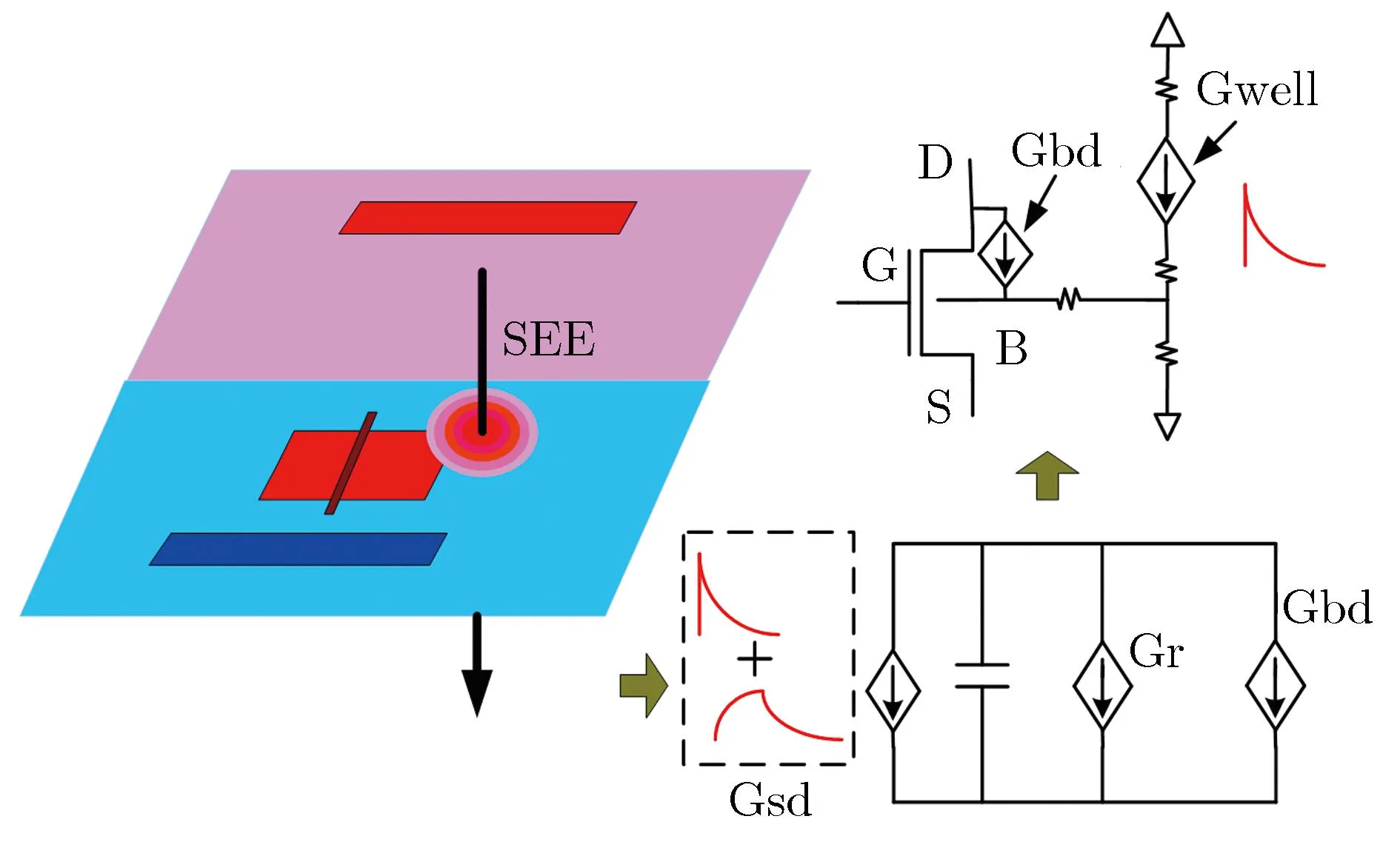
图10 SEE模拟流程的示意图[18]
通过设计具有加固结构的芯片,开展辐照试验测试及数值仿真,系统梳理结构变化和电路工作状态变化对于辐射效应仿真的附加要求,大大提升了对集成电路实际结构及工作状态的覆盖度[19-20]。通过以上研究,实现了纳米尺度电路单粒子效应电荷收集机制解析建模,为辐射效应快速评价和加固单元库辅助设计奠定了仿真基础。
2020年,本文作者团队开发了集成于商用芯片设计与仿真平台的用户交互界面和并行化计算流程,成功研发瞬时辐射效应仿真软件TREES 1.0,可实现快速计算并标注电路版图中的敏感区域。图11为TREES1.0软件获取对SEE敏感性的计算结果[17]。依据中芯国际0.18 μm,65 nm,40 nm和UMC 40 nm等工艺平台流片生产集成电路,开展辐照试验获取单粒子效应敏感性,并与仿真评价结果进行逐一比对,验证了仿真软件的功能指标(功能完备性、准确性)和性能指标(计算精度、仿真速度)。
TREES 1.0能实现单元电路瞬时辐射效应实时分析,在此基础上,2021年,本文作者团队进一步研发了不依赖于国外软件的自主化版本TREES 2.0,实现独立用户界面、版图解析、激励项添加、国产电路仿真引擎集成等,在国产化麒麟操作系统上通过了适应性验证。图12为TREES 2.0界面[21]。
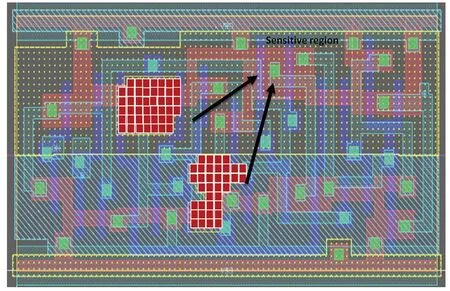
(a)Identifying sensitive region of single event effects

(b)Comparison of simulated and experimental data

图12 TREES 2.0界面[21]
TREES 2.0已公开报道的典型应用包括:(1)针对国产65 nm工艺SRAM阵列,准确评估单位及多位翻转的截面及敏感区域分布[22],通过明确电路辐射损伤机理,便于建立针对性的抗辐射性能评估方法;(2)针对0.18 μm和40 nm标准单元库,研究给出单元电路单粒子效应敏感性与驱动能力、特征尺寸、版图结构、工作模式之间的依赖关系和相关规律[23]。
同时,本文作者团队研发了TREES 2.0的升级版本SREES 1.0,能支持批处理与批存储,能直接对单元库执行激励文件自动生成、批量计算、层次化存储计算结果及计算结果写入矩阵式文本文件等操作,批量化获取不同重离子LET值、不同激励、不同输出电容情况下单元库中所有单元电路的SEE敏感性数据。SREES 1.0软件已通过在28 nm抗辐射加固单元库上开展的应用验证及第三方测试。SREES1.0软件的开发,为从工程实用角度上实现抗辐射加固芯片自主可控奠定了基础。
4 总结与展望
辐射效应易损性仿真能力建设属于核技术及应用的一项基础工程,为推动该方向发展,需关注以下几个方面:
(1)持续优化是必由之路。成熟软件的研发离不开持续的更新换代,美国的MRED和法国的MUSCA-SEP3在十余年内持续报道更新后的物理模型,美国的Xyce迄今已推出了6次整体更新和多达几十次的部分更新,以适应微电子领域日新月异的发展变化,增强软件产品的适用范围。
(2)积极引入新方法、新思路是必然选择。人工智能、深度学习等新方法,能增强计算效率,起到提质增效的作用。
(3)随着电子器件特征尺寸逐渐降低、工作频率与集成度不断增加、新结构新材料新型器件不断涌现,为保证国产电子器件辐射效应易损性分析软件能够持续发挥作用、有效辅助抗辐射加固芯片设计,需持续加大投入,利用自研芯片或与器件设计单位合作的方式,在多种类型器件、不同工艺平台上验证软件可用性。与此同时,需加强软件在辐射效应领域内相关单位的推广应用,通过迭代修改的方式提高软件成熟度。

