通孔电镀铜填孔浅析
杨智勤 欧阳小平 张 曦 陆 然 林 健
(深南电路有限公司,广东 深圳 518117)
近年来电路板朝向轻、薄、小及高密互连等趋势发展,要在有限的表面上,装载更多的微型器件,这就促使印制电路板的设计趋向高密度、高精度、多层化和小孔径方面的发展。
而其中增层法、半加成法、改良的半加成法、雷射成孔技术随之产生。叠孔技术作为一种有效的手段,也很受重视。比较常见的是芯板经过机械钻孔、去钻污、化铜、全板电镀、树脂塞孔、加覆盖镀(POFV)二次电镀、配板、蚀刻开窗、激光钻孔、后填盲孔等步骤完成叠孔。为了适应印制电路板的发展,盲孔的填孔工艺得到了广泛研究[1]。但是,经过全板电镀后的通孔进行树脂塞孔时会出现很多缺陷,从而导致叠孔失败,进而影响电信号的传递。通孔填孔镀铜技术于2005年开始,一经出现,就受到广大PCB科研者的青睐。因此本文从导电膏塞孔、树脂塞孔方式出发,浅析通孔填孔镀铜的反应机理,优势和局限性。
1 塞孔方法
1.1 导电膏塞孔
在印制电路板的制造过程中,一种相对新型工艺称为导电膏塞孔[2]。主要用于在积层技术中填充埋孔。使用这些导电膏可以制造平表面,随后对其金属化,然后进行增层。相对于一些绝缘性填充材料来说,其导电膏具有一定的散热效果,图1是导电膏塞通孔的示意图。

图1 导电膏塞孔示意图
从该流程来看,导电膏塞孔的工艺流程相对复杂。同时为了满足基板的表面平整度,需要研磨多余的导电膏,这时将引起基板的翘曲或变形。不但劳动力成本增大,而且不良率也高,由于需要等角沉积加覆盖镀(POFV)的二次电镀,所以基板面铜的总厚度变厚,线路蚀刻时,线路的微细化将受到明显的限制。
1.2 树脂塞孔
常见的树脂塞孔的方式有压合填孔与树脂油墨塞孔两种方式。压合填孔比较适合厚径比低及孔数少的埋孔。芯板通孔的树脂塞孔工艺可以为HDI增层制作提供一个平坦的表面[3],平坦的表面显得尤为重要,以确保受控阻抗在高频应用中的关键电路层之间的传导。业界普遍采用的塞孔方法有丝网印刷和滚涂方式,通孔塞孔的顶部可能是玻璃纤维增强的树脂层或加覆盖镀(POFV)的二次电镀层。如果通孔顶部是加覆盖镀的二次电镀层,则可以在铜面上制作盲孔进行叠孔。塞孔所用到的树脂是高Tg和低热膨胀系数(CTE),其制作流程和图1是类似的。
树脂塞孔作为HDI中比较新、决定未来HDI趋势走向的一种新工艺,其发展程度反映了一个公司HDI的整体制作水平,同时也是各厂家极为保密的东西。树脂塞孔中存在的难题:厚板小孔难以一次塞实;树脂固化收缩而难以实现孔塞得饱满;树脂内气泡难以消除;板面树脂残留难以消除等,几种常见的缺陷见图2。

图2 树脂塞孔时易出现的缺陷
从图2中可以发现,树脂塞孔易出现塞孔凹陷过大、加覆盖镀的二次电镀层易断裂、增层时经激光钻孔孔型易钻歪。
1.3 通孔电镀铜塞孔
通孔是通过机械钻孔于芯板上产生,然后经化学沉铜,全板电镀,树脂塞孔来达到上下层的导通。目前的趋势是芯板的厚度越来越薄,对技术的要求越来越高,这已影响产量,质量,生产成本。例如树脂塞孔属于劳动密集型的工作,机械研磨或涂刷后树脂固化会导致尺寸的不稳定,厚度小于100μm的芯板问题尤为严重。树脂本身是一种高固体含量的材料和纯铜具有不同的热膨胀系数。
电镀填孔工艺制作的平坦的铜面来取代树脂塞孔或导电膏塞孔将是非常有前景的,铜沉积在孔内作为金属化过程中的一个必要组成部分。钻孔过后的芯板为了实现导通,可以先化学沉铜一层很薄的铜为填孔作为种子层,然后通过单一,全自动连续加工生产线完成填充。
利用该特征可以给设计者带来更多的设计选择,孔内的热膨胀系数只取决于金属铜和支持玻璃树脂钻孔介质。可以在通孔上进行叠孔而不影响其可靠性,图3为通孔内非导电性物质填充和纯铜填充。

图3 非导电性物质的填充和通孔填孔镀铜
2 通孔填孔镀铜技术
2.1 电流的影响
就电镀用到的电流而言,有直流和交流之分[4]。在直流电镀过程中,孔能填满主要归结于设备加功能力和有机添加剂。在有机添加剂的作用下采用反向脉冲电镀(PPR)电镀方式同样也可以给出填孔所需要的不同于表面电镀的速度。PPR与有机添加剂一起作用,是一种能提供填充孔所需电镀速率的有效途径。在直流电镀时,仅电流可以控制,而在PPR电流波形中,有三个参数可以独立改变:持续时间,停止时间,电流密度。这些参数可对铜离子沉积的控制更完全。另外,不同的PPR波形可连接在一起形成复合波形,通过对这些参数的控制铜离子的吸附和解吸过程,但在直流电流中却不能做到,尤其是电镀药水不是专用的塞孔药水时,反向脉冲电镀效果显得尤为突出,图4采用的是反向脉冲电镀方式。
使用反向脉冲电镀能够干预这些光剂在通孔和板面的浓度分布平衡。例如加速剂(催化剂)更加集中于通孔的中央,而板面上的加速剂浓度耗尽。这是由于在反向(阳极)脉冲的条件下板面上的加速剂脱附并咬蚀一部分铜出来。随着电镀反应的进行,通孔中心加速剂的浓度相对较低,它需要一段时间才能重新吸附,图4为加速剂在反向脉冲电镀时的浓度分布。

图4 反向脉冲电镀过程中加速剂的分布示意图
正向电流主要控制铜离子在板面的附着和沉积,反向电流主要作用是对电流密度比较大的尖端部位所沉积的铜的反咬蚀作用,表现在电镀塞孔上,是将孔口处沉积的铜咬蚀掉,起到拉平的效果。在正向电流的作用下,由于电镀药水添加剂的作用,使得铜离子在孔内的沉积速率大于在板面的沉积速率。于此同时,在反向电流的作用下,孔口处沉积的铜被咬蚀掉,保证了铜离子在孔内的顺利沉积,避免了空洞形成。
2.2 通孔镀铜填孔机理
镀铜电解液通常包括整平剂、载运剂、光亮剂、氯离子、硫酸、硫酸铜等。光亮剂在氯离子协助下能产生去极化作用,降低过电位,加速镀铜速度又称加速剂。本身还可以进入镀层中参与结晶结构,影响干预铜原子沉积的自然结晶方式。整平剂带有很强的正电性,很容易吸附在镀件的表面电流密度较大处,与铜离子竞争,使铜离子在高电位处不易沉积,但又不影响低电流区的铜沉积,使原本起伏不平的表面变为平坦。载运剂具有增加极化作用,与氯离子共同作用下会增加对铜沉积的抑制,可协助光亮剂前往阴极凹陷各处分布,必须在氯离子的协助下才能发挥作用。
微盲孔的超等角填充方式已经在早期的实验验证过,但是通孔填孔的生长方式的确让人比较费解。对通孔和盲孔填孔来说,控制步骤是抑制基板表面镀层的成长,于此同时促进通孔或盲孔内部的镀层的成长。然而与盲孔填孔镀铜不同,通孔内部没有底面,因此就没有几何学上的自下而上(Bottom Up)成长,所以必须控制基板表面与通孔内部的镀层析出之差,从通孔的中部优先的成长镀层,可以获得孔隙率少的通孔填孔镀层。
Wei-ping Dow等[5]研究了圆柱形通孔在没有加速剂的条件下,其通孔能被填满,而V、X型通孔需在有加速剂的条件下才能被填满。图5为圆柱形通孔在没有加速剂的条件下被填充示意图。
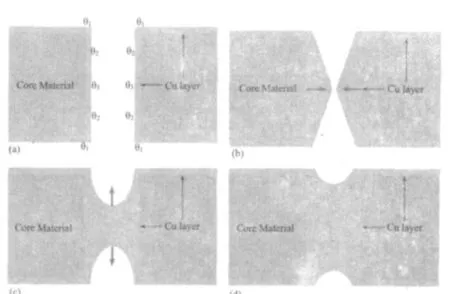
图5 通孔填孔生长示意图
其填孔机理主要归结于抑制剂的吸收、消耗、扩散,导致抑制剂浓度差存在于通孔中心和板面。图5(a)为抑制剂浓度分布,其θ1>θ2>θ3,抑制剂浓度分布在通孔内部是呈现对称分布。图5(b)为铜层在有抑制剂的条件下优先在通孔中心沉积,从而呈现蝴蝶尾状铜沉积,其生长方式为水平横向生长。图5(c)为铜层生长方式由水平横向生长变为垂直纵向生长。图5(d)为填孔步骤末期,铜沉积速率减慢,主要由于孔口抑制剂浓度高导致。由于电镀液中不存在加速剂,其填孔步骤结束时会导致一定的凹陷。该方法是改变了通孔内的电流密度分布,必须在低电流密度下进行才能防止空洞和裂缝的产生。如果采用高电流密度,抑制剂在基板表面不能有效地吸附并抑制铜沉积,铜的生长速率超过了抑制剂的吸附速率,最终,铜晶核会聚集在基板表面导致表面粗糙。
2.3 通孔填孔技术的优势
通孔填孔电镀具有很多方面的优势,尤其是其具有很高的可靠性能。当填充材料具有不同的热膨胀系数时,其在使用过程中的老化问题是值得关注的,这点在PCB行业中尤为显著。铜的膨胀系数大约是17×10-6/K,而典型的FR4材料大约是110×10-6/K,另外一些塞孔性材料在通孔填孔中的热膨胀系数在(30×10-6/K)~(40×10-6/K)。这意味着,经过全板电镀通孔中的铜镀层容易受到来自孔内不同材料的热冲击而导致开路,而使用通孔填孔技术则可以避免不同材质膨胀系数引起的电性能失效。
另外,通孔填孔技术具有优越的热传导,铜具有明显的热传导是因其具有很高的热传导率,达到360 W/(m·K),优于任何其他填充材料。我们使用的导电膏热传导率一般为1W/(m·K),个别能达到8W/(m·K)。如果使用填充物质塞孔时,经过估算,超过90%~99%的热量传递是由铜层传递,这明显降低了填充物质的热传导的应用[6]。
我们可以很容易通过引入热阻的概念来完成能力的比较,热阻是反映热量传递的能力的综合参量,在热传热学的工程应用中,为了满足生产工艺要求,有时通过减小热阻以加强传热,而有时则通过增大热阻以抑制热量的传递。通孔中镀层可以被看做为热传导线,而热阻Rth可以用公式[7]:Rth=d[μm]/(λ[ W(m·K)])·A[m2],公式中的d为热传导线的长度,即基板的厚度;λ为热传导系数(即铜或其他填充材料的热传导系数);A为热传导线的横截面积。假定孔的直径为120μm和基板的厚度为150μm,通孔中的热传导系数主要取决于通孔中孔铜厚度。为了提高热传导能力应该使孔铜的厚度增加,而不是使用填充其他不导电的介质,理论算出的结果在表1。
从表1可以看出,通孔填孔镀纯铜的热阻值是最低的,其传热效果是最好的。如果使用热阻值高的物质塞孔,必须增加散热孔的数量来达到等同的效果,通常这种做法不太适合基板朝微型化发展。进行叠孔时不必担心由于对位不好,也可以很好地实现电气互连,从而达到节省布线空间的目的[8]。

表1 热传导能力的比较
3 结论
盲孔填孔已经广泛应用于HDI制造,而通孔填孔电镀更值得人们的期待。本文已经表明通孔填孔电镀可以取代芯板填充其他填充剂,优化了工艺流程,从而获利。其优点就是其具有良好的热传导和避免热冲击,可以提高封装基板的可靠性。到目前为止,这项技术局限是薄芯板和微通孔,其电镀过程是一个全板电镀的过程。如果工艺条件成熟,可以控制面铜厚度低于20μm,这使得制作50μm以下的精细线路是可行的。同时,这种工艺明显缩短了工艺流程,降低了劳动密集程度,更好的为生产服务,拉动产品品质的提升。
[1]Ryszard Kisiel, Jan Felba, Janusz Borecki,et al. Problems of PCB microvias filling by conductive paste[J].Microelectronics Reliabiility,2007,47:335-341.
[2]Sven E Kramer. An overview of the advantages and drawbacks to typical plugging methods[J].Printed Circuit Design &Manufacture, 2004,3:44-47.
[3]M.Carano.Via Hole Plugging Technology[J].Circuitree,2007,5.
[4]Fujinami T, Kobayashi A, Maniwa H, et al.Finish[J]. Soc,1997, 48(6):660.
[5]Wei-ping Dow,Hsiang-Hao Chen, Ming-Yao Yen, etal.Through-Hole Filling by copper electroplating[J]. The Electrochemical Society,2008,10:750-757.
[6]Stephen Kenny, Bernd Roelfs. Form thin cores to outer layers:Filling through holes and bliid micro vias with copper by reverse pulse plating[J].International conference on electronic packaging technology &High Density Packaging (ICEPTHDP), 2009:918-922.
[7]Christoph Lehnberger.Strategien zur Elektronik-Kuhlung[J]. Leiter platten-Design, 2004,10:24.
[8]Wei-ping Dow, Hsiang-Hao Chen. A novel copper electroplating formula for laser-drilled micro via and through hole filling[J].Circuit World,2004,30(3):33-36.

