光读出红外成像芯片真空封装研究*
张云胜, 冯 飞, 魏旭东, 戈肖鸿, 王跃林
(1.中国科学院 上海微系统与信息技术研究所,上海 200050;2.中国科学院大学,北京 100049)
光读出红外成像芯片真空封装研究*
张云胜1,2, 冯 飞1, 魏旭东1, 戈肖鸿1, 王跃林1
(1.中国科学院 上海微系统与信息技术研究所,上海 200050;2.中国科学院大学,北京 100049)
为解决光读出红外成像焦平面阵列器件的真空封装,提出了一种新颖的真空封装方法。该封装结构由可见光窗口、硅垫片和红外窗口三部分构成。硅垫片和可见光窗口(玻璃)通过阳极键合形成封装腔体,用于放置芯片;红外窗口不仅选择性增透8~14 μm波段的红外辐射,且作为封装盖板;封装腔体和红外窗口在真空室内通过焊料键合完成真空封装。该封装结构通过了气密检测,并测试得到了200 ℃电烙铁热像图。
真空封装; 红外成像焦平面阵列; 光读出; 阳极键合; 焊料键合
0 引 言
真空封装对于红外焦平面阵列(infrared focal plane array,IRFPA)芯片是必不可少的[1~4]。IRFPA需要封装来保护内部脆弱的微结构免于外界水汽、灰尘等造成的损坏;更重要的是需要真空环境来确保芯片的正常工作。迄今为止,已有多种针对电读出IRFPA的真空封装方案,可以分为芯片级封装[1]、圆片级封装[2,3]和像素级封装[3,4]。芯片级真空封装是研发最早且目前仍被广泛使用的一种真空封装方法,但是其封装效率比较低。圆片级真空封装提高了封装效率,但该方法对IRFPA芯片的成品率要求较高,否则,将会封装相当比例的废片,从而浪费昂贵的红外滤波片。像素级真空封装也是为了提高封装效率而研发的一种封装方法。一个代表性的案例是由CEA-LETI研发的,其创新之处是在圆片上用半导体薄膜对像素进行真空封装。然而,方案中使用薄膜作为封装盖板,比较脆弱,难以有效保护内部脆弱的像素结构。
上述封装方案中没有光读出红外焦平面阵列(optically readable infrared focal plane array,ORIRFPA)芯片所需的可见光窗口,因而需要研发新的封装方法。本文提出了一种新颖的真空封装方法:硅垫片和玻璃可见光窗口通过阳极键合形成容纳芯片的封装腔体;红外窗口作为封装盖板,不仅可以选择性增透波长8~14 μm的红外辐射,而且可以有效地保护内部的像素结构。
1 ORIRFPA工作气压对其像素性能的影响
ORIRFPA通过机械变形将目标的红外图像转换为可见光图像[5~9],其成像性能一般由噪声等效温差(noise equivalent temperature difference,NETD)来衡量。而NETD∝G[5],G为ORIRFPA芯片的总热导。对于ORIRFPA
G=Gconst+Gair.
(1)
Gconst由ORIRFPA芯片的材料、结构等参数决定,对于一个特定的芯片而言是个定值,且与其工作气压无关。Gair为与ORIRFPA芯片工作气压p相关的热导,即封装腔体内部空气热传导热导[6]。下面将详细分析Gair与芯片工作气压p的关系。
真空封装结构剖面如图1所示,d1=20 μm是像素到衬底的距离;d2=730 μm是像素到封装壳体上表面的距离。

图1 真空封装结构剖面示意图
在标准大气压下,像素和衬底以及封装壳体之间的空气热传导热导为[6]
(2)
其中,kair=26×10-2W/(m·K)为空气的热导率,Am为微镜面积,d2远大于d1,则后一项可以忽略,所以
(3)
在稀薄空气下,kair是气压p的函数,其关系式为[6]
(4)
kair0=26×10-2W/(m·K)为一个大气压p0下的空气热导率,λ0为一个大气压下空气分子的平均自由程,而分子平均自由程与气压的关系为
(5)
其中,玻耳兹曼常数kB=1.38×10-23J/K,气体的温度为T,空气分子的平均直径是δ=3.5×10-10m。当p<308.5Pa时,λ>20μm,像素与衬底之间的距离会限制空气分子的运动。所以,当p<308.5Pa时,实际的平均自由程取20μm,即λ=20μm,故
kair=8.43×10-5p,
(6)
(7)
如图2所示,空气热传导热导与封装腔内气压呈线性关系。由于NETD∝G∝p,要提高ORIRFPA芯片的性能,即减小NETD,则需要对芯片进行真空封装来降低芯片工作气压p。
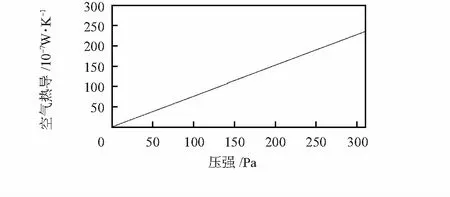
图2 空气热导随压强变化曲线
而与气压无关的像素本身热导(热辐射热导和梁结构的热导)为1.34×10-7W/K[6]。当封装内部气压p为1.77Pa时,空气热导等于像素本身热导。所以,当气压小于1.77×10-2Pa时,空气热导只有像素本身热导的1 %,影响可以忽略不计,故红外芯片需要的内部真空度至少要低于1.77×10-2Pa。
2 ORIRFPA芯片真空封装结构与ANSYS仿真
针对光读出红外芯片的特点,提出了一种新颖的真空封装方法:首先,制作用于真空封装的腔体;然后,挑选出性能合格的IRFPR芯片;第三,将芯片焊料键合到封装腔体内;最后,在真空室内将红外盖板焊料键合到封装腔上完成真空封装。
封装结构如图3所示,真空封装由三部分构成:玻璃可见光窗口、硅垫片和红外窗口,硅垫片和玻璃可见光窗口通过阳极键合形成用来放置芯片的封装腔体;红外窗口不仅对波长8~14μm的红外辐射进行选择性增透,而且用来作为封装盖板,可以较好地保护内部脆弱的芯片结构。

图3 封装结构图
假设封装结构内部为真空、外部为一个大气压,采用ANSYS有限元分析软件对该真空封装结构进行了仿真,其结果如图4。由仿真分析可知,应力最大值是34.42MPa,分布在封装腔体的内棱中间位置(图4中圆圈所示)。已知硅的屈服强度是6GPa,所用的Pyrex7740玻璃的屈服强度至少是150MPa。仿真结果表明:采用硅、玻璃来制作ORIRFPA真空封装腔体是完全可行的。

图4 封装结构应力分布剖面图
3 真空封装结构制作
如图5所示,真空封装结构制作流程为:
1)硅垫片的制作:使用KOH腐蚀工艺制作硅垫片;
2)硅垫片和玻璃可见光窗口阳极键合,形成封装腔体;
3)在封装腔体上制作Au并图形化,形成Au粘附层;
4)将本实验室已制备的性能良好的ORIRFPA芯片焊料键合到封装腔体内;
5)制备红外窗口:使用普通硅片作为红外窗口,在上面溅射Au并图形化,形成粘附层;
6)红外窗口在真空环境下焊料键合到封装腔体片上,完成真空封装。

图5 真空封装制作流程
制作得到了所需的真空封装结构,如图6所示。

图6 封装实物图
4 测试结果与分析
将12组真空封装样品(其中10组未加入红外芯片的封装片,2组加入红外芯片)进行氟油粗检,结果无气泡产生,初步说明封装结构具有气密性。
将已通过氟油粗检的ORIRFPA真空封装芯片进行了热成像测试并得到了200 ℃电烙铁的热像图,如图7所示。

图7 200 ℃电烙铁热像图
真空封装结构腔体容积为0.58×10-6m3,在真空封装完成后104h测得200 ℃电烙铁热像图;与不同真空度下芯片热成像的能力对比,可知封装腔体内部真空度约为1 000Pa,故该真空封装结构的空气漏率约为1.52×10-9Pa·m3/s,满足了MIL—STD—883E对漏率的要求。
5 结 论
本文详细阐述了一种新颖的光读出红外成像焦平面阵列芯片的真空封装方法,该真空结构包括三部分:玻璃可见光窗口、硅盖板和红外窗口。该真空封装通过了氟油粗检, 漏率为1.52×10-9Pa·m3/s,符合MIL—STD—883E对漏率的规定。该真空封装后的红外成像焦平面阵列芯片可以对200 ℃的电烙铁清晰成像,表明了该真空封装方法是有效的。
[1]HataH,YoshiyukiNakaki,HiromotoInoue,etal.UncooledIRFPAwithchipscalevacuumpackage[C]∥ProcofSPIEonInfraredTechnologyandApplicationsXXXII,Orlando,2006:620619—1-620619—10.
[2]GoochR,SchimertT,McCardelW,etal.Wafer-levelvacuumpackagingforMEMS[J].JVacSciTechnolA,1999,17(4):2295-2299.
[3]AstierA,ArnaudA,Ouvrier-BuffetJ,etal.AdvancedpackagingdevelopmentforverylowcostuncooledIRFPA[C]∥ProcofSPIEonInfraredComponentsandTheirApplications,Bellingham,2004:107-116.
[4]DumontG,RabaudW,BaillinX,etal.PixellevelpackagingforuncooledIRFPA[C]∥ProcofSPIEonInfraredTechnologyandApplicationsXXXVII,Orlando,2011:80121I—1-80121I—7.
[5]ZhaoY,MaoM,HorowitzR,etal.Optomechanicaluncooledinfraredimagingsystem:Design,microfabrication,andperforman-ce[J].JMEMS,2002,11(2):136-146.
[6] 杨广立.微机械反射式光读出非制冷红外成像阵列器件研究[D].上海:中国科学院研究生院上海微系统与信息技术研究所,2007:25-27.
[7] 冯 飞,焦继伟,熊 斌,等.一种新颖的基于MEMS技术的光读出热成像系统性能分析与制作[J].红外与毫米波学报,2004,23(2):125- 130.
[8] 杨广立,冯 飞,熊 斌,等.一种微机械光读出红外成像阵列器件机械特性对器件性能影响的研究[J].光学精密工程,2007,15(5):699-705.
[9]OuYi,LiZhigang,DongFengliang,etal.Design,fabrication,andcharacterizationofa240×240MEMSuncooledinfraredfocalplanearraywith42μmpitchpixels[J].JMEMS,2013,22(2):452-461.
Vacuum packaging research of optically readableinfrared imaging chip*
ZHANG Yun-sheng1,2, FENG Fei1, WEI Xu-dong1, GE Xiao-hong1, WANG Yue-lin1
(1.Shanghai Institute of Microsystem and Information Technology,Chinese Academy of Sciences,Shanghai 200050,China; 2.University of Chinese Academy of Sciences,Beijing 100049,China)
A novel vacuum packaging method is proposed for vacuum packaging optically readable infrared imaging focal plane array(ORIRFPA)device.The vacuum packaging structure is made up of three parts,a visible light window,a silicon spacer,and an infrared window.The silicon spacer is bonded to visible light window-glass using anodic bonding to form packaging cavity,for chip placement;infrared window is not only used to selectively transmit infrared radiation ranges from 8 μm to 14 μm,but also is used as packaging cover board;packaging cavity is solder bonded to infrared window in vacuum chamber.Then the packaging structure passes air tightness test,and thermal images of soldering iron at temperature 200 ℃ are test and obtained.
vacuum packaging; IRFPA; optically readable; anodic bonding; solder bonding
2014—06—06
国家自然科学基金资助项目(60876081,61172151); 国家“ 863”计划资助项目(2009AA04Z317)
10.13873/J.1000—9787(2015)02—0044—03
TN 215
A
1000—9787(2015)02—0044—03

