盲孔快速镀铜添加剂对填孔效果的影响及其作用过程
张波,潘湛昌,,胡光辉,肖俊,刘根,罗观和
(1.广东工业大学轻工化工学院,广东 广州 510006;2.广州秋泽化工有限公司,广东 广州 510006)
盲孔快速镀铜添加剂对填孔效果的影响及其作用过程
张波1,潘湛昌1,*,胡光辉1,肖俊1,刘根1,罗观和2
(1.广东工业大学轻工化工学院,广东 广州 510006;2.广州秋泽化工有限公司,广东 广州 510006)
介绍了一种快速填盲孔电镀铜工艺,镀液组成和工艺条件是:CuSO4·5H2O 210 g/L,H2SO485 g/L,Cl-50 mg/L,润湿剂C (环氧乙烷与环氧丙烷缩聚物)5 ~ 30 mL/L,整平剂L(含酰胺的杂环化合物与丙烯酰胺和烷基化试剂的反应产物)3 ~ 16 mL/L,加速剂B(苯基聚二硫丙烷磺酸钠)0.5 ~ 3.0 mL/L,温度23 °C,电流密度1.6 A/dm2,阴极摇摆15回/min或空气搅拌。研究了湿润剂C、整平剂L和加速剂B对盲孔填孔效果的影响。结果表明,润湿剂C与加速剂B用量对填孔效果的影响较大,而整平剂L用量的影响较小。最优组合添加剂为:整平剂L 8 mL/L,湿润剂C 15 mL/L,加速剂B 1.5 mL/L。采用含该添加剂的镀液对孔径100 ~125 μm、介质厚度75 μm的盲孔进行填孔电镀时,填孔率大于95%,铜镀层的延展性和可靠性满足印制电路板技术要求。此外,对添加剂填孔过程的研究表明,爆发期在起镀后的20 ~ 30 min,爆发期孔内的沉积速率是表面沉积速率的11倍以上。
印制线路板;盲孔;电镀铜;添加剂;填孔率;沉积速率
First-author’s address:Faculty of Light Industry and Chemical Engineering, Guangdong University of Technology, Guangzhou 510006, China
电子产品的微型化、多功能化推动了印制电路板(PCB)朝线路精细化、小孔微型化的方向发展,其主流产品为HDI(高密度互连)板和IC(集成电路)基板。为满足HDI及IC基板的高密度、高集成化要求,PCB制造业开创了电镀填孔技术[1],该技术主要通过电镀填孔添加剂进行“超等角”电沉积来实现盲孔填充[2]。
电镀填孔添加剂已发展到第二代。第一代电镀填孔添加剂的代表产品是陶氏化学的 EVF和日本株式会社JCU的VFII。这类添加剂只能采用板面电镀方式填孔,面铜需达到20 ~ 35 μm(一般耗时60 min左右),后续需要将铜层减薄到10 μm左右,过蚀刻或蚀刻不均都会导致开路、短路等故障,产品的合格率低,成本高。随着线路精细化、小孔微型化技术的发展,必然要求在更短时间内和更薄镀层下完成盲孔填充,同时填孔方式必须适用于板面和图型电镀(因精细制作更多采用半加成法、通孔金属化或盲孔填充与线路同时成型的方式)[2]。在这样的背景下,新一代电镀填孔添加剂孕育而生,它能在更短时间(35 ~ 45 min)内电镀更薄的镀层(12 ~ 15 μm)实现盲孔填充,并且稳定性优于第一代,其代表产品为JCU的VL和罗门哈斯的LVF。广东工业大学与广州秋泽化工通过产学研的方式,开发了此类电镀填孔添加剂。本文结合研究的实际,探讨了三组分复合添加剂对盲孔填孔性能的影响,并研究了该添加剂体系在填孔爆发期的特点。
1 实验
1. 1 盲孔测试板规格与工艺流程
盲孔测试板(FR-4覆铜板)规格:盲孔孔径100 ~ 125 μm,介质层厚度75 μm,经沉铜、闪镀得到孔内镀铜层总厚度为4 ~ 6 μm。工艺流程为:QZ-PB121(广州秋泽化工)酸性除油60 s →水洗60 s →过硫酸钠-硫酸体系微蚀60 s →水洗60 s →3% ~ 5%(质量分数)硫酸浸渍60 s →填孔电镀→水洗→烘干。
1. 2 填孔电镀
镀槽容积为5 L,采用可溶性磷铜球为阳极,基础镀液(VMS)组成为:CuSO4·5H2O 210 g/L,硫酸85 g/L,Cl-50 mg/L。电镀工艺条件为:温度23°C,电流密度1.6 A/dm2,阴极摇摆15回/min,药液交换方式为对喷。其中,湿润剂C是环氧乙烷与环氧丙烷的缩聚物,分子量为2 000 ~ 3 000;整平剂L为含酰胺的杂环化合物、丙烯酰胺以及烷基化试剂的反应产物;加速剂B为苯基聚二硫丙烷磺酸钠。
1. 3 电镀添加剂填孔过程的研究
通常认为电镀填盲孔的过程分为起始期、爆发期和修复期三个阶段。本文通过人为断电方式,分别在起镀后的10、20、30、40和50 min取出对应板,采用JMP-2P金相研磨抛光机(深圳市巨杰仪器设备有限公司)和MJ22金相显微镜(广州明美),通过观察其放大200倍的金相切片来明确填孔状况,分析添加剂在各阶段对表面沉积速率与孔内沉积速率的影响。
1. 4 性能评价
1. 4. 1 添加剂填孔性能的评价
电镀添加剂的填孔性能主要通过对盲孔的填孔效果来评价,习惯上使用填孔率、铜厚、凹陷值(Dimple)等表征。填孔率 = (B/A) × 100%,凹陷值 = A - B,其中A为盲孔孔底到板面铜层的厚度,B为盲孔孔底到孔表面镀铜层最凹处的厚度,C为盲孔填孔电镀时的镀层厚度,具体见图1[3]。采用金相显微镜观察放大200倍的金相切片,根据填孔电镀后有无包孔现象以及填孔率是否在85%以上来判定是否合格。

图1 盲孔填孔能力表征示意图Figure 1 Schematic diagram showing characterization of blind via filling capability
1. 4. 2 极化曲线测试
在Autolab PGSTAT 302N电化学工作站(瑞士万通)上测量,采用三电极体系,工作电极为直径3 mm的玻碳电极(GCE,聚四氟乙烯包覆),辅助电极为大面积铂片,参比电极为饱和Hg/Hg2SO4电极(SSE),23 °C恒温水浴,扫描速率为10 mV/s,扫描范围为0.1 ~ -0.5 V[4]。
1. 4. 3 镀层的物理性能评价
在2.0 A/dm2下对不锈钢板电镀60 ~ 70 μm厚的铜层,然后参考IPC-TM-650《印制电路协会试验方法手册》,采用岛津Auto Graph AGS-H 500N电子万能测试机进行镀层延展性和抗拉强度的测试,拉扯速率为10 mm/min,拉力为50 kgf/cm2(相当于490 N/cm2)。
1. 4. 4 镀层的可靠性评价
采用浸锡热冲击试验法,先在150 °C下对经填孔的测试板烘烤6 h,干燥箱中自然冷却到室温,再置于288 °C无铅锡炉中连续热冲击6次,每次持续10 s,最后采用金相显微镜观察试样截面是否存在孔铜断裂或裂纹、孔壁分离现象。
2 结果与讨论
2. 1 加速剂B对填孔效果的影响
在基础镀液中分别加入整平剂L 8 mL/L、润湿剂C 15 mL/L以及加速剂B 0.5 ~ 3.0 mL/L,于1.6 A/dm2下电镀40 min,并拍摄金相切片,以研究加速剂B体积分数对填孔效果的影响,结果见图2。从图2可知,加速剂体积分数为0.5 ~ 3.0 mL/L时,面铜厚度为12 ~15 μm。当加速剂体积分数为0.5 mL/L时,填孔率只有35%;当加速剂体积分数为1.0 ~ 2.5 mL/L时,无任何填孔不良现象,填孔率大于95%;当加速剂体积分数为3.0 mL/L时,填孔率降为88%。因为加速剂B是含S的小分子化合物,能加快铜的电沉积。当加速剂B含量较低时,对孔内镀铜的加速效果不明显。当B剂体积分数为3.0 mL/L及以上时,孔内富集效果削弱,孔表面与孔内加速剂B的含量趋于一致,“超等角”电沉积模式被破坏,填孔率降低,甚至无填孔效果。因此加速剂B含量需控制在一定的范围内,才能达到明显的“超等角”电沉积模式[5]。本体系加速剂的适宜用量为1.0 ~ 2.0 mL/L。
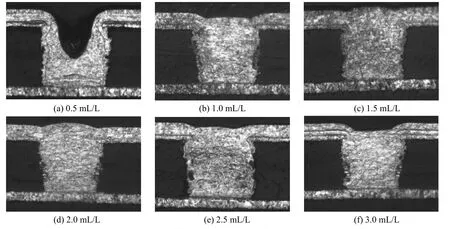
图2 加速剂B用量对填孔效果的影响Figure 2 Effect of dosage of accelerator B on via filling efficiency
2. 2 润湿剂C对填孔效果的影响

图3 润湿剂C用量对填孔效果的影响Figure 3 Effect of dosage of wetting agent C on via filling efficiency
在VMS中加整平剂L 8 mL/L、加速剂B 1.5 mL/L以及润湿剂C 5 ~ 30 mL/L,于1.6 A/dm2下电镀40 min,以研究润湿剂C体积分数对填孔效果的影响,结果见图3。从图3可知,润湿剂C的体积分数为5 ~ 30 mL/L时,表面镀层厚度为12 ~ 15 μm。当润湿剂C的体积分数为5 mL/L时填孔正常,但板面出现明显的颗粒(见图4);当润湿剂C的含量为10 ~ 20 mL/L时,填孔正常,填孔率大于95%,外观上表现为镜面光亮,无颗粒现象;当润湿剂C的含量达25 mL/L及以上时,填孔率略降,甚至有包孔现象。其原因是:湿润剂C为一种高分子表面活性剂,它通过吸附于铜层表面来减缓铜在表面的沉积,达到外观平整的效果。当其含量较低时,未能形成均匀的吸附层,故铜面粗糙或有铜颗粒存在;当其含量较高时,容易产生泡沫,而泡沫容易进入盲孔,导致包孔。故润湿剂的用量在10 ~ 20 mL/L范围内最合适。

图4 镀铜层表面的颗粒现象Figure 4 Particle phenomenon on surface of copper coating
2. 3 整平剂L对填孔效果的影响
VMS中加入润湿剂C 15 mL/L、加速剂B 1.5 mL/L以及整平剂L 3 ~ 16 mL/L,于1.6 A/dm2下电镀40 min,以研究整平剂L的体积分数对填孔效果的影响,结果见图5。从图5可知,湿润剂体积分数为3 ~ 16 mL/L时表面镀层厚度为12 ~ 15 μm。当整平剂不足(如3 mL/L)时,容易产生包孔现象;当整平剂体积分数为6 mL/L及以上时,对填孔效果的影响不如加速剂B和润湿剂C明显。因为整平剂L是一种含氮杂环类高分子聚合物,有明显的正电性,填孔时主要吸附在孔口高电流处,抑制孔口沉积,避免因过早封口而产生孔洞。当其含量不足时,作用不明显,容易产生包孔。另外,整平剂L的分子量比较大,其扩散速率比小分子物质(含硫加速剂)慢,即使增大其浓度,对孔内沉积的影响也微乎其微[5]。故整平剂的适宜用量为6 ~ 13 mL/L。

图5 整平剂L用量对填孔效果的影响Figure 5 Effect of dosage of leveling agent L on via filling efficiency
2. 4 填孔过程分析
通常认为电镀填盲孔的过程分为3个阶段:起始期、爆发期和修复期[6]。在VMS中分别加整平剂L 8 mL/L、润湿剂C 15 mL/L和加速剂B 1.5 mL/L,在1.6 A/dm2下,通过人为断电方式,分别在起镀后的10、20、30、40和50 min时取出对应板,通过金相显微镜观察其填孔状况,明确添加剂作用的3个阶段,结果见图6和表1。从图6可知,填孔起始期在起镀的10 min内,此过程是加速剂B、整平剂L和润湿剂C在孔表面与孔内分布,主要是孔内加速剂的富集;20 ~ 30 min为药水爆发期,主要表现为孔内“超等角”沉积模式,孔内沉积速率为表面沉积速率的10倍以上,此阶段孔的填充率在85%以上;40 ~ 50 min为修复期,随着孔“自下而上”填充,孔内加速剂、整平剂和润湿剂对铜沉积起竞争作用,此时更趋向于“等角”沉积模式。由表 1可知,表面的铜沉积在整个电镀过程中接近匀速,孔内沉积速率与表面沉积速率之比在起始期约为1.65,爆发期内大于11.00,修复期时在2.40以上,说明该组合添加剂在整个电沉积过程中以“超等角”沉积模式为主导。

图6 复合添加剂在不同阶段的填孔效果Figure 6 Via filling efficiency of composite additive at different stages

表1 不同阶段的沉积速率Table 1 Electrodeposition rates at different stages
2. 5 镀液极化曲线
采用三电极体系在基础镀液中加入不同添加剂,测量阴极极化曲线,结果如图7所示。从图7可知,在基础镀液中加入加速剂B 1.5 mL/L,镀液阴极极化减弱,说明加速剂B能够加快铜的沉积。在基础镀液中分别加入其他添加剂时,阴极极化均增强,铜的沉积均受到抑制。其中15 mL/L润湿剂C的抑制作用最强,15 mL/L润湿剂C + 8 mL/L整平剂L + 1.5 mL/L加速剂B次之。结合上述结果可知,组合添加剂具有最佳的整平能力[7-8]。这是因为润湿剂C为高分子化合物,主要分布在孔表面,抑制表面铜的电沉积;整平剂L为带有部分正电荷的杂环化合物,主要吸附在孔口等高电流密度区,抑制孔口铜的电沉积;而加速剂B为含S的小分子化合物,能够进入孔内加速铜的沉积。3种添加剂的协同作用使盲孔沉积能达到明显的“超等角”电沉积模式[5]。

图7 VMS中加入不同添加剂时的阴极极化曲线Figure 7 Cathodic polarization curves for VMS with different additives
2. 6 镀层可靠性评估
2. 6. 1 延展性和抗拉强度
VMS中加入整平剂L 8 mL/L、润湿剂C 15 mL/L和加速剂B 1.5 mL/L时,铜镀层的延展性和抗拉强度测试结果见表2。从表2可知,铜镀层的延展性大于20%,抗拉强度大于270 MPa,符合IPC-TM-650中铜镀层延展性大于12%和抗拉强度大于250 MPa的要求。

表2 铜镀层延展性与抗拉强度Table 2 Ductility and tensile strength of copper coating
2. 6. 2 镀层的可靠性评价
图8为VMS中加入整平剂L 8 mL/L、润湿剂C 15 mL/L和加速剂B 1.5 mL/L时所得铜镀层热冲击试验前、后的金相照片。从图 8可知,热冲击试验后,镀层中无孔铜断裂或裂纹、孔壁分离等现象,说明铜镀层可靠性良好。

图8 热冲击测试前后填孔试样的金相照片Figure 8 Metallographs of filled via sample before and after thermal shock test
3 结论
(1) 湿润剂C与加速剂B的用量对填孔效果的影响较大,而整平剂L的用量对填孔效果的影响较小,3种添加剂的最佳体积分数范围为:整平剂L 6 ~ 13 mL/L,润湿剂C 10 ~ 20 mL/L时,加速剂B 1.0 ~ 2.5 mL/L。
(2) 在210 g/L CuSO4·5H2O + 85 g/L硫酸 + 50 mg/L Cl-基础镀液中加入整平剂L 8 mL/L、润湿剂C 15 mL/L和加速剂B 1.5 mL/L,于1.6 A/dm2下电镀40 min,所得面铜的平均厚度为12 ~ 15 μm,填孔率大于95%,铜镀层的延展性和抗拉强度满足PCB工业生产的技术要求,可靠性良好。
(3) 该组合添加剂的爆发期在起镀后的20 ~ 30 min,爆发期孔内的沉积速率约为表面的11 ~ 15倍。
[1] KISIEL R, FELBA J, BORECKI J, et al. Problems of PCB microvias filling by conductive paste [J]. Microelectronics Reliability, 2007, 47 (2/3): 335-341.
[2] DOW W P, YEN M Y, LIAO S Z, et al. Filling mechanism in microvia metallization by copper electroplating [J]. Electrochimica Acta, 2008, 53 (28):8228-8237.
[3] 李亚冰, 王双元, 王为. 印制线路板微孔镀铜研究现状[J]. 电镀与精饰, 2007, 29 (1): 32-35, 39.
[4] 汪松. 印制板深孔酸性电镀铜添加剂的研究[D]. 哈尔滨: 哈尔滨工业大学, 2011: 17-22.
[5] 窦维平. 利用电镀铜填充微米盲孔与通孔之应用[J]. 复旦学报(自然科学版), 2012, 51 (2): 131-138, I-II.
[6] WEST A C, MAYER S, REID J. A superfilling model that predicts bump formation [J]. Electrochemical Solid-Sate Letters, 2001, 4 (7): C50-C53.
[7] BERNARDS R F, FISHER G, SONNENBERG W, et al. Additive for acid-copper electroplating baths to increase throwing power: EP0440027 [P]. 1991-08-07.
[8] 雷华山, 肖定军, 刘彬云. 盲孔填孔电镀铜添加剂的研究[J]. 电镀与涂饰, 2013, 32 (12): 31-34.
[ 编辑:周新莉 ]
Effectiveness of rapid copper plating additives for blind via filling and their working process
ZHANG Bo,
PAN Zhan-chang*, HU Guang-hui, XIAO Jun, LIU Gen, LUO Guan-he
A rapid copper plating process for bind via filling was introduced. The bath composition and process conditions are as follows: CuSO4·5H2O 210 g/L, H2SO485 g/L, Cl-50 mg/L, wetting agent C (polycondensate of epoxy ethane and epoxy propane) 5-30 mL/L, leveling agent L (reaction product of heterocyclic compound containing amide, alkylating agent and acrylamide) 3-16 mL/L, accelerator B (phenyl polydipropyl sulfonate) 0.5-3.0 mL/L, temperature 23 °C, current density 1.6 A/dm2, swing rate of cathode 15 times/min or agitation. The effects of wetting agent C, leveling agent L and accelerator B on blind via filling efficiency were studied. The results indicated that the dosages of wetting agent C and accelerator B have a great effect on blind via filling, while the dosage of leveling agent L has a slight effect on it. The optimal additive formulation is as follows: wetting agent C 15 mL/L, leveling agent L 8 mL/L, and accelerator B 1.5 mL/L. When using the bath containing the given composite additive, the filling ratio is higher than 95% for blind vias with a diameter of 100-125 μm and a dielectric layer thickness of 75 μm, and the ductility and reliability of copper coating can meet the technical requirements of printed circuit boards. The study on filling process using the additives show that the explosion stage is at 20-30 min, and the deposition rate inside blind via is 11 times higher than that of outside.
printed circuit board; blind via; copper plating; additive; filling ratio; electrodeposition rate
TQ153.14
A
1004 - 227X (2016) 17 - 0896 - 06
2016-05-17
2016-08-14
广东省科技计划项目(2016A010103035);广东省自然科学基金(2016A030313704)。
张波(1991-),男,湖南湘西人,在读硕士研究生,主要从事PCB工艺技术研究及药水开发。
潘湛昌,博士,教授,(E-mail) panzhanchang@163.com。

