短波碲镉汞电子雪崩二极管的模拟仿真
张智超,闻 娟
(华北光电技术研究所,北京 100015)
1 引 言
碲镉汞材料是一种优异的红外半导体材料,具有随组分可调的禁带宽度。从20世纪70年代报道碲镉汞二级管具有雪崩增益特性以来,国外众多机构对碲镉汞的雪崩机理及制造工艺进行了大量深入研究。研究发现随碲镉汞材料截止波长的变化,碲镉汞雪崩二级管具有不同的雪崩机制:室温下,当碲镉汞材料的截至波长短于1.9 μm时,碲镉汞材料的能带间隙接近或等于自旋分裂能,空穴电离系数的共振增强使得空穴电离系数远大于电子电离系数;当碲镉汞材料的截至波长大于1.9 μm时,随着截至波长的增加,电子的有效质量降低导致电子电离系数迅速增加,而空穴电离系数的共振增强效应消失,并且随着截至波长的增加而减小,因此电子电离系数超过空穴电离系数。电子电离系数与空穴电离系数的差异使得碲镉汞雪崩二极管的过剩噪声因子接近1,使得碲镉汞雪崩二极管具有低噪声特性。国外已经研制出基于环孔结构[1]、PIN结构[2]和吸收倍增分离结构[3]的碲镉汞雪崩二极管高性能器件。由于碲镉汞雪崩二极管能够对接受信号进行放大输出,提高了系统信噪比,可用于光子计数、激光雷达、密码量子学和空间光通信等需要响应低弱信号的场景[1]。
碲镉汞雪崩二极管工作在高反向偏压下,器件的暗电流水平限制了器件的灵敏度和可用雪崩增益,因此改善暗电流特性是获得高性能碲镉汞雪崩二极管器件的关键。本文采用silvaco仿真软件对短波(x=0.43)N-on-P平面PIN结构的碲镉汞e-APD器件的暗电流、雪崩增益及量子效率进行了仿真分析,仿真结果表明,合理设计器件结构和优化材料生长工艺及器件制造工艺可以改善暗电流特性,是获得高性能碲镉汞e-APD器件的关键。
2 数值模型
2.1 器件结构
器件的仿真模拟是求解由泊松方程、电子与空穴的连续性方程、电流输运方程构成的耦合非线性偏微分方程组的过程。本文使用商用半导体软件silvaco TCAD的atlas模块对碲镉汞e-APD器件进行仿真模拟。在平面结构中必须考虑横向电场的作用,因此采用二维结构进行仿真。器件的基本结构如图1(a)所示,在P型碲镉汞衬底上通过硼离子注入形成高掺杂浓度的N+区,离子注入产生的间隙汞原子向衬底内部扩散,消除P型碲镉汞材料中的汞空位,形成低掺杂浓度的N-区,最终形成平面PIN结构。在仿真过程中假设各区域是均匀掺杂,为保证仿真精度和提高仿真速度,在电场变化剧烈的区域增加网格密度,考虑到器件结构的对称性,采用的器件网格结构如图1(b)所示。仿真中采用的结构参数与材料参数见表1。
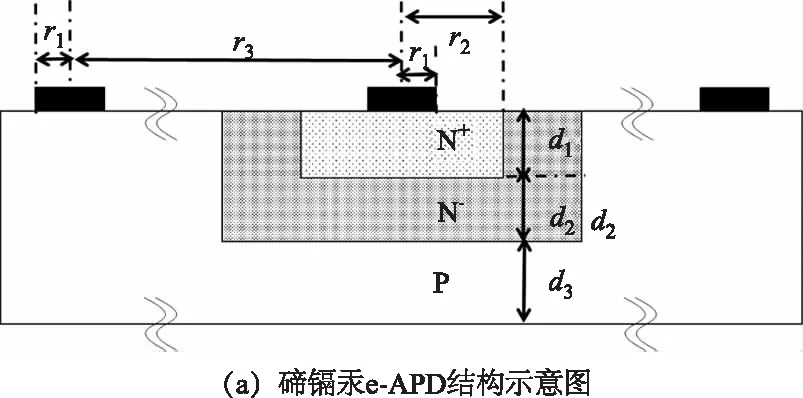
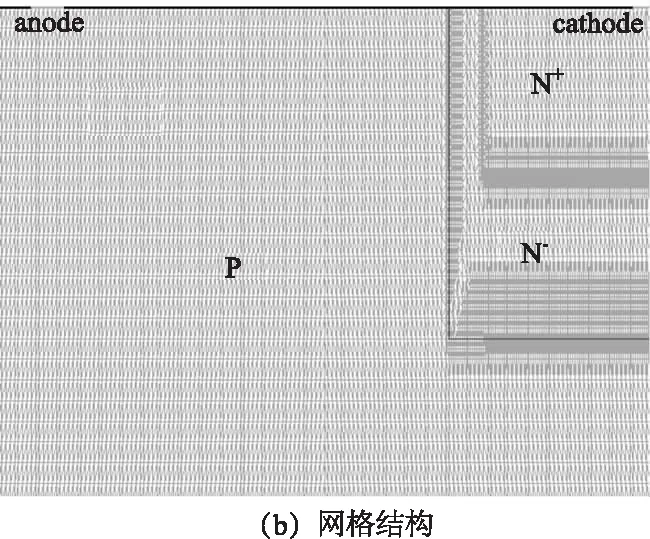
图1 碲镉汞e-APD器件仿真结构Fig.1 Structure for simulation of HgCdTe e-APD表1 碲镉汞e-APD器件结构及材料典型参数[9]Tab.1 Parameters for HgCdTe e-APD structure and material

参数数值参数数值N+区厚度d1/μm)2组分x0.43N-区厚度d2/μm2温度T/K80P区厚度d3/μm2SRH寿命/s1×10-6电极半径r1/μm1陷阱密度/cm-31×1014注入区半径r2/μm10陷阱能级/V0.3EgN、P电极间距r3/μm36电子有效质量0.03N+区掺杂浓度 Nd/(cm-3)2×1018Auger/n/(cm6/s-1)1.74×10-26N-区掺杂浓度 N/(cm-3)2×1014Auger/p/(cm6/s-1)3.48×10-27P区掺杂浓度 Na/(cm-3)2×1016CCOPT/(cm3·s-1)3.21×10-10
2.2 暗电流机制[4-8]
碲镉汞e-APD探测器的灵敏度与可用雪崩增益受到暗电流的限制。主要的暗电流机制有:扩散电流(Jdiff)、产生-复合电流(Jgr)、陷阱辅助隧穿电流(Jtat)、带间直接隧穿电流(Jbtb)、表面复合电流(Jsurf),碰撞电离。表面复合漏电可以使用与PN结并联的电阻进行简化模拟,这里不予考虑。
1)扩散电流
扩散是二极管的基础电流机制,与材料本身的性质直接相关。扩散电流通过求解漂移-扩散方程
得到:
式中,q是电子电荷;Ln和Lp分别是电子和空穴的扩散长度;Dn和Dp分别是电子与空穴的扩散系数;np0和pn0分别是P型区与N型区的平衡少子浓度;K是玻尔兹曼常量;T是晶格温度。
2)产生复合机制
半导体的产生复合过程包括SRH复合、俄歇(auger)复合和辐射(radiative)复合。
SRH复合的复合速率为:
TAUN0[p+nieexp(-ETRAP/kTL)]}
(2)
式中,Etrap是深能级与费米能级之差;TAUP0和TAUNO分别是空穴和电子的SRH寿命;nie是本征载流子浓度;TL是晶格温度。
俄歇复合的复合速率为:
式中,AUGN和AUGP是俄歇复合系数。
辐射复合的复合速率为:

3)陷阱辅助隧穿机制
陷阱辅助隧穿的复合率为:
RTAT=



4)带间直接隧穿机制
直接隧穿的产生率为:
式中,Eg是材料的禁带宽度;E是电场强度。
5)碰撞电离
国外研究表明Okuto-Crowel(O-C)模型通过选取合适的参数能够很好地吻合碲镉汞e-APD器件实际增益特性。在碲镉汞e-APD器件中只考虑电子的碰撞电离过程(取0),电子的电离系数可表示为:
αn(E)=αEcexp(-b/E)
(11)
αEg/q≈22V1-c/ cm1-c
(12)
bq/Eg≈115000 cm1-c
(13)
式中,αn是电子的碰撞电离系数;c是由实际增益特性的拟合参数,取=0.6。
3 结果与分析
3.1 暗电流特性
碲镉汞e-APD器件为实现雪崩放大,需要在具有一定宽度的低掺杂的增益区内形成高电场,电子在电场的加速作用下获得能量并与晶格碰撞。当电子的能量超过一定的阈值后,会引发碰撞电离产生新的电子空穴对,实现对电流的放大。为满足碰撞电离所需的能量,碲镉汞e-APD器件需要工作的高反向偏置电压下,暗电流特性如图2所示。
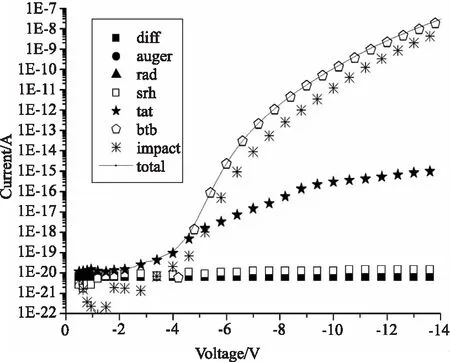
图2 暗电流特性Fig.2 Characteristic of dark current
从图2中可以看出,在高偏压(>5V)区域,BTB机制成为暗电流的主导机制,同时碰撞电离机制的作用逐渐增强,使器件表现出雪崩过程。TAT机制对器件暗电流的影响主要体现在中偏压区域,而俄歇复合及辐射复合两种本征电流机制在整个仿真电压范围内都不是主导电流机制。
图3是电学参数在仿真结构中的二维分布,横纵坐标表示与图1(b)对应的空间位置坐标。从图3中可知电场、BTB隧穿和电子碰撞电离均集中在低掺杂的雪崩放大区。这是由于雪崩放大区掺杂浓度低,是高阻区,外加的工作偏压主要降落在雪崩放大区。外加电压在雪崩放大区内形成高电场区,在雪崩放大区之外,电场强度迅速降低。由式(8)和(11)式可知BTB复合率和电子电离系数是电场强度的函数,在高电场作用下,雪崩放大区的碲镉汞能带发生弯曲,电子隧穿通过禁带的几率上升;电子在电场的作用下不断加速运动获得能量,当电子能量超过一定的阈值后,在与碲镉汞晶格的碰撞过程中将能量传递给晶格上的原子,使电子跃迁产生电子空穴对,产生雪崩放大现象。因此BTB与碰撞电离过程集中发生在雪崩放大区,是高偏压下暗电流的主要来源区域。

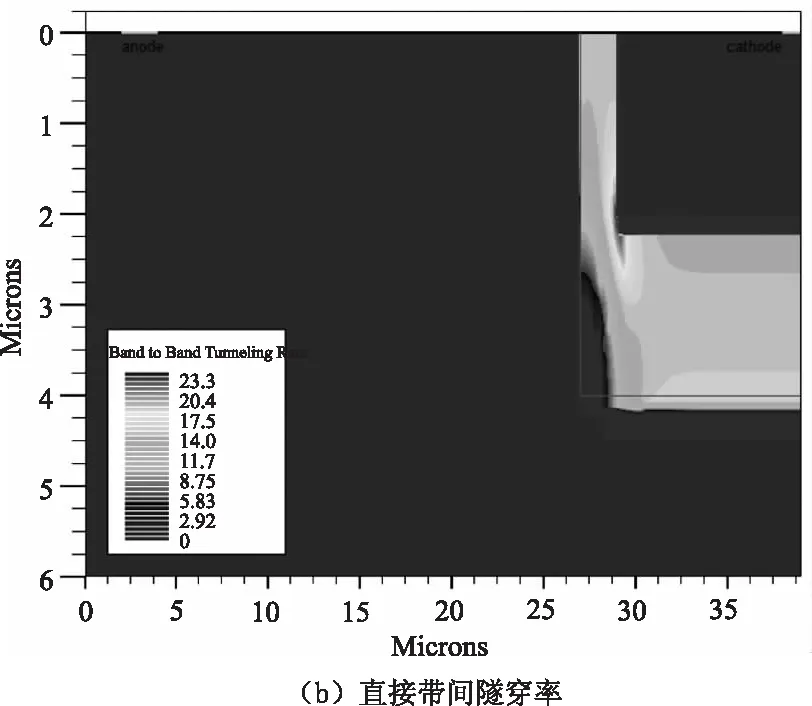
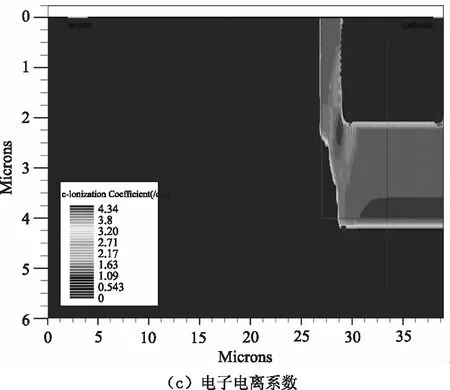

图3 电学参数分布Fig.3 Distribution of the electrical parameters
图4是不同雪崩增益区宽度的暗电流特性。由图可知,在不同雪崩放大区宽度的结构中,高反向偏压下的BTB电流均是暗电流的主导机制,并且随着宽度的增加,电流机制的转变电压也随着上升。由图3可知外加电压主要降落在雪崩放大区上,在雪崩放大区内电场强度变化基本恒定,因此随着雪崩放大区宽度的上升,电场强度逐渐下降,使得BTB电流随之下降。

图4 不同雪崩增益区宽度的暗电流特性Fig.4 Dark current with diffent avalanche gain width
碲镉汞材料对材料生长工艺和器件制造工艺非常敏感,容易在碲镉汞材料中引入陷阱能级。陷阱能级作为复合中心,导带中的电子与价带中空穴可以通过位于禁带中的陷阱能级进行复合,在器件中引入漏电,在长波碲镉汞器件中陷阱能级和陷阱密度是影响TAT电流的重要因素。由图2可知,陷阱能级引发的辅助隧穿机制在低偏压区占主导,图5(a)表明短波碲镉汞器件暗电流对固定在0.3 Eg处的陷阱能级密度不敏感,陷阱能级对碲镉汞暗电流的影响有限。图5(b)表明相比陷阱密度,陷阱能级的位置对短波碲镉汞器件的暗电流的影响更大。这是因为短波碲镉汞材料的禁带宽度大于长波碲镉汞材料,电子在电场作用下通过陷阱能级的隧穿复合几率要低于长波碲镉汞材料,靠近禁带中心的深能级才是更有效的复合中心,因此应尽量减少接近禁带中心的缺陷能级的引入。


图5 暗电流与陷阱的关系Fig.5 Relationship of dark current and trap
3.2 雪崩增益及量子效率分析
雪崩增益是碲镉汞雪崩二极管的重要特性之一,器件的雪崩增益可以由下式得到:
式中,M是雪崩增益;V是外加偏压;I是有光照时的输出电流;ICC是零偏压下的暗电流。

图6 不同w值下的增益-电压特性(d3=2 μm)Fig.6 Gain-voltage curve with different w(d3=2 μm)
在仿真过程中采用1.57 μm的单色光源作为入射光源,照射在整个仿真结构背面,光源功率为0.5 W/cm2(相当于3.95×1018光子/s·cm2)。为简化处理,假设碲镉汞e-APD背面对入射光无反射损失。按照(14)式处理光电流和暗电流得到器件的雪崩增益,结果如图6所示,随着w值的上升,在固定偏压下的雪崩增益下降。雪崩增益与电子电离系数及雪崩放大区宽度的乘积有关。随着雪崩放大区宽度增加,其上的电场强度下降,导致电子电离系数降低,使得雪崩放大区宽度的增加难以补偿电场强度下降带来的损失。
假设在耗尽区内电场恒定,对O-C模型积分可得到雪崩增益的解析表达式[8]:
M=exp[α(E)w]=exp[aVcw1-cexp(-bw/V)]
(15)
式中,w是雪崩放大区的宽度。
入射光子在作为吸收层的P型碲镉汞材料中转换为光生载流子,只有能被雪崩放大区收集到的光生电子才能引发碰撞电离,实现对初始光生电流的放大。这里采用设定入射光束的宽度固定为15 μm来模拟直径30 μm二极管,不同吸收层厚度器件的雪崩增益曲线及暗电流如图7所示。结果表明器件的增益随着吸收层厚度增加而变大,而暗电流不受吸收层厚度的影响。由于只有从雪崩放大区边界进入的电子才能经历全部雪崩放大区的增益效应,当吸收层厚度接近光的穿透深度时,部分光生电子产生在雪崩放大区内,这部分电子只能经历部分雪崩放大区的增益效应,相当于雪崩放大区宽度降低,使得按照式(14)得到的平均雪崩增益低于预期,随着吸收层厚度的增加,该过程对平均增益的影响降低,表现为相同偏压下雪崩增益逐渐增大。


图7 不同吸收层厚度的器件特性(d2=2 μm)Fig.7 Characteristics of device with different width of the absorb film(d2=2 μm)
随着吸收层厚度的增加,器件在零偏压下的光电流依次为72 nA、57 nA、27 nA和0.16 nA,对应的量子效率依次为76.2%、60%、28.3%和0.16%。这是因为碲镉汞材料(x=0.43)对1.57 μm波长的吸收主要发生在材料表层,光生电子向雪崩放大区扩散的过程中存在复合,随着吸收层厚度的增加进入雪崩放大区的光生电子逐渐减少,使得零偏压下的光电流和量子效率逐渐下降。量子效率的降低表明光电转换效率的下降,影响器件的工作效率。因此需要综合考虑吸收层厚度对量子效率和雪崩增益的影响,在满足增益需求的条件下尽量减少吸收层厚度,使器件性能最优。
4 结 论
从仿真结果可知,工作在80 K的短波碲镉汞e-APD平面PIN器件的暗电流及雪崩增益受到器件结构设计及材料生长工艺及器件制备工艺的影响。当器件的工作偏压逐渐升高时,器件的暗电流的主要成分由TAT电流转变为BTB电流,其中TAT电流对接近禁带中心的陷阱能级更加敏感。当加大雪崩放大区宽度时,器件的暗电流特性有明显改善,而碰撞电离的阈值电压逐渐增加。影响器件工作效率的量子效率随吸收层厚度的增加而下降,而碰撞电离的阈值电压有轻微的降低。因此,要获得高性能的短波碲镉汞e-APD器件需要考虑以下方面:
1)增大雪崩放大区宽度,降低峰值电场强度,抑制BTB电流;
2)选择合适的吸收层厚度,优化量子效率及雪崩增益特性;
3)改善材料生长及器件制备工艺,减少深能级缺陷,抑制TAT电流。

