SSB键合在COB封装中的应用研究
刘译蔓
(中国电子科技集团公司第四十七研究所,沈阳110032)
1 引 言
COB(Chip On Board,板上芯片)技术是将裸露的IC 芯片直接贴装在印刷电路板上,通过键合线与电路板键合,然后进行芯片的钝化和保护,其结构如图1所示[1]。如果裸芯片直接暴露在空气中,易受污染或人为损坏,将难以实现芯片功能,因此须用胶把芯片和键合引线包封起来,这种封装形式也被称为软包封。引线键合是裸芯片与电路板相连接的过程,为电源和信号的分配提供电路连接[2],键合工艺质量的好坏直接关系到整个封装器件的性能和可靠性,也直接影响到封装的总厚度。在COB 封装中,由于将裸芯片直接贴装在印制电路板上,没有对其单独封装,所以能有效地降低成本[3]。早期COB 技术一般只面向对信赖度无过高重视的低阶消费性电子产品,如玩具、计算器、小型显示器、钟表等日常生活用品。例如早期台湾COB 工艺大多由出身IC 封装厂的员工靠家庭代工方式完成,常给人COB 的质量不够牢靠的印象。然而随着时代进步,电子产品趋于轻薄短小,COB 反而有越来越广的用途,如手机、照相机等具有小型化要求的产品大多已导入COB 工艺。

图1 COB 结构示意图
2 COB键合常见问题分析
在PCB 工艺中,镀金层通常是用于保护底部镍层,防止其氧化。在后续的回流焊工序中,金层还会与焊锡在217℃的温度下形成金属间化合物(IMC)并逸走[4]。在PCB 板的制造中,在化学镀Ni-P 镀层上进行化学镀Au 时,由于Ni 的局部腐蚀,若使用含有还原剂的置换镀Au 液,会降低Ni-Au 镀层之间的附着性,引起引线键合不良[5]。在进行COB 键合时,造成无法键合的原因通常主要是镍层被氧化,以及金层质量不佳。此外,镀层表面缺陷会导致黑盘或针状孔缺陷,从而造成键合强度下降[6]。
针对上述问题,采用SSB 键合,作为常规金丝球键合的一种扩展,可极大改善COB 的应用表现。其中,超声铝丝键合和热超声金丝球键合均可用于COB 封装中,热超声金丝球键合由于其较高的引线键合生产能力而更受欢迎[7-8]。
3 SSB键合在COB中的应用
SSB(Stand-Off Stitch Bond)键合是热超声金丝球键合的一种,该方法的键合过程大致如下:先选定第一键合点,再选定第二键合点,压线时,先在第一键合点预植一个金球,然后由劈刀带动金丝移动到第二键合点完成键合,形成线弧的起点,然后劈刀按设定的轨迹运动到第一键合点预植的金球上完成键合,并形成了线弧的终点,至此完成一个完整的键合过程。完成键合的形态如图2所示。该方法也可称为 BSOB(Bond Stitch On Ball),常用于芯片叠层低弧度键合以及芯片间的引线互连中[9]。
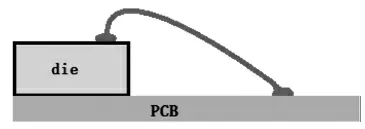
图2 BSOB 键合方式
引线键合有正向键合和反向键合之分。通常来说,正向键合是指第一键合点落在芯片且作为线弧起点,第二键合点落在管壳引脚且作为线弧终点;反向键合则正相反,第一键合点落在管壳引脚作为线弧起点,第二点键合点落在芯片作为线弧终点。
因此,对于SSB 键合,由于线弧起于第二键合点、止于第一键合点,所以在某种程度上可以认为是一种反向键合。
在实际封装中,金丝球键合常由于基板原因发生键合不良等问题。选取某款以镀金PCB 板为基板的模块电路为例,该电路要求芯片与基板焊盘间采用直径25μm 的金丝互连,实物电路如图3所示。在电路试封时,采用与陶瓷集成电路封装相同的键合方式,先完成芯片与PCB 基板的键合,再在PCB 基板焊点上植一个金球,即BBOS(Bond Ball On Stitch),如图4所示。至此,PCB 镀金焊盘上还会出现较大比例的脱焊、虚焊等失效模式。通过调整第二点温度、超声功率、键合压力以及键合时间等参数,键合不良现象仍未得到有效解决。
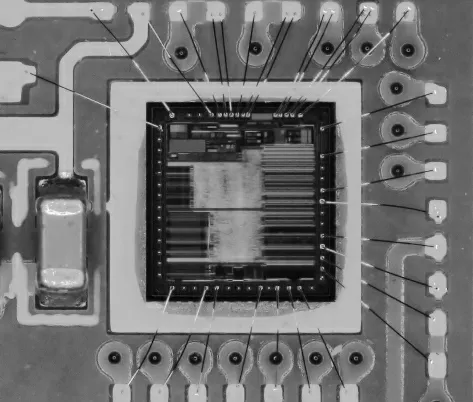
图3 电路实物

图4 BBOS 键合方式
对失效原因做进一步分析,推测为该模块电路采用的PCB 板焊盘镀金层质量较差,且金层表面质量不好,线弧第二点直接落在其表面时,与金丝之间的结合质量差且接触面积相对较小,不能形成牢固有效的结合[10]。随后改用SSB 方法键合,前期在镀金PCB 板进行工艺调试,并选择样品中的10 条线进行键合强度测试,测试样品实物如图5所示。
样品钩线位置选择在引线中间,引线皆在球焊根部断裂,相应的键合强度值如表1所示。从表中数据可见,键合强度值满足GJB548B 方法2011.1 中规定的“直径25μm 金丝密封前键合强度大于等于3.0g”的要求,且未出现球焊、楔焊脱键等现象。

表1 SSB 键合样品强度
此外,为更准确反映楔焊位置键合强度,再取部分引线在靠近楔焊位置进行键合强度测试。测试结果表明拉力值在10g~11g,引线在钩线位置断裂,楔焊焊点保持完整,证明楔焊焊点及焊点根部具有较强的键合强度。测试样品如图6所示。

图6 楔焊点键合强度测试
将该方法应用在模块电路中,并根据焊盘状态对键合参数做适当调整,取得了较好的键合效果并通过了键合目检和键合强度测试,最终实物电路如图7所示。

图7 采用SSB 方法完成键合的电路
4 结束语
与常规的金丝球键合相比,SSB 键合速度要慢一些,但却具有更宽泛的焊盘兼容性,在陶瓷基板焊盘状态不佳或使用PCB 基板焊盘的情况下,可以获得常规金丝球键合难以取得的键合效果,是一种相对理想的键合方法。通过研究SSB 键合工艺,实现了COB 封装的可靠键合。该方法可推广到其他类似的应用场合,具有广泛的应用前景和社会效益。

