国产硅片锥形缺陷的改善方法
陆振杰 李杰 郎玉红
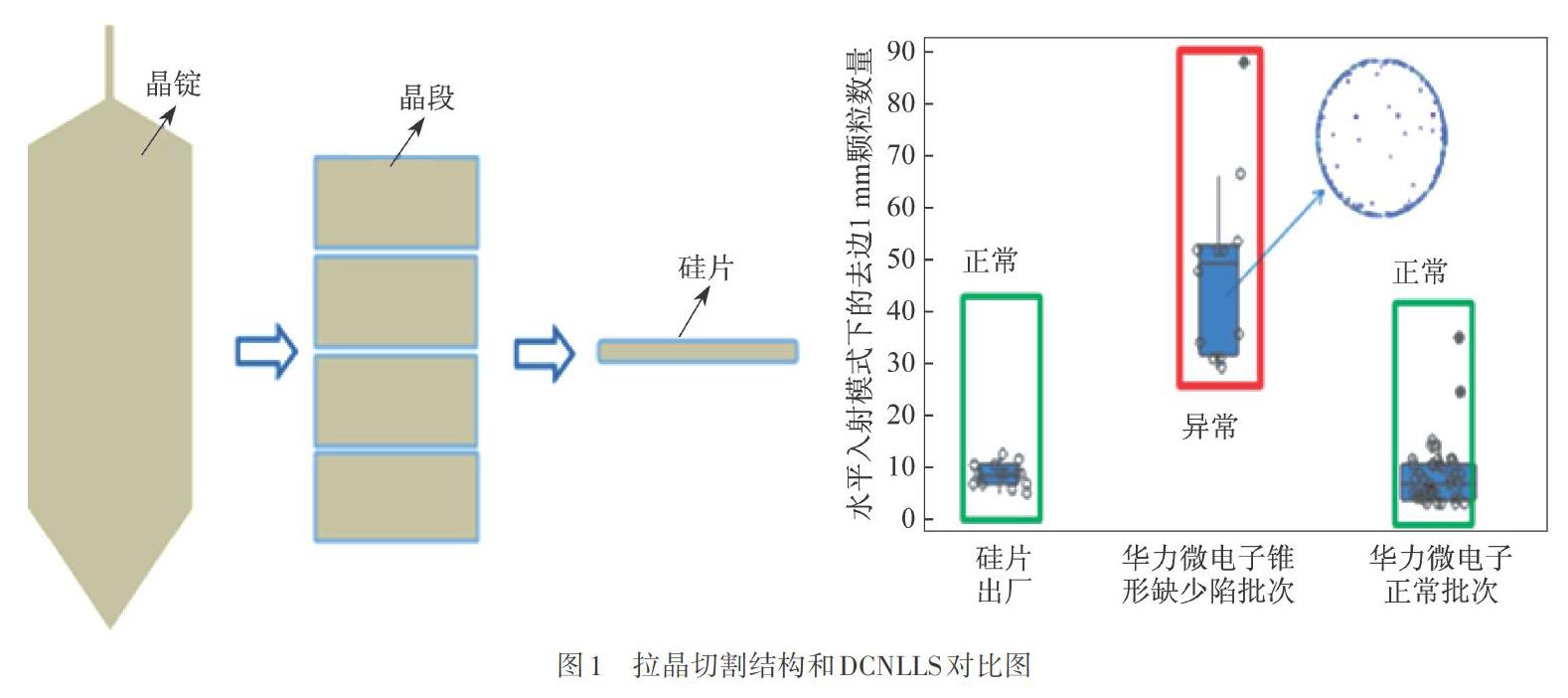
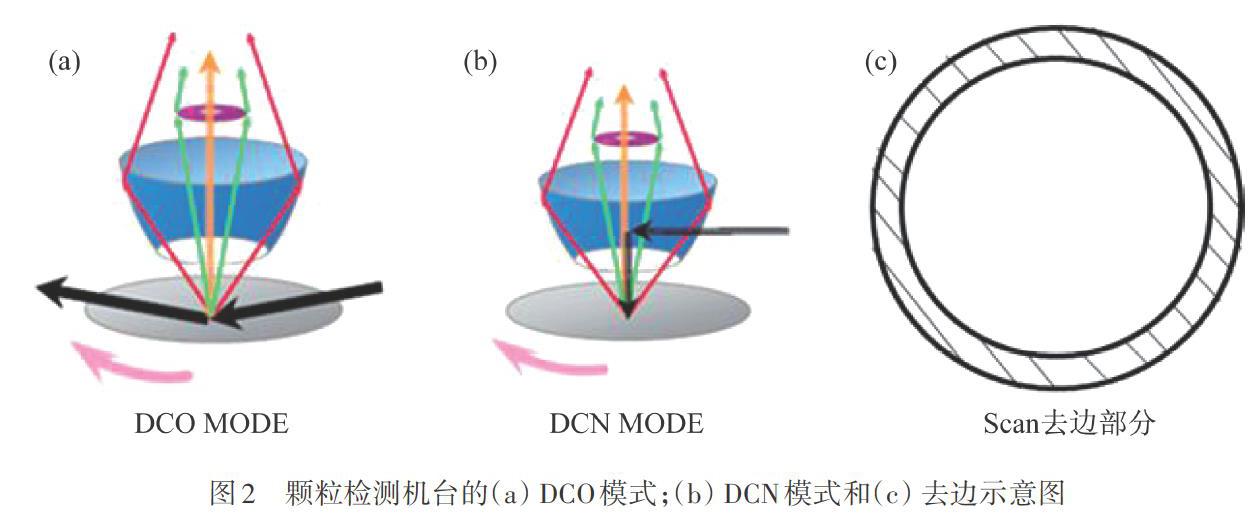
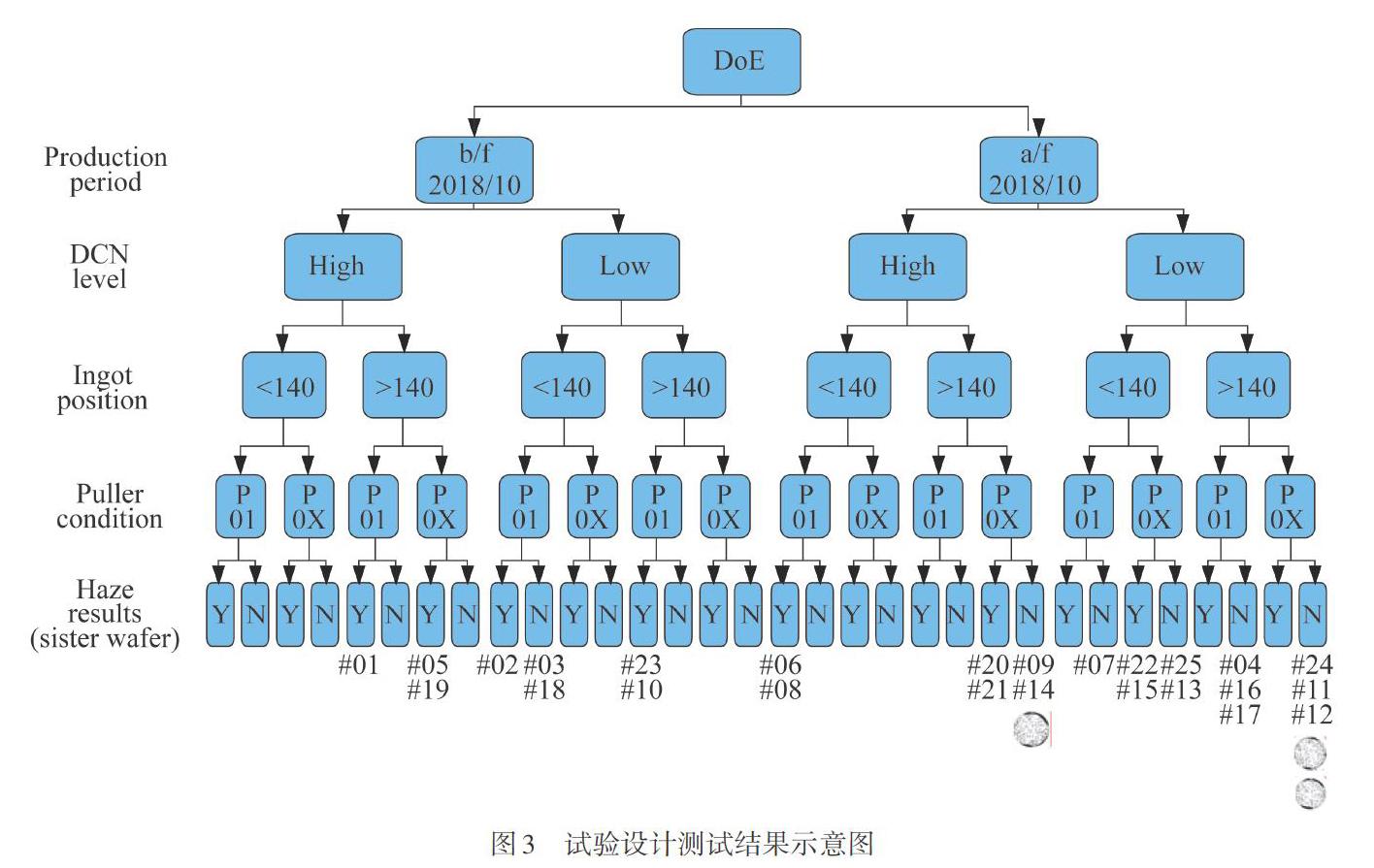
摘 要: 针对某国产硅片在验证过程中的锥形缺陷,通过优化拉晶和制作工艺中的等待时间管控,减少硅片的缺陷,提升硅片的质量.
关键词: 国产硅片; 锥形缺陷; 硅片磨边; 等待时间
中图分类号: TN 47 文献标志码: A 文章编号: 1000-5137(2020)04-0483-04
Abstract: The cone defects in the verification of domestic silicon wafer were focused and studied in the paper.By optimizing the control of the waiting time in pulling and producing during the silicon wafers process,the cone defects of silicon wafers were reduced and the quality of silicon wafer was greatly improved.
Key words: domestic silicon wafer; cone defect; silicon wafer edging; waiting time
0 引 言
硅片,又稱晶圆,是制造半导体芯片的基本材料.硅在自然界中以硅酸盐或二氧化硅的形式广泛存在于岩石、砂砾中.硅晶圆的制造有三大步骤:硅提炼及提纯、单晶硅生长、晶圆成型[1].晶圆的制造属于 “航天级”的尖端技术,难度系数较大.目前全球能制造高纯度电子级硅的企业不足100家,由于布局早、产业链成熟,信越半导体、盛高、环球晶圆、世创、LG(现已更名为SK)等晶圆企业几乎承担了全球80%的晶圆供应量,技术优势非常明显,尤其是在大尺寸的晶圆生产上,且晶圆市场长期处于供不应求的状态[2].
国产硅片的研发和制造起步较晚,但进度很快.近几年,中国大陆在晶圆生产上,逐步形成了长三角、中西部为核心,辐射周边区域的局面,目前很多企业都具备8英寸晶圆的生产能力,但12英寸晶圆的生产技术还不成熟.随着国家02专项的推进,国产硅片势必会在硅片产业中扎实发展.
锥形缺陷是硅片验证过程中出现的问题.锥形缺陷颗粒大小在100 nm左右,在微米级节点工艺中,其几乎不会造成良率损失,但在纳米等级的工艺节点中,小尺寸颗粒的残留会干扰后续的刻蚀工艺,在沟槽中形成很多颗粒缺陷,可能直接影响芯片的良率,干扰缺陷侦测过程.
本文作者就硅片在晶圆制造过程中出现的锥形缺陷,通过对晶圆制备中的磨边清洗工艺的等待时间的研究,发现清洗工艺的等待时间会影响后续锥形缺陷的产生,提出了一种提前侦测异常硅片的监控方法.
1 锥形缺陷发生机理
1.1 锥形缺陷产生的影响因素分析
实际生产中,并非所有硅片都存在锥形缺陷现象.通过对比正常和异常硅片在工艺机台和工艺时间的收敛性发现,即硅片在颗粒检测机台上(与水平面平行入射)模式(DCN)下,去边1 mm的颗粒数量(参数DCNLLS)与锥形缺陷存在较强相关性,如图1所示.
硅片出厂前都需要对表面的颗粒项目进行检测,颗粒检测机入射光源模式有两种:与水平面有20°夹角斜入射(DCO)及与DCN模式,如图2(a),2(b)所示[3].传统硅片关键参数项目中的颗粒检查一般采用DCO模式,去边3 mm,靠近边缘(边缘小于3 mm)的颗粒往往被忽略,如图2(c)所示.
部分正常硅片的DCNLLS可能与异常硅片的DCNLLS数量相当,所以锥形缺陷的产生存在其他的影响因素.因此,将其他可能影响锥形缺陷产生的因素,包括:生产时间、DCN水平、晶棒位置、拉晶机台和硅片表面粗糙度(是否有环形分布),综合在一起,分批次进行(试验设计)测试,如图3所示.
实验结果显示#09,#11,#24硅片的锥形缺陷明显,其中,#11,#24硅片的DCNLLS较低,同时呈现出锥形缺陷,对比其他硅片发现这2片硅片的磨边工艺时间较长,而#09硅片的磨边工艺时间同样较长,所以认为磨边工艺时间也是锥形缺陷产生的一个影响因素.
1.2 锥形缺陷产生的影响因素验证
锥形缺陷一般形成于干法刻蚀之后,在干法刻蚀过程中,因硅片中的金属离子扩散游走而形成的金属硅化物会附在硅片表面,形成掩模层,影响刻蚀的完成度,最终造成锥形缺陷[4].金属离子越多,越活跃,形成锥形缺陷的数量就越多,而硅片的DCNLLS数量和磨边工艺时间都会影响硅片边缘金属的活跃度(图4).
一般来说12英寸硅片的拉晶操作采用直拉单晶提拉法[4],在热场、磁场以及硅汤液界面环境的影响下,在硅片的边缘形成大量氧的沉淀物,这些沉淀物在后续高温工艺(1 000 ℃以上)中会形成Bulk Micro Defect(BMD),通过经典BMD测试方法[5],对晶棒进行3 h,780 ℃和16 h,1 000 ℃的高温退火,切割成硅片,测试BMD密度,发现异常硅片的BMD尺寸没有明显变化,但其边缘处BMD的密度比正常硅片更大.
将多晶硅原料放入石英坩埚中,加热融化后,用一根籽晶拉直,拉晶过程中,过多的BMD会破环硅的体心结构,导致层错[6],这些层错是金属离子扩散的天然管道,更有利于金属离子的扩散.
通过实验验证磨边工艺时间对硅片边缘金属的影响.正常情况下,磨边工艺时间小于1.5 h,没有空闲等待时间,将样本硅片分成4组,每组2片硅片,磨边工艺空闲等待的时间分别是0,1,2和3 h,测试硅片的金属离子浓度.结果显示,随着空闲等待时间的增加,金属离子(Fe/Ni)的数量有明显增加.
综上所述,当硅片边缘的DCNLLS偏高或者磨边工艺的空闲等待时间较长,都会导致锥形缺陷的产生.基于当前实验数据,为硅片的DCNLLS和磨边工艺的空闲等待时间划定一个安全范围,当DCNLLS小于20颗,且磨边工艺时间小于1.5 h(没有空闲等待时间)时,硅片不会发生锥形缺陷.
2 锥形缺陷改善方法
2.1 DCNLLS管控方法
通过和国产硅片厂商合作,最终锁定一个关键的拉晶参数X(处于技术保护需要,不能说明具体的参数名称),X和硅片的DCNLLS数量有很强的相关性,通过优化X的设定,最终达到对DCNLLS数量的合理管控.
由于DCNLLS在晶锭方向有固定的趋势分布,表现为晶棒顶部位置较低,晶棒底部位置较高,只需要对晶锭切割后的Block头尾2片硅片进行DCNLLS测试,就可以确定该Block硅片是否符合要求(图5).
2.2 磨边工艺空闲等待时间管控方法
将样本硅片分为2批次同时作业,磨边单批工艺时间是0.75 h.单批次作业时,每片硅片的作业时间最长不超过0.75 h;2批次作业时,每片硅片的作业时间最长不超过1.50 h.按此作业流程,短期内,硅片作业时间少于1.50 h,待参数监控等系统成熟后,可管控每片硅片实际工艺时间,确保其工艺时间都小于0.75 h.
3 结 论
本文主要针对在国产硅片推进过程中的锥形缺陷问题进行预防和改善.通过和国产硅片厂商的合作,对比正常和异常的硅片,并比较了硅片生产工艺机台和生产工艺时间的收敛性.通过验证实验,发现影响锥形缺陷产生两大主要因素为:DCNLLS数量和磨边工艺的空闲等待时间.从机理上,解释了金属离子导致锥形缺陷产生的过程,并通过有效的监控手段,发现和解决锥形缺陷,防止锥形缺陷的再次发生.
参考文献:
[1] BURDICK G M,BERMAN N S,BEAUDOIN S P.A theoretical analysis of brush scrubbing following chemical mechanical polishing [J].Journal of the Electronchemical Society,2003,150(2):140-147.
[2] BUSNAINA A A,LIN H,MOUMEN N,et al.Particle adhesion and removal mechanisms in post-CMP cleaning processes[J].IEEE Transactions on Semiconductor Manufacturing,2002,15(4):374-382.
[3] STATHIS J H.Percolation models for gate oxide breakdown [J].Journal of Applied Physics,1999,86(10):5757-5766.
[4] 陈畅生.硅中吸除技术的物理機制 [J].半导体学报,1992,13(3):174-180.
CHEN C S.Physical mechanism of gettering in silicon [J].Chinese Journal of Semiconductors,1992,13(3):174-180.
[5] YAMAGISHI H,FUSEGAWA I,FUJIMAKI N,et al.Recognition of D defects in silicon single crystals by preferencial etching and effects on gate oxide integrity [J].Semiconductor Science and Technology,1992,7(1A):135-140.
[6] GRAF D,LAMBER T U,BROHL M,et al.International technology roadmap for semiconductors [J].Journal of the Electrachemical Society,1995,142(9):31892002.
(责任编辑:包震宇)
——国外课堂互动等待时间研究的现状与启示

