二维BN材料中n型掺杂探索:基于第一性原理的带电缺陷计算
刘雪飞,吕 兵,罗子江
(1.贵州师范大学物理与电子科学学院,贵阳 550025;2.贵州财经大学信息学院,贵阳 550025)
0 引 言
二维材料由于具有优异的电学、光学、热学和力学特性已经受到广泛关注。石墨烯,以sp2杂化形成六方单层结构,于2004年被国外研究小组成功制备[1-2],并展示出强烈的双极性电场效应,电子和空穴浓度可高达1013/cm2量级,室温迁移率达到~10 000 cm2/V·s量级[1]。石墨烯的成功制备掀起了二维材料研究的热潮,科学家们相继成功制备出碳氮化合物[3-4]、过渡金属二硫化物[5-8]、磷烯[9-10]等新型二维材料。体相III-V族半导体材料在半导体器件领域的成功应用促使人们开始思考III-V族材料是否可在二维相下稳定存在,并展开系列研究[11-15]。本课题组前期的工作对25种III-V族二维材料的结构、力学、电学等物理性质进行系统计算,并取得一系列丰富的研究结论[16]。实验上,六方二维氮化硼(h-BN)被证明具有较好的力学、电学性能[17-19]。然而,在制备单层二维材料过程中,各种点缺陷的无意引入,会严重改变其物理性质[20-23]。因此对h-BN材料中缺陷被引入的难易程度及缺陷性质进行研究非常必要。过去几年来,有大量学者对二维h-BN中的点缺陷性质进行计算[12,24-30]。然而,他们要么没有考虑缺陷带电,而部分考虑带电缺陷的文献并没有使用合理的二维带电缺陷校正理论对缺陷形成能进行校准,因此所得结论会有较大误差。本课题组在之前发表的文章中系统计算二维h-BN中的四种本征带电缺陷,并证明四种本征缺陷都无法有效提供载流子,而且还扮演着电子或空穴的复合中心,因此会在一定程度影响h-BN单层体系掺杂效率[31]。带电缺陷的计算对确定某种掺杂原子是否能提供有效的n或p型掺杂载流子具有重要意义[32]。然而,据文献调研表明,关于二维h-BN中引入各种替位杂质原子的带电缺陷计算鲜有报道。理论上,将X(X=C, Si, Ge, Sn)原子引入h-BN中替换B原子(XB)可实现n型掺杂,这是由于被替换的原子核外电子比替位原子少一个,从而可为体系提供电子载流子。因此,本文基于第一性原理方法,结合带电缺陷计算理论及二维缺陷形成能校正理论对XB带电缺陷体系进行系统计算。为解决半局域泛函将低估带隙从而影响缺陷性质的精度问题,因此,基于前期工作所提方法[31],本文将半局域泛函结果有效地转换到了杂化泛函精度,提高了结论的可靠性。
1 计算方法
本文基于密度泛函理论并考虑自旋极化,使用(Vienna Ab initio Simulation Package,VASP)代码完成计算[33]。计算中泛函选用(Perdew John P., Burke Kieron, Ernzerhof Generalized gradient approximation)GGA-PBE[34], 赝势选用投影增强波(Projector Augmented Wave,PAW)[35]。传统PBE方法将会低估半导体带隙,因此本文中用杂化泛函(Heyd-Scuseria-Ernzerhof,HSE06)[36]计算h-BN能带结构。为提高计算精度,平面波基组截断能为450 eV,倒空间K点采样使用Monkhorst-Pack方法,K点采样密度为2×1×1,部分结果处理借助于陕西理工大学王伟老师开发的VASPKIT代码[37]。计算过程中,所有原子上的Hellman-Feynman受力均小于0.1 eV/nm,能量收敛判据为10-6eV。在计算过程中,为方便使用Freysoldt和Neugebaue(FN)[29]提出的校正方法,将BN原胞的晶格重新定义为正交形式,并进行扩胞,体系包含100个原子,为克服z方向伪相互作用,沿该方向的真空层厚度为3.75 nm。
在有一定大小超胞中,具有电荷价态q的点缺陷形成能可表示为[32,38-39]
(1)

ΔV0/p=V0|far-Vp
(2)
ΔV0/p是势能校正项,由远离缺陷位置的静电势V0|far与完美超胞静电势Vp之间差决定。μi(i=B,N,C,Si,Ge,Sn)是稳定相原子化学势,在平衡态BN体系中满足:
EBN=μB+μN
(3)
其中,EBN表示一个BN原胞的能量。本文用Pymatgen计算了其它原子的化学势范围[40]。实验研究表明真实材料中缺陷浓度非常小,因此缺陷之间的相互作用较小,形成能公式中计算一个有限大超胞的缺陷形成能,显然无法很好模拟真实缺陷浓度,会有误差[29,41-42],因此有必要对其进行校正:
(4)
(5)

(6)

电荷转移能级在带电缺陷计算中尤为重要,其表达式为[32,38]:
(7)
其中,Ef(q;Ef=0)和Ef(q′;Ef=0)分别表示q和q′价态时的形成能,施主和受主离子化能可由转移能级到CBM和VBM的能量差进行确定:
ID=CBM-E(q/q′)
(8)
IA=E(q/q′)-VBM
(9)
ID以及IA值越小,表示相应缺陷能级越浅。浅能级施主或受主可以为半导体材料提供电子或空穴,从而改善半导体材料的电阻率和载流子迁移率;而深能级对半导体材料的电阻率没有贡献。
2 结果与讨论

图1 二维正交5×5 BN 超胞(100个原子)示意图Fig.1 Schematic diagram of two-dimensional orthogonal 5×5 supercell of BN (100 atoms)
计算所用结构如图1所示,图中较大原子为B, 较小原子为N, n-type替位点缺陷被标为XB, 缺陷附近的键长标为l′, 远离缺陷的键长被标为l,原始的六方BN原胞对应菱形虚线框,正交化以后的原胞对应虚线长方形框,晶格常数被标注为a和b。经过结构优化,发现在远离缺陷处的B-N键长与完美BN中的B-N键长几乎相同,说明缺陷对较远处原子键的影响可忽略,表明所选的超胞尺寸是合理的,确保了后续的计算结果可靠性。在缺陷附近最近邻三个化学键的键长与所选替位原子X的半径有关,X原子半径越大,其X-N键长也越大。另外,可以发现缺陷近邻键长l′对缺陷体系所具有的带电价态不敏感。
基于公式(1),对二维h-BN中四种n-type替位型杂质的缺陷形成能进行计算,并绘制出缺陷形成能随费米能级(电子化学势)变化的函数图(见图2~图5),各图中(a)和(b)分别对应富氮和贫氮化学势环境。图中不同价态用不同斜率表示,粗实线表示在整个电子化学势范围形成能最小的价态,其中转移能级被实心圆点和竖直虚线标注,下面将分别对四种缺陷体系进行讨论。首先,以图2为例详细说明此图中各物理量意义,在公式(1)中,对于给定价态q, 缺陷形成能将会是费米能级的一次函数,因此在图中将会是一条直线,因此对CB体系从-2价到+2价进行计算,将会得到5条类似直线,其中直线的斜率对应不同价态。正价态表示在带隙中的杂质态将向导带贡献电子(施主),负价态表示杂质态将从价带捕获电子(受主),因此理想的浅施主能级应尽量靠近导带边,而理想的受主能级应尽量靠近价带顶。另外,在图2中,斜率发生变化的拐点被称为电荷转移能级(式(7)),被圆点标注。基于本课题组之前发表的工作成果中提出的方法[31],可以将PBE泛函下的电荷转移能级转换到HSE精度,其转换细节在此不再赘述。其中PBE 和HSE 所对应的带隙用箭头标注在图2(a)中,对应的PBE和HSE带隙值分别为4.64 eV和5.67 eV,为使图片更简洁,后文类似图片均未标出。所谓最稳定价态是指在给定费米能级时,缺陷形成能最小的价态。因此,CB体系最稳定价态为+1价和0价,在图中用较粗实线标注(下同)。从结果来看,对于CB体系,其电荷转移能级E(+1/0)发生在距离PBE价带顶2.9 eV处,对应的施主离子化能(式(8))为1.74 eV,表现为深施主能级,转化到HSE精度时,该缺陷转移能级变得更加局域,其HSE精度下施主离子化能为2.00 eV。因此CB将不会对h-BN提供有效的施主型载流子。值得注意的是,由于具有更加小的缺陷形成能,将C原子替换B原子在富氮条件下比贫氮条件相对更加容易。另外,在费米能级靠近价带顶附近(即h-BN处于p掺杂条件),CB一方面具有负缺陷形成能,另一方面具有+1价态,表明在C、N、B共存体系中,C替换B原子后将会自发的捕获价带中的空穴(或发射电子到价带中补偿空穴),从而严重降低h-BN中的p型载流子导电率。

图2 CB体系的缺陷形成能随电子化学势变化图Fig.2 Defect formation energy of CB system as a function of the electronic chemical potential
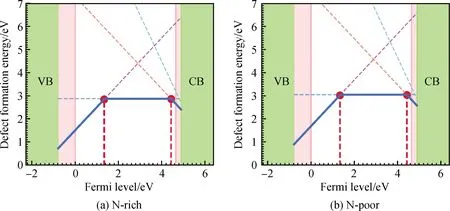
图3 SiB体系的缺陷形成能随电子化学势变化图Fig.3 Defect formation energy of SiB system as a function of the electronic chemical potential
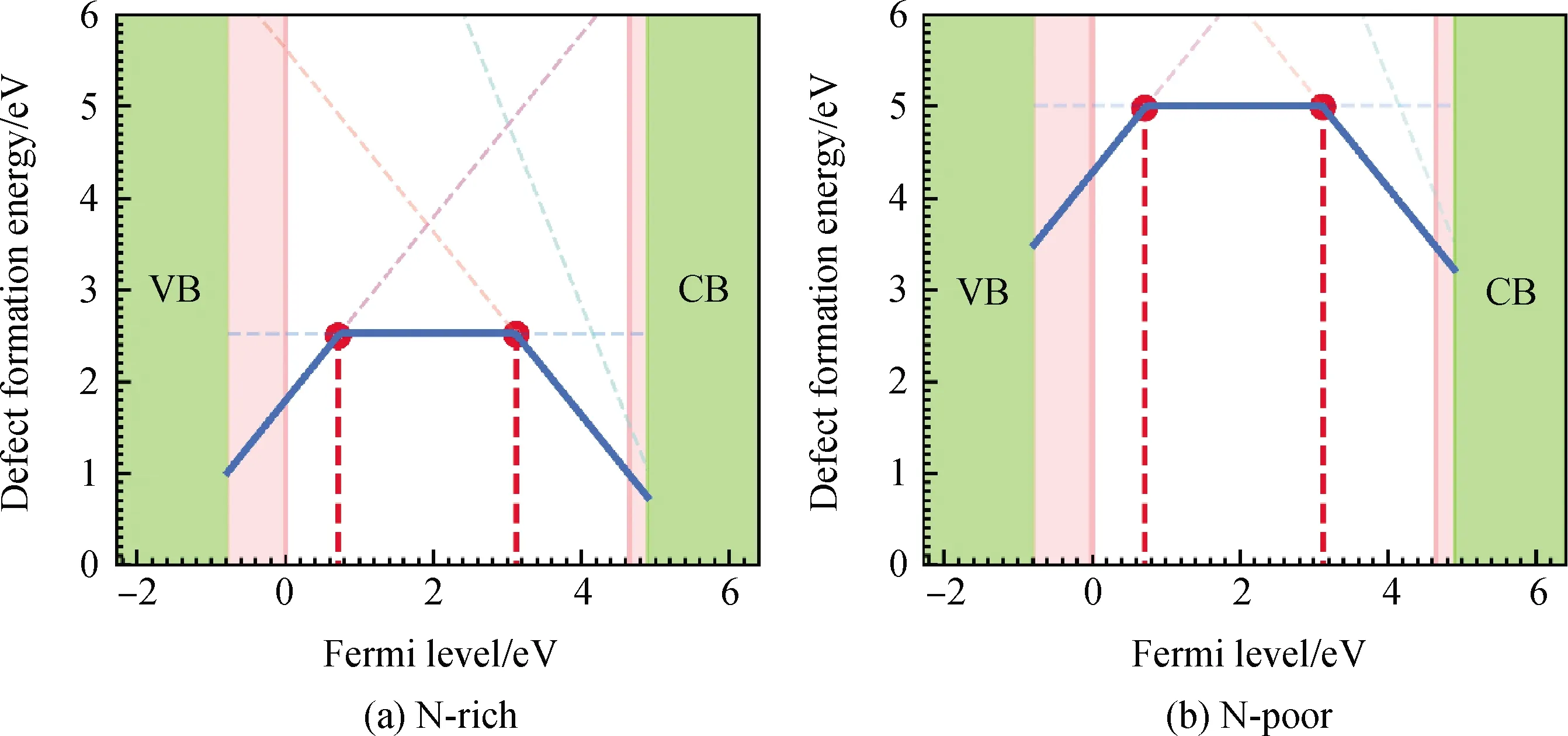
图4 GeB体系的缺陷形成能随电子化学势变化图Fig.4 Defect formation energy of GeB system as a function of the electronic chemical potential
图3绘制了SiB体系缺陷形成能随费米能级变化的函数图,其最稳定价态为+1, 0 和-1价,其中E(+1/0)在PBE和HSE 泛函下分别距价带顶1.3 eV和2.1 eV, 因此对应着施主离子化能为3.34 eV和3.57 eV,为深施主能级,类似的在宿主h-BN材料为p型掺杂时,Si原子的无意引入会导致p型掺杂效率降低,影响空穴导电率。如图4所示,当用Ge原子去替换B原子时,在富氮条件下具有相对较小的缺陷形成能,其最稳定价态与SiB体系类似,即为+1,0和-1价。从其转移能级的结果来看,GeB仍然表现为深能级施主和受主,其HSE精度下施主离子化能为4.06 eV,在富氮条件下,当费米能级靠近带边位置时,GeB具有+1(价带顶)和-1价(导带底),而且其相应的形成能小于1 eV,因此意味着在制备BN时,无意引入的Ge原子将会扮演载流子捕获中心,降低掺杂效率。图5 绘制了SnB体系的缺陷形成能随电子化学势变化图,值得注意的是,该体系费米能级在带隙范围变化时,其最稳定价态只有0和-1价,因此不具备施主能级特性,只具有受主能级特性,但根据前面的分析,可知其表现为深能级受主。同样,在靠近导带底附近,SnB具有稳定的-1价,意味着中性SnB缺陷将从导带捕获电子从而降低h-BN的n型导电率。
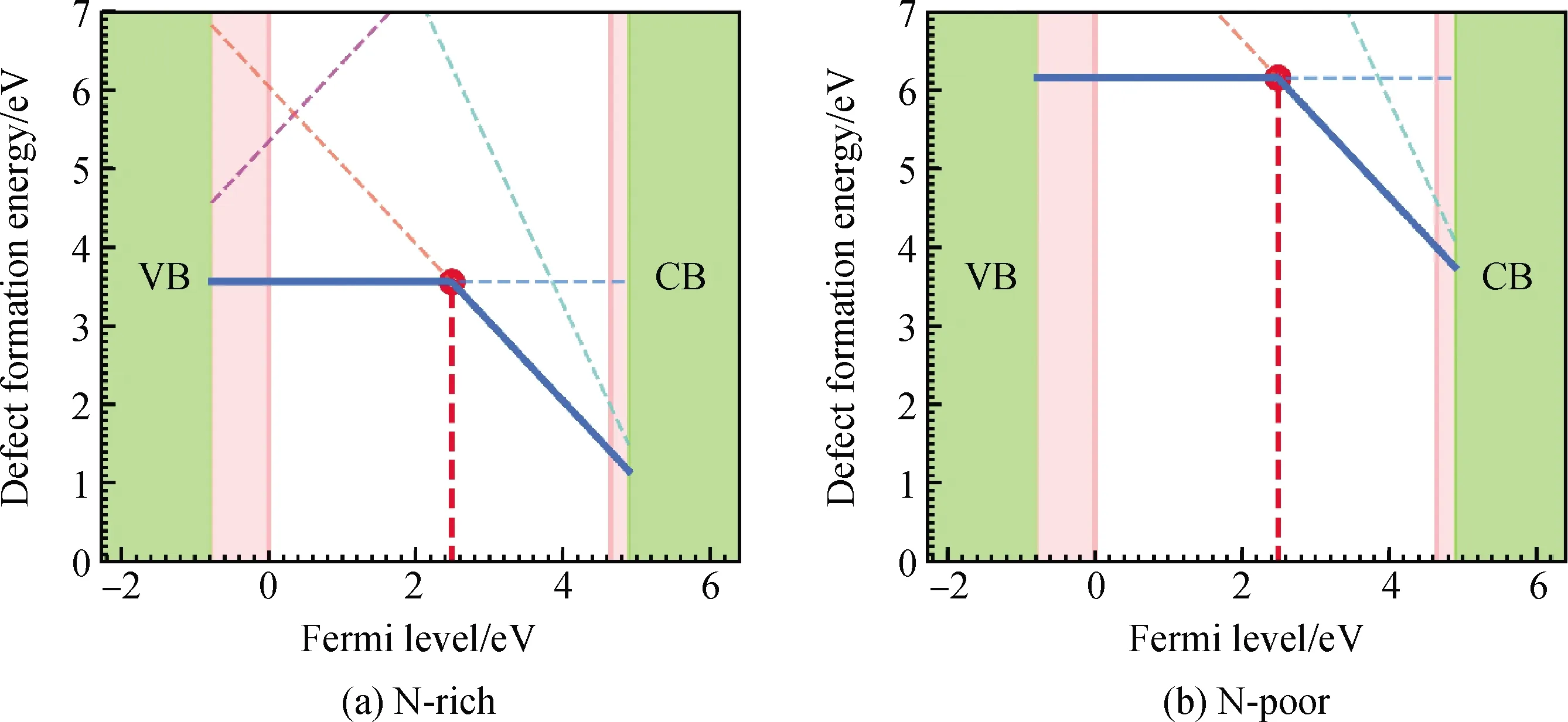
图5 SnB体系的缺陷形成能随电子化学势变化图像Fig.5 Defect formation energy of SnB system as a function of the electronic chemical potential
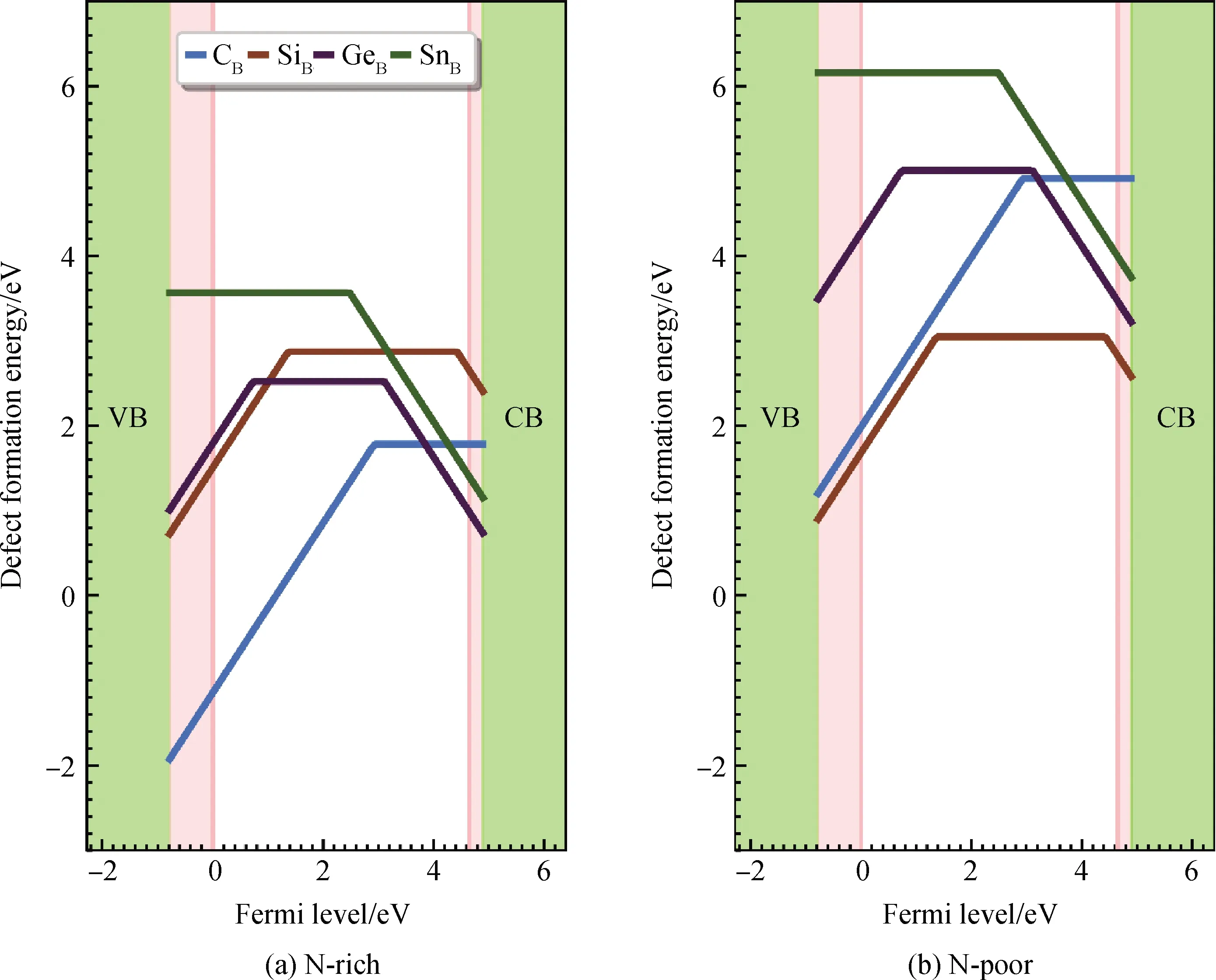
图6 四种n-type缺陷体系最稳定价态对应的缺陷形成能随电子化学势变化图Fig.6 Plots of defect formation energy changing with electronic chemical potential corresponding to the most stable charge state of four n-type defect systems
图6绘制了二维h-BN体系中四种缺陷体系的最稳定价态随费米能级变化的函数图。整体来讲,各缺陷体系均是在富氮条件下具有相对较小的缺陷形成能。另外该图也可以直观看出CB体系在费米能级从价带顶到3.6 eV左右均是最稳定的缺陷,而从3.6 eV 到导带底范围内GeB则成为最稳定缺陷,需要注意的是CB在p型掺杂的h-BN中由于在+1价态具有负形成能,很容易捕获价带中的空穴从而降低空穴导电率。图7进一步将各体系的电荷转移能级绘制出来,从中可以直观看出各缺陷转移能级的相对分布位置,根据前文详细的讨论,在图7中的所有施主型能级和受主型能级均为深能级,其中CB(SnB)仅具有施主(受主)型能级,而SiB和GeB则同时表现出深施主和受主特性,对比前三种缺陷体系,也可看出随着IV族原子的增大,其施主型能级越来越局域(变深),而对比后三种缺陷体系则发现其受主型能级越来越浅。

图7 四种n-type体系的电荷转移能级分布图Fig.7 Charge transition energy levels of the four n-type systems
3 结 论
本文基于第一性原理方法和二维带电缺陷校正理论,对二维h-BN中四种可能的n型掺杂体系进行系统计算及深入讨论,结果表明对于宽带隙半导体h-BN,很难实现n型掺杂,其中施主型离子化能最小的CB体系也具有2.00 eV离子化能,是典型的深能级施主,且研究表明四种缺陷体系的施主特性随替位原子半径增大而变深,其受主特性也将随替位原子半径增大而变浅。另外,CB体系在宿主h-BN处于p型掺杂条件下具有最小的形成能,表现出+1价稳定价态,将会捕获价带中的空穴,从而降低h-BN p型载流子导电率。本研究证明了宽禁带半导体h-BN很难通过单种原子实现n型掺杂,从而可为实验提供一定指导。

