低光能触发的砷化镓光导开关导通机理
徐守利 刘京亮 胡 龙 倪 涛 许春良
低光能触发的砷化镓光导开关导通机理
徐守利1刘京亮1胡 龙2倪 涛1许春良1
(1. 中国电子科技集团公司第十三研究所 石家庄 050050 2. 西安交通大学电子科学与工程学院 西安 710049)
该文建立了砷化镓(GaAs)光导开关(PCSS)的一维器件仿真模型,研究了低光能触发条件下电流通道内关键物理参数的瞬态变化过程,提出了GaAs PCSS的多雪崩电离畴物理模型,能够自洽地解释低光能触发、超快速导通和电压锁定等开关特征。GaAs PCSS受12 W、905 nm脉冲激光触发后,电流通道内产生多个高场强(200~600 kV/cm)雪崩电离畴,雪崩电离畴随等离子体浓度的提高而发展、湮灭,导致开关延迟3.0 ns后在147 ps内超快速导通。开关导通后,电流通道内仍存在少量雪崩电离畴,使开关导通后电压锁定。雪崩电离畴运动导致GaAs PCSS工作时出现ps级电流振荡现象,分析了振荡信号产生的物理原因。同时,开展了低光能触发条件下GaAs PCSS雪崩导通实验研究。结果表明,当采用50 Ω固态脉冲形成线、4 mm间距异面结构、PCSS工作电压为17.5 kV时,负载输出脉冲峰值功率达MW级,脉冲上升时间约为620 ps,最高重频达到20 kHz。
脉冲功率 光导开关 雪崩电离畴 低光能触发 亚纳秒
0 引言
高功率微波因具有巨大的军事应用价值,已成为当前军事竞争的战略制高点。高功率微波武器是利用定向辐射的高功率微波束干扰、扰乱、降级甚至烧毁敌方电子设备的一种定向能武器[1-4]。
高功率微波按频带宽度一般分为窄带高功率微波和超宽带高功率微波。窄带高功率微波的产生主要依赖气体开关的脉冲驱动源和电真空器件的微波源[5]。相对于窄带高功率微波,超宽带高功率微波覆盖的频谱范围更宽,理论上作用目标范围相对更广。超宽带高功率微波的产生主要依赖气体开关的脉冲源和后级的气体陡化开关,微波功率可达到数十吉瓦。但系统复杂、体积和质量庞大,受限于开关恢复时间,重频水平仅为百赫兹量级[6-8]。随着半导体技术的不断进步,半导体器件的峰值功率不断提升,基于半导体器件可构建固态化的高重频超宽带微波系统,进一步拓展了超宽带高功率微波的应用。雪崩砷化镓(Gallium Arsenide, GaAs)光导开关(Photoconductive Semiconductor Switch, PCSS)所需的触发光能量相比于Si和SiC PCSS低约3~5个数量级。GaAs PCSS工作电压高达数百千伏、开通时间为百皮秒、延时抖动仅为数十皮秒、触发光脉冲能量为数纳焦、重频达到千赫兹以上,在超宽带高功率微波中具有重要应用价值[9-11]。
GaAs PCSS导通过程中产生电流丝通道,其密度高达106A/cm2量级以上,导致PCSS寿命有限。若要解决器件寿命难题,必须要深入研究器件的工作机理。目前,已有陷阱俘获场模型、双注入和深能级陷阱俘获模型、深能级杂质电离模型、阳极雪崩注入模型、局部电离模型、流注模型、集体碰撞电离模型、光激发电荷畴模型等数种物理模型来解释GaAs PCSS雪崩导通机理[12-20]。上述模型可以解释器件的个别工作特征,虽尚未能自恰地解释器件低光能触发、超快速导通、电压锁定(lock-on)等各工作特征,但为后续的研究工作起到很好的借鉴作用。基于半导体器件仿真工具无法模拟获得PCSS电流丝的形成过程,因此对全尺寸GaAs PCSS仿真时,并不能获得超快速的雪崩导通物理过程。实际上,PCSS雪崩导通仅发生在电流丝通道内,故可将模型中的器件结构等效为电流丝结构,只仿真电流丝内的物理过程。因此,在低光能触发条件下获得了GaAs PCSS超快速导通的整个瞬态过程,并观察到了多雪崩电离畴形成、演变及湮灭过程[21]。多雪崩电离畴的演变物理过程导致的超快速导通需要深入分析,尤其是雪崩电离畴演变运动所引发的新物理现象更值得关注。本文深入研究了GaAs PCSS雪崩导通过程中,雪崩电离畴的产生和演变动态过程,为器件的工程设计和应用提供理论指导依据。
1 器件仿真模型
1.1 砷化镓参数模型
基于Silvaco Atlas器件仿真工具建立GaAs PCSS一维器件-电路混合模型。P. M. Smith等通过实验测取了GaAs在高场强下的电子速度,当电场强度在20~200 kV/cm范围内时,电子速度随电场强度的提高而降低[22];S. N. Vainshtein等的实验结果表明,电子微分迁移率在特征电场强度th至600 kV/cm的范围内仍为负[23]。根据上述研究结果,PCSS仿真模型中电子迁移率为
式中,为电场强度;th为特征电场强度,本文取4.0 kV/cm;sn为电子饱和速度,取5.0×106cm/s;n0为低电场电子迁移率,取7 000 cm2/(V·s)。
空穴迁移率为

式中,sp为空穴饱和速度,取6.6×106cm/s;p0为低电场空穴迁移率,取400 cm2/(V·s)。
载流子电离系数是PCSS仿真模型中重要的物理参数。参数模型中的电子、空穴电离系数取值与实测值一致[24]。电子、空穴的电离系数分别为


式中,n0取2.1×105cm-1;n取6.2×105V/cm;p0取2.5×105cm-1;p取7.2×105V/cm。
载流子复合包含两种复合模型:Shockel-Read- Hall(SRH)复合和俄歇(Auger)复合。SRH复合模型的载流子复合率表示为

式中,和分别为电子浓度和空穴浓度;n为电子寿命,取1.0×10-9s;p为空穴寿命,取2.0×10-8s;ie为本征载流子浓度。SRH复合是通过杂质或缺陷等复合中心的电子和空穴复合。在PCSS器件模型中,电子和空穴寿命采用仿真工具中GaAs材料的推荐参数值。
电子与空穴复合时,把能量或者动量通过碰撞转移给另一个电子或另一个空穴,造成该电子或空穴跃迁的复合过程称为Auger复合。Auger复合模型的复合率表示为

式中,n和p分别为电子和空穴的Auger系数,采用仿真工具中GaAs材料的推荐参数值[25],n取5.0× 10-30cm6/s,p取6.0×10-31cm6/s。
光在半导体材料内传播时,光子被材料吸收产生电子-空穴对。光致载流子生成率表示为

式中,为光功率;0为量子效率;为光传播相对距离;为普朗克常数;为光波长;为光传播速度;为光吸收系数。GaAs材料的本征吸收界约为873 nm,仿真和实验采用的光波长均为905 nm。GaAs材料吸收905 nm激光的量子效率约为0.66[26]。光吸收系数不仅与波长有关,且受偏置电场影响。根据Franz-Keldysh效应[27],905 nm波长激光在88 kV/cm电场偏置的GaAs中吸收系数为3.61´102cm-1。
1.2 仿真电路
PCSS雪崩导通时形成高密度电流通道,假设光脉冲注入时刻电流通道即已形成,最高电流密度设为1.0×106A/cm2。半绝缘GaAs电阻率达到108Ω·cm,电子迁移率大于6 000 cm2/(V·s)。根据电阻率和电子浓度关系,模型中GaAs掺杂浓度为107cm-3。电极间距为0.1 mm。雪崩电离畴宽度最小约为0.1 μm,相邻网格点的间距设为0.01 μm,以保证每个雪崩电离畴描述的网格点足够多。触发光波长为905 nm,对应光子能量为1.375 eV。GaAs材料禁带宽度为1.42 eV,材料内EL2缺陷能级距离导带间隙为0.75 eV。缺陷能级上的束缚电子吸收注入光子后,非本征跃迁至导带,形成初始载流子。PCSS触发位置由阴极沿电场方向注入。
异面结构PCSS、一维等效电流通道及模拟电路如图1所示。直流电源dc通过充电电阻c向电容(100 pF)充电,待电容充电至880 V工作电压时,开关S1关断,光脉冲从阴极触发PCSS。光脉冲功率为12 W,脉宽为1.3 ns,能量约为15.2 nJ。电路模拟中,最小时间步为1´10-6ns,满足PCSS整个雪崩导通过程的时间精度要求。波长905 nm的光在GaAs材料的吸收系数为3.61´102cm-1,即光功率透射2.77´10-2mm深度时功率衰减至原功率的36.8%。PCSS导通后,电容向50 Ω负载放电。

图1 PCSS模拟电路
1.3 仿真电路波形
PCSS电压、负载电压和光脉冲功率波形如图2所示。图中,0=50.0 ns、1=52.983 ns、2=53.130 ns、1,2=53.011 ns。开关电压提高至880 V时,PCSS偏置电场强度为88 kV/cm,50 ns时刻光脉冲沿电场方向触发PCSS阴极。PCSS延迟时间为3.0 ns,导通时间为147 ps。在线性模式下,PCSS的输出波形几乎是触发光脉冲的线性响应,而模型中PCSS的导通时间远小于触发光脉冲前沿(约为1 ns)。此外,PCSS输出脉冲峰值功率为12.8 kW,相对光脉冲峰值功率增益约为1 000倍。因此,PCSS工作于雪崩模式。

图2 电路模拟波形
根据电流通道内电场强度、载流子浓度等关键物理参数分布变化,PCSS的导通过程可分为三个阶段:延迟阶段(0≤<1)、超快速导通阶段(1≤<2)和电压锁定阶段(≥2)。
2 PCSS导通瞬态物理过程
2.1 延迟阶段
光脉冲触发PCSS时,阴极受光区吸收光子产生了电子-空穴对。在电场作用下,电子向阳极漂移,空穴向阴极漂移。阳极处产生高电场区,峰值电场强度大于250 kV/cm。阳极高电场区及雪崩畴形成如图3所示。高电场区内载流子雪崩倍增,产生的空穴向阴极漂移,电子向阳极漂移。由于阳极高电场区的雪崩注入作用,阴极处光注入等离子体区外的空穴浓度逐渐提高,结构内形成初始等离子体。光注入等离子体区边界电场强度大于th时,产生初始偶极畴,如3a所示。初始偶极畴向阳极运动,积累层电子浓度提高,畴峰值电场强度提高,初始偶极畴发展为高电场(电场强度大于200 kV/cm)的雪崩电离畴。从52.268~53.543 ns的时段内,畴峰值电场强度由71.67 kV/cm提高至274.32 kV/cm,PCSS两端电动势差sw变化率为-1.67 V/ns,如图3b所示。在52.389 ns时,当光注入等离子体区边界处电场强度大于th时,产生了新的初始偶极畴。
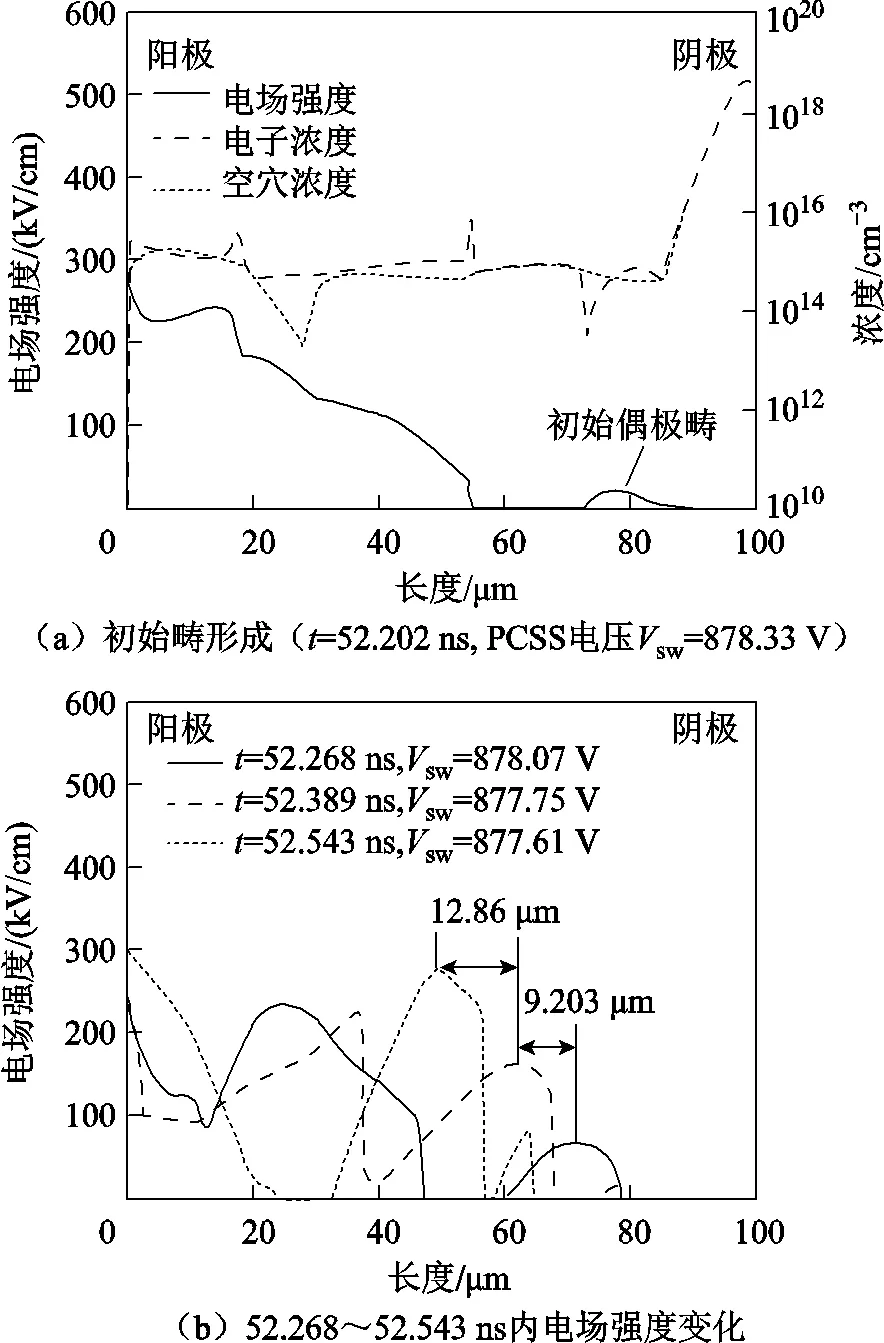
图3 阳极高电场区及雪崩畴形成
雪崩电离畴向阳极运动,畴内载流子雪崩倍增,导致畴后等离子体浓度高于畴前等离子体浓度。等离子体浓度提高使雪崩电离畴宽度减小,从而导致畴两端电动势差减小。当光注入等离子体区边界处电场强度再次大于th时,产生一个新的初始偶极畴向阳极运动,并在高等离子体浓度条件下迅速发展为雪崩电离畴。因此,随着等离子体浓度提高,形成了多个雪崩电离畴同时向阳极运动,并使等离子体浓度加速提高。52.839~52.881 ns时,电流通道内多雪崩电离畴的演变如图4所示。畴宽度随等离子体浓度提高而迅速减小。雪崩电离畴产生、运动过程中,电流通道内等离子体浓度提高,导致雪崩电离畴峰值电场强度提高、数量增多、宽度减小。雪崩电离畴峰值电场强度提高,又加速了畴内载流子雪崩倍增,导致等离子体浓度进一步提高,因此,雪崩电离畴的演变是一个正反馈过程。

图4 多雪崩电离畴形成
2.2 超快速导通阶段
当雪崩电离畴峰值电场强度足够高、数量足够多时,电流通道内等离子体浓度开始急剧上升,PCSS进入超快速导通阶段。根据雪崩电离畴的演变特征,超快速导通阶段又可划分为两个阶段。
1)第1阶段(1≤<1,2)
在第1阶段,随着等离子体浓度提高,雪崩电离畴数量增多、峰值电场强度提高,但畴宽度急剧减小,使PCSS两端电动势差急剧降低,开关两端电动势差变化率达到-5.4´103V/ns,该阶段电流通道内的电场、电子和空穴分布变化如图5所示。

图5 第1阶段多雪崩电离畴演变
等离子体浓度提高导致雪崩电离畴峰值电场强度提高、畴宽度减小、畴两端电动势差降低,雪崩电离畴运动速度随峰值电场强度的提高而提高。52.999~53.011 ns内的多雪崩电离畴演变动态如图6a所示,其中一个雪崩电离畴的演变如图6b所示。在52.999~53.007 ns的8 ps时间内,图6b中雪崩电离畴峰值电场强度由434.56 kV/cm提高至471.94 kV/cm,畴宽度由0.58 μm减小至0.46 μm,畴两端电动势差由24.51 V降低至21.78 V,畴内峰值载流子生成率由6.31´1030cm-1·s-1提高至1.0´1031cm-1·s-1,畴向阳极运动了0.527 μm,对应运动速度为8.78´106cm/s;在时刻53.007~53.011 ns的4 ps时间内,雪崩电离畴峰值电场强度进一步提高至500.52 kV/cm,畴宽度减小至0.42 μm,畴两端电动势差降低至20.51 V,峰值载流子生成率提高至2.0´1031cm-1·s-1,畴向阳极运动了0.473 μm,对应运动速度为1.18´107cm/s。

图6 雪崩电离畴演变(52.999~53.011 ns)
2)第2阶段(1,2≤<2)
在第2阶段内,随着等离子体浓度提高,雪崩电离畴峰值电场强度降低、畴数量减少、畴宽度减小,从而导致PCSS两端电动势差进一步急剧降低,该阶段的开关两端电动势差变化率为-4.94´103V/ns,电流通道内的电场、电子和空穴分布变化如图7所示。
等离子体浓度提高导致电离畴峰值电场强度降低、畴宽度减小,电离畴运动速度随峰值电场强度降低而降低。53.069~53.082 ns内多雪崩电离畴演变动态如图8a所示,其中一个雪崩电离畴演变如图8b所示。在时刻53.069~53.077 ns 的8 ps时间内,畴峰值电场强度由484.89 kV/cm降低至433.9 kV/cm,畴宽度由0.2 μm减小至0.16 μm,畴两端电动势差由9.65 V降低至6.57 V,畴运动速度为9.59´106cm/s;53.077~53.082 ns中,雪崩电离畴峰值电场强度进一步降低至393.88 kV/cm,畴宽度减小至0.13 μm,畴两端电动势差降低至5.34 V,畴运动速度为6.98´106cm/s。

图7 第2阶段多雪崩电离畴演变

图8 雪崩电离畴演变(53.069~53.082 ns)
2.3 电压锁定
PCSS的导通电压示意图如图9a所示,其导通电压约为38.09 V,对应电场强度约为3.8 kV/cm,该Lock-on电场强度近似等于电子速度的特征场强值(4 kV/cm)。PCSS通态电场强度模拟结果与已报道的Lock-on电场强度实验值(3.6~9.5 kV/cm)相符合。导通后的电场及电动势分布如图9b所示,电流通道内的等离子体区仍然存在两个畴,峰值电场强度分别为268.17 kV/cm、114.41 kV/cm,对应峰值载流子生成率分别为7.94´1027cm-3·s-1、3.98´1023cm-3·s-1。阴极边界处空穴浓度大于电子浓度,导致该处存在高电场区,该区域和等离子体区交界处产生雪崩电离畴向阳极运动。电离畴运动过程中逐渐湮灭,而高电场区和等离子体区交界处将持续产生雪崩电离畴。在53.317 ns时,PCSS两端电动势差为37.62 V(阳极处电动势),两个雪崩电离畴两端电动势差总和为29.23 V,开关维持的电动势差主要由雪崩电离畴分担。PCSS导通后,电流通道内仍然存在少量的雪崩电离畴,使电流通道内载流子产生和复合达到了动态平衡,导致PCSS电压锁定,即Lock-on现象。

图9 导通电压及电流通道内电场、电动势分布
2.4 雪崩电离畴特征
雪崩电离畴是由电子和空穴组成的局部高电场区,其峰值电场强度为200~600 kV/cm。雪崩电离畴内载流子浓度、电场强度、电子速度和电流密度分布特征如图10所示。雪崩电离畴前沿电场强度th处的电子速度高于畴内高电场处的电子速度,使该处电子抽取速度高于畴内电子补充速度,导致畴前沿电子耗尽,即电子浓度低于畴外等离子体浓度;同样,雪崩电离畴后沿处电子积累,电子浓度高于畴外等离子体浓度,如图10a所示。雪崩电离畴运动速度高于畴内电子漂移速度,且空穴向阴极漂移,导致畴后等离子体浓度高于畴前等离子体浓度。雪崩电离畴内电子和空穴浓度相等时,电场强度最大,如图10b所示。畴内电场分布对应的电子速度分布如图10c所示。电子电流密度、空穴电流密度、位移电流密度和总电流密度分布如图10d所示。

雪崩电离畴提高了PCSS电流通道内的等离子体浓度,等离子体浓度的提高又影响雪崩电离畴的演变。在电流通道内雪崩电离畴形成和湮灭过程中,畴峰值电场强度和宽度随等离子体浓度变化如图11所示。当等离子体浓度由2.0×1015cm-3左右提高至1.0×1018cm-3左右时,雪崩电离畴峰值电场强度从270 kV/cm左右提高至540 kV/cm左右后下降至360 kV/cm左右,雪崩电离畴宽度从约13.9 μm减小至0.1 μm左右。

图11 雪崩电离畴参数随等离子体浓度变化
雪崩电离畴与传统Gunn畴特征明显不同,主要表现在两个方面。
1)初始形成
传统Gunn畴形成于微波Gunn二极管器件中,由掺杂电离产生的电子和电离施主组成;雪崩电离畴产生于PCSS雪崩导通的电流通道内,由碰撞电离产生的电子和空穴组成。
2)演变动态
当内外电子平均速度相等时,Gunn畴停止生长并趋于稳定,Gunn畴周期性产生、渡越和消失,对应产生周期性微波信号;PCSS中,由于强大的雪崩注入作用,形成的初始偶极畴不稳定而迅速发展为高电场雪崩电离畴,随着等离子体浓度提高,雪崩电离畴形成、湮灭。
多雪崩电离畴在PCSS内引发类似载流子集体雪崩电离现象,在亚纳秒时间内产生高浓度等离子体。由于PCSS导通主要由结构内强烈的雪崩电离决定,PCSS具备低光能触发和超快速导通特性。PCSS导通后结构内仍然存在少量雪崩电离畴使电压锁定。因此,多雪崩电离畴理论能够自洽地解释PCSS雪崩导通各工作特征。
2.5 皮秒级振荡
根据模拟研究结果,PCSS转变为低阻导通状态后,开关电流波形出现了皮秒级的振荡信号,如图12所示。图中,1=53.222 9 ns,2=53.224 2 ns,3=53.225 5 ns,4=53.227 0 ns。由图12可知,振荡电流信号的峰峰值约为0.04~0.25 A,振荡周期约为3.8~6.1 ps。

图12 皮秒级振荡信号
PCSS雪崩导通转变为低阻态后,电流通道内充满高浓度等离子体(约为1018cm-3)。电极处电子浓度和空穴浓度不相等,导致产生两个高电场区。阳极高电场区中,电子浓度高于空穴浓度,电子向阳极漂移,不满足畴形成条件;阴极处高电场区内,碰撞电离产生的电子向等离子体区漂移,当阴极高电场区某处电子浓度高于空穴浓度时,阴极高电场区分裂出一个雪崩电离畴。雪崩电离畴在高浓度等离子体区运动过程中逐渐湮灭,即峰值电场强度降低、畴宽度减小。一个振荡周期内不同时刻(见图12)的阴极处电场分布和结构内电动势分布如图13所示。由于阴极处雪崩电离畴周期性产生和湮灭,PCSS两端电动势差变化周期为ps量级,对应电流波形出现ps级振荡信号。PCSS雪崩导通后,电流通道内形成高浓度的等离子体后,阴极处雪崩电离畴周期性产生和湮灭,使开关电流出现ps级振荡,振荡信号频率达到THz范围。

图13 不同时刻电流通道内阴极处电场分布和电动势分布
S. N. Vainshtein等开展n-p-n0-n+结构的双极GaAs雪崩晶体管超快速导通研究时,提出了GaAs雪崩晶体管的雪崩电离畴的物理模型,模拟发现并实验验证了双极GaAs雪崩晶体管可产生太赫兹波,并将太赫兹波的产生归因于雪崩电离畴的演变坍塌[28-29]。
3 PCSS雪崩导通实验研究
3.1 实验电路
基于GaAs PCSS导通机理研究,进一步开展了低光能触发GaAs PCSS的实验研究。实验电路原理图如图14a所示,电路由触发控制、初级供电、脉冲形成、PCSS及负载构成。直流电源DC通过充电电阻c向电容充电,充电完成后双路延时触发信号源首先控制初级开关Sm导通,通过1:30脉冲变压器(Pulse-Transformer, PT)和二极管VD向微带型脉冲形成线充电,待形成线电压达到峰值,信号源触发激光二极管。激光二极管产生两路激光脉冲,一路用于监测,另一路触发PCSS。负载脉冲经80 dB衰减后由2.5 GHz、20 GS/s示波器监测。脉冲形成线端口阻抗为50 Ω,电长度约为1 ns。激光脉冲波长约905 nm。选取窄条异面结构GaAs PCSS进行实验,如图14b所示。器件电极间距为 4 mm、宽度为2 mm,脉冲耐压为20 kV。PCSS由阴极处被触发,受光区域直径约为1 mm。
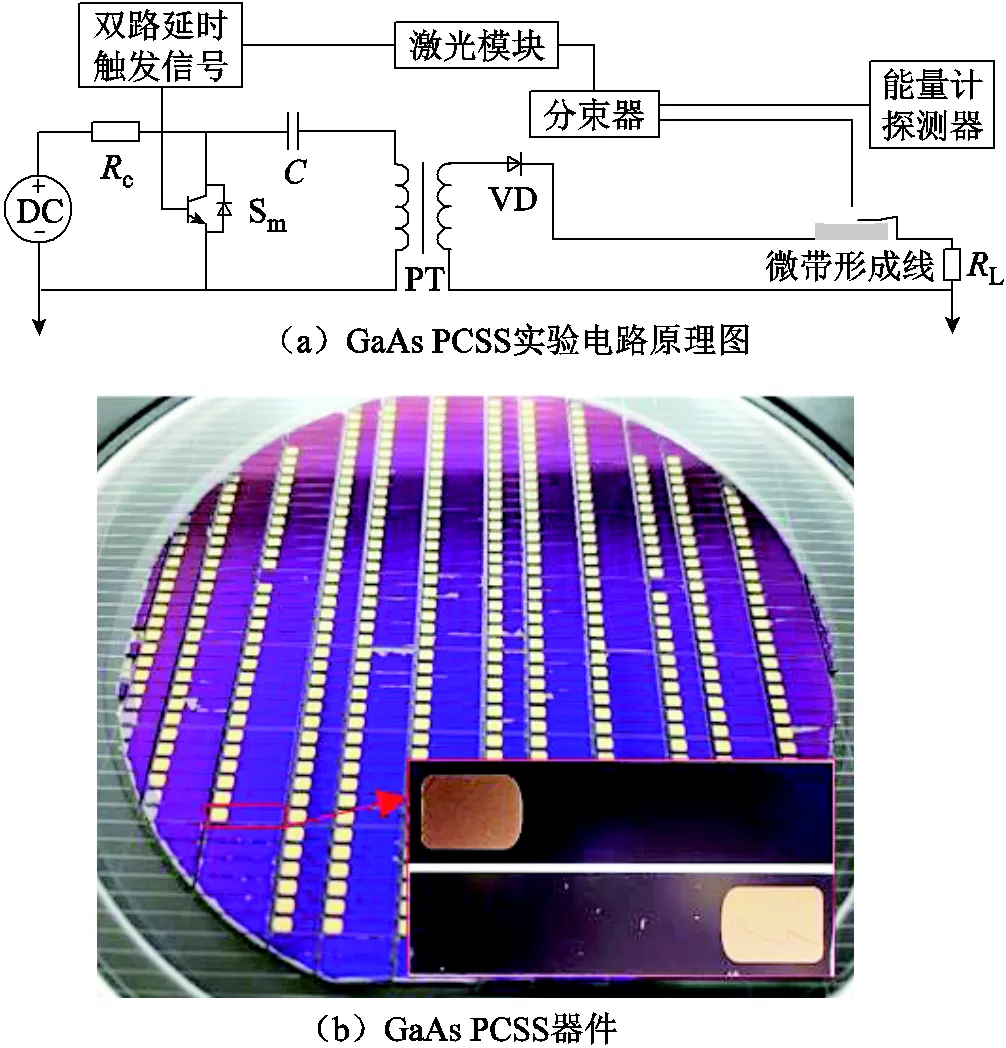
图14 GaAs光导开关实验原理及器件实物
3.2 实验结果及讨论
实验中初级电容充电至450 V,脉冲变压器次级脉冲形成线的充电电压约为17.5 kV。随着PCSS受光触发导通,形成线电压迅速向负载释放。图15为形成线通过PCSS向负载输出的实验脉冲波形,高压脉冲峰值约为8.5 kV,脉冲上升沿为620 ps,开关导通电流约为170 A,峰值功率约为1.4 MW。

图15 负载输出波形
由于雪崩电离畴的最小宽度约为0.1mm,在PCSS数值模拟中,在保证网格间距精度条件下,受限于网格总量,无法仿真全间距PCSS导通过程,不得不缩小开关间距开展仿真以研究器件导通机理。由1.3节可知,仿真得到0.1 mm间距器件获得了147 ps的脉冲上升时间;实验测得4 mm间距PCSS产生的脉冲上升沿约为620 ps。除测量因素外,负载脉冲的上升沿r主要受两个因素影响:一是PCSS本身的开关时间sw;二是形成线放电形成波传输回路的寄生电感p(r∝p/,为回路电阻)。则r可表示为

1)实验PCSS开关速度将大于仿真获得的开关速度。一方面,PCSS器件模型中,载流子迁移率、电离率等参数未考虑器件工作温度的影响,实际上PCSS雪崩导通形成的高密度电流将使器件温度明显上升,载流子饱和漂移速度和载流子电离率随温度提高而降低,从而将导致开关时间将随器件温度提高而增大;另一方面,在模拟中,未考虑寄生电感的影响。
2)在实验中,PCSS的电流丝及高压条件下的连接方式等,将产生大于8 nH的寄生电感(按电流丝等效圆截面直导线计算),回路时间常数约为160 ps。因此,寄生电感引起的测量限制时间约为500 ps。
3)此外,所能获得的高压脉冲衰减器带宽仅为1.5 GHz,也限制了脉冲上升沿的准确测量。
模拟中0.1 mm小间距GaAs PCSS的结果和实验中4 mm大间距PCSS的结果均说明,以电子渡越时间无法解释PCSS超快速导通的物理原因,而多雪崩电离畴模型能很好地解释雪崩模式PCSS超快速导通特性。由于大间距PCSS的电流丝和高压绝缘连接带来的寄生电感更大,大间距高压PCSS产生脉冲前沿大于小间距低压PCSS。
当器件峰值功率达到MW量级时,丝状电流分布导致开关每次导通时的损耗较大。在1 kHz重复频率下,对器件进行测试,结果表明,PCSS可连续工作10 s以上,仅个别输出脉冲幅值发生跌落。PCSS连续工作10 s后暂停工作一段时间,依然能恢复1 kHz正常工作。在20 kHz重复频率下,进一步测试了开关的极限频率响应特性,结果如图16所示。结果表明100~200个脉冲内,开关可以维持稳定工作,随着20 kHz下脉冲数增加,开关芯片局部电晕电荷逐渐积累,器件沿面出现放电和闪络等现象,严重影响了开关表面的绝缘特性。
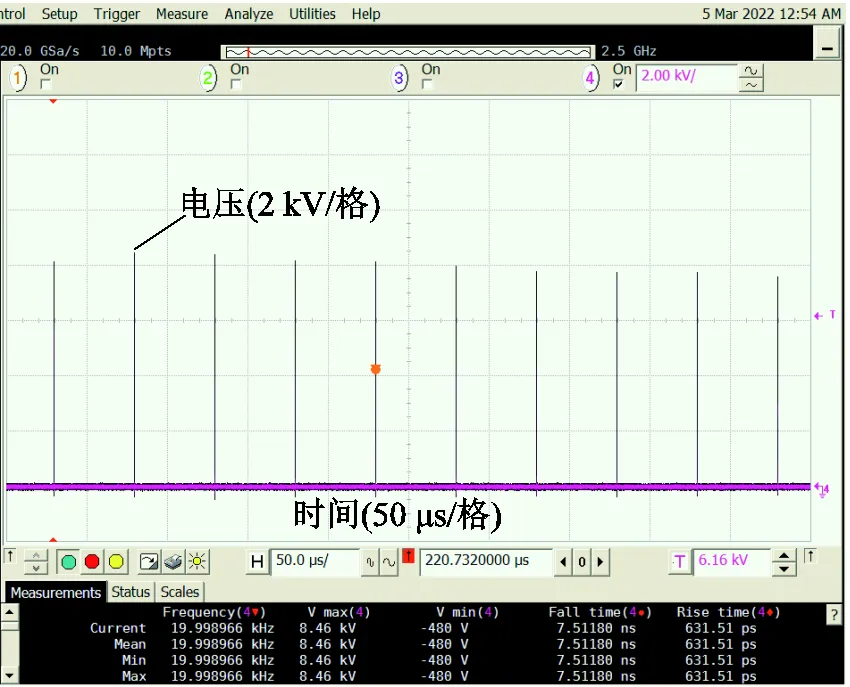
图16 20 kHz重复频率下输出脉冲实验波形
PCSS雪崩导通时形成高密度电流通道,使器件随工作次数增加而损伤加剧。实验结果表明,电极边缘处因电场、电流聚集而更容易损伤。要提高雪崩模式GaAs PCSS的寿命,不仅要匀化电极边缘处电场和电流分布,还要采用新材料、新技术提高电极散热性能及高温工作稳定性。此外,还应研究多电流通道集成技术,减少每条电流通道的电流,从而进一步提高器件寿命。
4 结论
本文研究了低光能触发GaAs PCSS超快速导通的雪崩电离畴产生和演变机理,解释了PCSS低光能触发、超快速导通和电压锁定等工作特征的物理原因,得到以下结论:
1)在延迟阶段,电流通道内产生了多个高电场强度(200~600 kV/cm)的雪崩电离畴,随着等离子体浓度提高,雪崩电离畴峰值电场强度提高,畴内高电场又加速载流子雪崩倍增,从而使等离子体浓度进一步提高。
2)在超快速导通阶段,随着等离子体浓度的提高,雪崩电离畴峰值电场强度提高,但畴宽度迅速减小,使PCSS两端电动势差急剧降低;随着等离子体浓度进一步提高,雪崩电离畴峰值电场强度降低、畴宽度减小、畴数量减少,从而使PCSS两端电动势差进一步急剧降低。
3)PCSS导通后,电流通道内仍存在少量雪崩电离畴,使开关电压锁定,对应Lock-on电场强度为3.8 kV/cm,与已报道实验结果(3.6~ 9.5 kV/cm)相符合。PCSS雪崩导通后,电流通道内充满高浓度等离子体(约为1018cm-3),阴极处雪崩电离畴周期性产生、湮灭使开关电流振荡周期为3.8~6.1 ps。
4)在导通机理研究的基础上,开展了低光能触发下4 mm间距异面PCSS的实验研究。在雪崩模式下,脉冲形成线充电电压为17.5 kV,负载输出高压脉冲上升沿约为620 ps,脉冲峰值功率可达MW级,最高重频达到20 kHz。
[1] 荀涛, 孙晓亮, 樊玉伟, 等. 重频吉瓦级高功率微波源硬管化技术研究[J]. 电子科技大学学报, 2020, 49(1): 87-91.
Xun Tao, Sun Xiaoliang, Fan Yuwei, et al. Progress in a hard-tube, gigawatt-class, repetitively operated high-power microwave source[J]. Journal of University of Electronic Science and Technology of China, 2020, 49(1): 87-91.
[2] 王宁, 金雪雁. 高功率微波国外发展现状以及与电子战的关系[J]. 航天电子对抗, 2018, 34(2): 61-64.
Wang Ning, Jin Xueyan. The present situation of high power microwave abroad and its relationship with electronic warfare[J]. Aerospace Electronic Warfare, 2018, 34(2): 61-64.
[3] 薛明, 杨庆新, 章鹏程, 等. 无线电能传输技术应用研究现状与关键问题[J]. 电工技术学报, 2021, 36(8): 1547-1568.
Xue Ming, Yang Qingxin, Zhang Pengcheng, et al. Application status and key issues of wireless power transmission technology[J]. Transactions of China Electrotechnical Society, 2021, 36(8): 1547-1568.
[4] 何映江, 余亮, 马剑豪, 等. 一种升压模式的可调极性高频Blumlein脉冲形成线功率调制模块[J]. 电工技术学报, 2021, 36(2): 425-434.
He Yingjiang, Yu Liang, Ma Jianhao, et al. An adjustable polarity high frequency Blumlein pulse forming line power modulation module with boost mode[J]. Transactions of China Electrotechnical Society, 2021, 36(2): 425-434.
[5] Wu Ping, Sun Jun, Chen Changhua. Lifetime experimental study of graphite cathode for relativistic backward wave oscillator[J]. Journal of Applied Physics, 2016, 120(3): 033301.
[6] 石磊, 樊亚军, 周金山, 等. 双路输出超宽谱高功率微波驱动源Tesla变压器[J]. 强激光与粒子束, 2013, 25(7): 1751-1754.
Shi Lei, Fan Yajun, Zhou Jinshan, et al. Tesla transformer for dual-output ultra-wide spectrum HPM pulse generator[J]. High Power Laser and Particle Beams, 2013, 25(7): 1751-1754.
[7] 何东欣, 张涛, 陈晓光, 等. 脉冲电压下电力电子装备绝缘电荷特性研究综述[J]. 电工技术学报, 2021, 36(22): 4795-4808.
He Dongxin, Zhang Tao, Chen Xiaoguang, et al. Research overview on charge characteristics of power electronic equipment insulation under the pulse voltage[J]. Transactions of China Electrotechnical Society, 2021, 36(22): 4795-4808.
[8] 霍群海, 李梦菲, 粟梦涵, 等. 柔性多状态开关应用场景分析[J]. 电力系统自动化, 2021, 45(8): 13-21.
Huo Qunhai, Li Mengfei, Su Menghan, et al. Analysis on application scenarios of flexible multi-state switch[J]. Automation of Electric Power Systems, 2021, 45(8): 13-21.
[9] 童军, 吴伟东, 李发成, 等. 基于GaN器件的高频高效LLC谐振变换器[J]. 电工技术学报, 2021, 36(增刊2): 635-643.
Tong Jun, Wu Weidong, Li Facheng, et al. High frequency and high efficiency LLC resonant converter based on GaN device[J]. Transactions of China Electrotechnical Society, 2021, 36(S2): 635-643.
[10] Xu Ming, Liu Chun, Luo Wei, et al. Pulse compression characteristics of an opposed-electrode nonlinear GaAs photoconductive semiconductor switch at 2 μJ excitation[J]. IEEE Electron Device Letters, 2022, 43(5): 753-756.
[11] 党鑫, 杨向红, 孙岳, 等. GaAs光导开关电极制备工艺及性能测试[J]. 西安交通大学学报, 2022, 56(2): 184-190.
Dang Xin, Yang Xianghong, Sun Yue, et al. Preparation technology and performance test of GaAs photoconductive semiconductor switch electrodes[J]. Journal of Xi’an Jiaotong University, 2022, 56(2): 184-190.
[12] Brinkmann R P, Schoenbach K H, Mazzola M S, et al. Analysis of time-dependent current transport in an optically controlled Cu-compensated GaAs switch[C]// OE/LASE '92, Proc SPIE 1632, Optically Activated Switching II, Los Angeles, CA, USA. 1992, 1632: 262-273.
[13] Yee J H, Khanaka G H, Druce R L, et al. Modeling the effect of deep impurity ionization on GaAs photoconductive switches[C]//OE/LASE '92, Proc SPIE 1632, Optically Activated Switching II, Los Angeles, CA, USA. 1992, 1632: 21-31.
[14] Zhao Hanmin, Hadizad P, Hur J H, et al. Avalanche injection model for the lock‐on effect in III‐V power photoconductive switches[J]. Journal of Applied Physics, 1993, 73(4): 1807-1812.
[15] Capps C D, Falk R A, Adams J C. Time-dependent model of an optically triggered GaAs switch[J]. Journal of Applied Physics, 1993, 74(11): 6645-6654.
[16] Bailey D W, Dougal R A, Hudgins J L. Streamer propagation model for high-gain photoconductive switching[C]//OE/LASE'93: Optics, Electro-Optics, and Laser Applications in Scienceand Engineering, Proc SPIE 1873, Optically Activated Switching III, Los Angeles, CA, USA. 1993, 1873: 185-191.
[17] Hudgins J L, Bailey D W, Dougal R A, et al. Streamer model for ionization growth in a photoconductive power switch[J]. IEEE Transactions on Power Electronics, 1995, 10(5): 615-620.
[18] K. Kambour, H. P. Hjalmarson, C. W. Myles. A collective impact ionization theory of lock-on in PCSS's[C]//14th IEEE International Pulsed Power Conference, Texas, USA, 2003:345-348.
[19] Hjalmarson H P, Kambour K, Myles C W, et al. Continuum models for electrical breakdown in photoconductive semiconductor switches[C]//2007 16th IEEE International Pulsed Power Conference, Albuquerque, NM, USA, 2008: 446-450.
[20] Shi Wei, Dai Huiying, Sun Xiaowei. Photon-activated charge domain in high-gain photoconductive switches[J]. Chinese Optics Letters, 2003, 1(9): 553-555.
[21] Hu Long, Su Jiancang, Ding Zhenjie, et al. Investigation on properties of ultrafast switching in a bulk gallium arsenide avalanche semiconductor switch[J]. Journal of Applied Physics, 2014, 115(9): 094503.
[22] Smith P M, Inoue M, Frey J. Electron velocity in Si and GaAs at very high electric fields[J]. Applied Physics Letters, 1980, 37(9): 797-798.
[23] Vainshtein S N, Yuferev V S, Kostamovaara J T. Ultrahigh field multiple Gunn domains as the physical reason for superfast (picosecond range) switching of a bipolar GaAs transistor[J]. Journal of Applied Physics, 2004, 97(2): 024502.
[24] Hui K, Hu C, George P, et al. Impact ionization in GaAs MESFETs[J]. IEEE Electron Device Letters, 1990, 11(3): 113-115.
[25] Haug A. Auger recombination in direct-gap semiconductors: band-structure effects[J]. Journal of Physics C: Solid State Physics, 1983, 16(21): 4159-4172.
[26] Ghadimi-Mahani A, Goodarzi A, Farsad E, et al. Performance and reliability improvement of 905nm high power laser diode by design, fabrication and characterization of high damage threshold mirrors[J]. Microelectronics Reliability, 2021, 119: 114070.
[27] Wight D R, Keir A M, Pryce G J, et al. Limits of electro-absorption in high purity GaAs, and the optimisation of waveguide devices[J]. IEE Proceedings J Optoelectronics, 1988, 135(1): 39.
[28] Mikhnev V A, Vainshtein S N, Kostamovaara J T. Time-domain terahertz imaging of layered dielectric structures with interferometry-enhanced sensitivity[J]. IEEE Transactions on Terahertz Science and Technology, 2020, 10(5): 531-539.
[29] Vainshtein S N, Duan Guoyong, Yuferev V S, et al. Collapsing-field-domain-based 200 GHz solid-state source[J]. Applied Physics Letters, 2019, 115(12): 123501.
Operating Mechanism of Low-Energy-Triggered Gallium Arsenide Photoconductive Semiconductor Switch
Xu Shouli1Liu Jingliang1Hu Long2Ni Tao1Xu Chunliang1
(1. The 13th Research Institute China Electronics Technology Group Corporation Shijiazhuang 050050 China 2. School of Electronic Science and Engineering Xi’an Jiaotong University Xi’an 710049 China)
High repetitive ultrawide band pulse possesses wide application prospect to civil and military fields, whose key parameters are decided by prosperities of the pulsed power semiconductor device. Gallium arsenide (GaAs) photoconductive semiconductor switch (PCSS) in avalanche mode based on semi-insulating (SI) wafer possesses properties of low-energy triggering, high voltage and ultrafast switching. The ultrawide band generator based on GaAs PCSS can achieve miniaturization, modularization and array. For decades, there were several theories explaining the phenomena in the avalanche PCSS with consideration of field-dependent trapping of charge carriers, deep impurity ionization, double injection, avalanche injection, localized impact ionization, streamer formation, collective impact ionization, and photo-activated charge domain. However, the operation mechanism, especially the lock-on effect, of the GaAs PCSS in the avalanche mode is still unclear.
Operating mechanism of low-energy-triggered GaAs PCSS was analyzed using a one-dimensional physics-based numerical simulation. The transient process of physical parameters in filament was discussed. The physics of multiple avalanche domains as the operating mechanism of the PCSS in avalanche mode was described, which leads to characteristics of low-energy triggering, ultrafast switching and voltage locking of the switch. When a 905-nm optical pulse with the power of 12 W triggered the PCSS from cathode, the switch reached a high conducting state in 147 ps after a delay time of 3.0 ns, and then turn-on voltage across the PCSS was locked at an electric field of about 3.9 kV/cm due to existing of residual avalanche domains in filament. The transient process can be divided into three stages containing delay, ultrafast switching and votage locking. In the delay stage, the intrinsic positive feedback causes formation of multiple avalanche domains and dense electron-hole plasma. In the ultrafast switching stage, the increase of plasma density leads to the increase of domain field and drastic domain shrinkage that reduces voltage across the structure very fast. Further increase of plasma density results in domains annihilation including reduction of domain width, peak field and domain number, and ultrafast switching sustainable occurs. At the last stage, the PCSS turns into voltage locking stage due to the existence of a small quantity of avalanche domains in the high conductivity structure. Moreover, the phenomenon of picosecond current oscillations was observed numerically in the avalanche GaAs PCSS, and the peak-to-peak amplitude of these current signals is about 0.04~0.25 A, and the oscillating period is about 3.8~6.1 ps.The physical reason was also discussed by evolution of avalanche domains in the filament.
Based on the investigation on the switching mechanism, the experimental study of the GaAs PCSS with 4 mm gap biased at 17.5 kV was carried out using in a 50 Ω pulse forming line. When the pulse forming line was charged to 17.5 kV, the laser pulse from a laser diode module triggered the GaAs PCSS at cathode side. The PCSS turned into a conducting state, and the pulse was generated across the load resistance. The peak power of voltage pulse reaches MW level, and risetime of output pulse is only about 620 ps, and the highest repetition rate is up to 20 kHz. The numeric switching time of GaAs PCSS is significantly less than that achieved in our experiment, which is caused mainly by parasitic inductance in experimental circuit.
Pulsed power, photoconductive semiconductor switch (PCSS), avalanche domain, low-energy triggering, sub-nanosecond
徐守利 男,1978年生,硕士,高级工程师,研究方向为半导体功率电子器件。E-mail:13833106174@139.com
胡 龙 男,1986年生,副研究员,硕士生导师,研究方向为半导体功率电子器件、脉冲功率技术。E-mail:hulong@xjtu.edu.cn(通信作者)
TM89
10.19595/j.cnki.1000-6753.tces.221390
国家自然科学基金(52177156)和强脉冲辐射环境模拟与效应国家重点实验室开放课题(SKLIPR2004)资助项目。
2022-07-19
2022-10-14
(编辑 李 冰)

