极紫外多层膜技术研究进展
张立超
(中国科学院长春光学精密机械与物理研究所应用光学国家重点实验室,吉林长春 130033)
1 引 言
极紫外 (Extreme Ultraviolet)是处于真空紫外与软 X射线之间,波长在几纳米至几十纳米的一个特殊波段。在过去相当长的一段时间内,这一波段的研究相对滞后,甚至一度曾被人们称为“Unobservable Ultraviolet”,这是由极紫外波段辐射的自身特点所决定的。在这一波段内存在着大量的原子共振线,因此入射光会在很短的距离内被吸收,典型的吸收长度仅在纳米量级。这种材料的强吸收特性,使得在极紫外波段不可能采用透射式光学元件。不仅如此,极紫外辐射还具有另一个特性,即所有材料的折射率实部都非常接近于 1,因此对单个界面来说,两种材料的折射率基本不存在差异,能够获得的反射率极小,通常小于 10-3量级,无法实现正入射的反射式光学元件[1]。
极紫外辐射特性严重制约了极紫外光学的发展。仿照 X射线波段,利用入射角小于临界角时产生的全反射现象,实现掠入射光学系统,曾一度成为极紫外波段光学应用的唯一选择。然而,由于掠入射光学系统的收集立体角很小,难以高效地收集空间观测中希望获得的微弱极紫外辐射信号。
研究发现极紫外多层膜可很好地解决这一问题。在这种结构中,利用多个界面反射光产生的相长干涉,可以在正入射条件下获得高反射率[2]。目前,基于极紫外多层膜的反射式光学元件,已经进入了以极紫外光刻与极紫外天文观测为核心的实用化阶段。
2 极紫外多层膜的发展
将多层膜应用于极紫外波段的思想源于上世纪 20年代。当时,X射线刚刚被发现,就有人提出采用人工方法仿照晶体结构,制备周期厚度为纳米量级的多层膜结构,其中高折射率 (吸收层)材料模拟晶体中的原子层,低折射率材料 (间隔层)模拟原子层的间隙,以这种人造周期结构实现布拉格衍射,从而在极紫外/软 X射线波段获得高反射率。这种想法在 40年代初被付诸实施:Dumond[3]等人采用热蒸发方法制备了 Au/Cu多层膜,并观察到了 X射线衍射现象,但由于两种材料之间存在严重扩散,周期结构很快消失,这一问题一直到 70年代以后才得到解决。Spiller于1972最先提出[4],可以像可见光波段一样,采用λ/4波堆结构的周期型多层膜实现极紫外波段的高反射率,并用电子束蒸发方法制备出极紫外多层膜。随后,Barbee也发展了磁控溅射沉积多层膜的方法[5]。这两种方法一直被沿用至今,成为了极紫外多层膜制备的两种常规方法。
在这之后,极紫外多层膜的研究进入了全面发展的时期,人们开展了一系列理论 (光学常数反演、膜系设计等)、制备方法 (电子束蒸发、磁控溅射、离子束溅射等)与薄膜性能测试技术 (光学性能、表面与界面表征等)的广泛研究,为多层膜技术的全面发展奠定了坚实的基础。膜厚控制精度达到原子量级的多层膜沉积设备的出现,是这一时期的突破性进展[6]。人们可以在大口径、非球面光学基底上,实现反射率接近于理论极限的高性能多层膜。
多年的积累,孕育出了一批高水平的研究机构,如美国的 Lawrence Livermore国家实验室、荷兰的 FOM-Rijnhuizen研究所、德国 Fraunhofer下属的两个研究所— IOF与 IWS、日本的Nikon公司等。这些机构或从产业应用,或从基础研究的角度出发,在多层膜技术领域开展了深入的工作,使极紫外光学技术逐步走向了成熟阶段。镀膜工艺与设备的日臻完善,使人们能够针对 500~600 mm的大口径光学元件,在严格保障光学元件面形精度的基础上,实现接近理论极限的反射率水平[7]。国内自 90年代中期起,也在此领域系统地开展了研究,并在中科院长春光机所、中科院上海光机所以及同济大学等单位的努力下取得了长足的进展[8~18]。表1列出了目前在极紫外波段,针对不同应用波长的最佳多层膜材料组合及其反射率理论极限值。
目前,极紫外波段的光学应用已从实验室研究阶段全面进入了以极紫外光刻与极紫外天文学为主的实用化阶段。

表1 极紫外波段最佳多层膜材料组合及其反射率Tab.1 The bestmater ial comb inations and reflectivities of EUV multilayer coatings
3 极紫外多层膜的关键技术
多层膜光学元件主要的应用有两种,即极紫外光刻与极紫外天文观测。二者对多层膜光学元件的性能要求具有不同的测重点:其中极紫外光刻系统要求镀膜过程具有更高的光学元件面形保障;而天文观测则更倾向于高的光谱分辨率。
除这些特殊要求外,在大口径光学基底上实现高反射率,是所有极紫外多层膜必须满足的共性要求。这需要通过高性能的沉积设备与合适的薄膜沉积工艺来保证。
3.1 制备方法的选择与沉积工艺设备
目前用于极紫外光刻系统多层膜制备的沉积方法主要有 3种。
(1)磁控溅射。磁控溅射是最常用的极紫外多层膜制备方法,该方法具有如下优势:首先,在溅射沉积过程中,溅射功率、工作气压等参数非常稳定,因此镀膜材料具有恒定的沉积速率,仅通过设定合适的沉积时间,就可实现纳米级膜厚的精确控制;其次,在磁控溅射装置中,通过控制镀膜基底的公转速度曲线,可以实现高精度的膜厚空间分布控制;此外,磁控溅射沉积工艺过程复杂程度不高,设备维护也相对较容易。由于具有上述优点,磁控溅射成为了极紫外波段多层膜制备的主要方法。各研究机构与企业都开发出了极紫外多层膜制备的专用磁控溅射沉积设备。如 Fraunhofer- IOF研究所采用的是 Leybold公司开发的NESSY(New EUV Sputter System),它能够镀制的最大反射镜尺寸为Φ650 mm,也可在一次镀膜过程中同时镀制两块Φ450 mm或三块Φ300 mm的反射镜[19];Veeco公司为 Lawrence Liver more实验室定制了一台最大镀膜口径为Φ470 mm的磁控溅射沉积设备[20];Nikon也自行研制了类似的设备,其最大镀膜口径为Φ600 mm[21,22]。
(2)电子束蒸发。采用电子束蒸发方法制备高性能的极紫外多层膜,必须采用离子束抛光和X射线膜厚监控两种辅助技术,这是由两方面的原因决定的。一方面,在电子束蒸发沉积过程中,沉积粒子动能较小,通常仅在 0.1 eV量级,因此迁移率较低,在薄膜沉积的过程中会导致粗糙度的积累,致使多层膜的反射率下降,所以必须采用离子束抛光方法降低多层膜的粗糙度[2]。另一方面,在电子束蒸发沉积过程中,沉积速率不稳定,必须采用光学监控方法进行膜厚控制,而对于极紫外多层膜这种单层膜厚仅为几纳米的超薄膜层来说,只能采用波长较短的 X射线进行膜厚监控。由于设备和工艺过程较为复杂,能够采用电子束蒸发方法制备出高质量极紫外多层膜的研究机构较少,仅有 FOM-Rijnhuizen研究所等寥寥数家。目前仅有的极紫外多层膜专用热蒸发镀膜机是Leybold公司为 Zeiss公司的极紫外光刻项目开发的沉积设备。
(3)离子束溅射。离子束溅射方法具有与磁控溅射方法相类似的优点,即沉积速率较为稳定,因此容易实现精确的膜厚控制。离子束溅射的不足之处也同样明显,即制备大口径的离子源比较困难,因此离子束溅射仅适用于中小尺寸光学元件的多层膜沉积。另外,离子束沉积方法所制备的多层膜反射率要稍低于磁控溅射与电子束蒸发方法。然而,离子束沉积具有一个另外两种方法所不具有的优势,即离子束溅射方法制备出的多层膜具有更少的缺陷。因此,离子束溅射被认为是极紫外光刻中多层膜掩模白板制备的最佳方法。由 Lawrence Liver more实验室和 Veeco公司合作开发的NEXUS-LDD- IBD离子束沉积系统是用于多层膜掩模白板制备的专用设备[23]。
3.2 高反射率多层膜的制备
在极紫外波段,材料的吸收非常强烈,不可能实现 100%的反射率。多层膜开发的目标就是实现尽量高的反射率,其标准的做法是:首先通过测试确定不同材料的薄膜在工作波长处的光学常数;然后采用这些光学常数进行膜系设计,以在工作波长处获得最高反射率为标准,并综合考虑材料的物理与化学性质,选取最佳的材料组合与膜系结构;最后采取合适的制备方法,优化薄膜沉积工艺,尽可能地使实际制备出的反射率符合理论设计结果。
目前,由于一些现实条件的限制,实际制备出的多层膜反射率尚无法达到理论设计值,产生这种情况的原因如下:
(1)在多层膜内存在膜层间的扩散。以Mo/Si多层膜为例,其中 Mo-on-Si和 Si-on-Mo的扩散层厚度分别为 1 nm和 0.6 nm左右,在周期厚度仅为 7 nm的 Mo/Si多层膜中占有很大的比例[24]。膜层间扩散的存在,使两种材料界面的光学衬度下降,从而降低了多层膜的反射率。
(2)随着波长进入到极紫外波段,由高频粗糙度引起的非镜面散射也是引起反射率下降的重要因素。多层膜在极紫外波段的散射由基底粗糙度与薄膜沉积参数共同决定[25,26]。
(3)实际制备出的多层膜与理想的设计膜系结构具有一定的偏差。比如在多层膜设计时,通常采用数据库中的光学常数[27],这与实际制备出的薄膜光学常数可能会存在一定的差别;又如在多层膜制备时,由于种种不确定因素的影响,每一膜层的厚度与其设计值相比也常常存在一定的随机误差[28]。凡此种种,都是能够降低多层膜反射率的因素。
由于上述原因,目前多层膜能够实际获得的反射率水平与其相应的理论极限值相比都存在一定的差距。以 Mo/Si多层膜为例,其在 13.5 nm处的反射率理论极限值为 74%,而经过多年的艰苦努力,目前能够实现的最高水平为 70.15%[29]。
为使实际制备出的多层膜反射率接近理论设计值,必须解决上述技术问题:
首先需要采取合适的手段,降低膜层间的扩散,这可以通过采用超薄阻挡层的方法来实现[30,31]。在每两个相邻膜层间增镀一层厚度为零点几个纳米的阻挡层,其材料为惰性物质,如B4C或 C等,这些惰性阻挡层材料不会与膜层材料发生反应,因此能够有效减小膜层间的扩散,实现提高反射率的目的。
其次,应采取措施降低由粗糙度引起的散射。通过优化多层膜沉积工艺,使膜层具有尽量小的内禀粗糙度,从而使基底的粗糙度在沉积过程中不会被接下来的膜层所继承,有效降低粗糙度,进而减小非镜面散射[32]。
最后,从两方面控制实际制备的多层膜与理想膜系设计结果所出现的偏差:一方面是发展高精度的光学常数提取方法,减小理论设计与实际制备膜系之间的差异;另一方面是从沉积设备的性能入手,对镀膜机的设计进行改进,提高多层膜沉积过程中工艺参数的稳定性,降低膜厚随机误差等不确定因素对膜系结构产生的影响。
4 极紫外光刻系统中的多层膜研究
在各种极紫外光学技术中,极紫外光刻系统对多层膜要求最为苛刻。如何满足这些苛刻的要求,一直是研究多层膜制备技术所追寻的目标。
4.1 极紫外光刻系统对多层膜的性能要求
图1显示了一个典型的极紫外光刻系统,其主要由如下几部分构成[33]:
(1)光源。极紫外光刻所采用的大功率激光等离子体光源或放电等离子体光源通常具有较高的工作温度,这意味着多层膜聚光镜必须具有非常好的热稳定性。
(2)照明系统。从光源发出的光经聚光后,需要经过照明系统的匀光,以实现整个视场范围内的均匀照明。
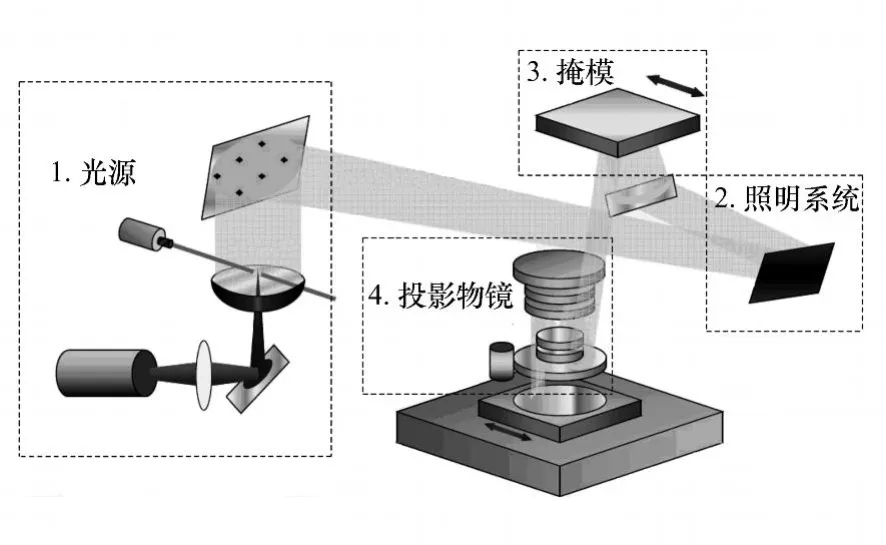
图1 极紫外光刻系统原理图Fig.1 Diagram of EUVL system
(3)反射式掩模。极紫外光刻掩模为反射式掩模,掩模图形必须在镀有多层膜的掩模白板上制作。
(4)微缩投影物镜。投影物镜是极紫外光刻系统的核心部分,其制造水平直接决定光刻成像质量。为确保像质,必须严格控制由镀膜引起的面形变化。
极紫外光刻系统的多层膜需要满足如下要求[34]:
(1)高反射率。包括聚光镜、照明系统、掩模与投影物镜在内的整个系统由 10个以上的多层膜反射镜构成,即使是每一个反射面的反射率有1%的降低,也足以使系统的总光通量大幅度下降。因此,多层膜必须尽量实现接近理论极限的反射率。
(2)反射率峰值波长匹配。多层膜的反射带宽极窄 (应用于 13.5 nm的Mo/Si多层膜,其带宽FWHM值仅为~0.6 nm),即使每块反射镜的反射率峰值稍有偏离,也足以使系统的光通量严重下降。为保证系统具有较高的光通量,不同反射镜的反射率峰值波长须严格匹配。匹配误差需控制在Δ λ< ±0.05 nm之内。
(3)面形保障。极紫外光刻是挑战目前光学制造技术极限水平的应用,其应用波长仅为13.5 nm。为保证系统的成像质量,系统中光学元件面形精度需要达到深亚纳米量级。具体分配到镀膜过程,要求由镀膜引起的面形误差变化控制在 0.1 nm(RMS)以内。
(4)热稳定性。极紫外光刻系统中的部分光学元件,如光源中的聚光镜,需要工作在高温环境下。为满足这种需要,多层膜必须具有较好的热稳定性,即能够在高温环境下,保证反射率曲线在长时间内不会发生变化。
4.2 多层膜反射率峰值波长匹配的实现
极紫外光刻系统包含 10个以上的多层膜反射镜。为使系统具有尽量大的光通量,每一块反射镜的峰值波长需要与工作波长严格匹配。目前对于多层膜的峰值波长匹配问题,通行的标准是误差极限为 ±0.05 nm,即多层膜反射率峰值波长需控制在 (13.5±0.05)nm。实现这一标准,意味着每一块多层膜在 13.5 nm处实际获得的反射率超过其峰值反射率的 99%,从而不至于使系统的光通量产生较大的损失[34]。
多层膜峰值波长的匹配误差属于随机误差,其大小具有一定的概率分布,具体的分布函数由镀膜机的稳定性决定:镀膜机的稳定性越好,匹配误差就越小,反之亦然。为实现匹配误差指标,必须从提高镀膜机的稳定性入手,这一般通过两方面的措施来实现:(1)在硬件上采取各种闭环控制,以提高沉积速率等各种工艺参数的控制精度;(2)尽量将沉积工艺设备设计得大一些,使一次镀膜过程内能够加工尽可能多的反射镜。
Lawrence Liver more实验室的研究结果显示了这一技术路线的可行性。在第一阶段,对镀膜机的匹配误差进行了评估,结果显示,不同样品的峰值波长标准偏差为 0.032 nm(1σ);第二阶段,充分考虑了对薄膜沉积速率影响最大的因素,如工作气氛、溅射功率、靶与基片的距离等,对镀膜机进行了改进,通过对这些因素的严格控制,使峰值波长的标准偏差减小到了 0.017 nm(1σ);在第三阶段的研究中,开发出了新的工艺设备,该设备在一次镀膜过程中就能够完成 4块反射镜的镀膜,进一步使标准偏差降低到了 0.01 nm(1σ),因而使最终的光通量达到了理论极限水平的99.3%,实现了多层膜反射率的峰值匹配[35]。
4.3 镀膜过程中的面形保障
在镀膜过程中,影响光学元件面形精度的因素主要有两种,即膜厚空间分布控制精度与薄膜应力。
对于极紫外光刻,精确实现膜厚空间分布控制的难度显而易见。根据光学设计结果,光线在每一块反射镜表面上不同点具有不同的入射角,因此多层膜必须根据这些入射角调整成周期厚度沿径向呈梯度分布而非均匀分布的形状;多层膜需要镀制在非球面的反射镜基底上,且部分基底的口径较大。这些因素都增加了膜厚控制的难度。多层膜的膜厚空间分布可以通过采用修正挡板或转盘公转速度调制实现。前者适用于电子束蒸发方法,后者应用于磁控溅射方法中。
图2显示了典型的磁控溅射沉积过程[20]。长方形的磁控溅射靶固定,基片既可以随底盘公转,也能够以自身的回转对称中心为原点进行自转。当自转转速足够高时,距自转中心距离相同的各点获得相同的沉积速率,将膜厚控制转化成了如何控制膜厚径向分布的一维问题。这一问题可以通过调整基片的公转速度曲线实现。

图2 磁控溅射沉积示意图Fig.2 Diagram ofmagnetron sputter deposition
如图3所示,转盘速度调制方法通过设置合适的公转速度曲线,使基片沿径向不同位置处的实际沉积时间得到修正,从而能够获得精确的膜厚径向分布。理论上,公转速度曲线分段区间越多,就越有可能实现高精度的膜厚分布控制。Lawrence Livermore实验室采用这一方法进行极紫外光刻实验装置—MET的多层膜制备,成功地将镀膜引起的面形误差控制为 0.06nm(RMS)[36]。

图3 转盘调速示意图Fig.3 Diagram of platter velocity modulation
多层膜的应力是另外一个制约光学元件面形精度的重要因素。常规的高反射率极紫外多层膜由几十个重复的膜层对构成,每个膜层对具有数百兆帕的残余应力,累积起来足以严重降低光学元件的面形精度。只有实现“零”应力状态,才能消除由应力造成的光学元件面形误差,确保系统的成像质量。
在早期的研究中,人们曾经尝试过改变工作气氛,改变 Mo与 Si膜层的厚度比例,采用 Kr作为工作气体代替 Ar退火处理等方法[37~39]来降低应力,但这些方法虽然能够有效减小应力,有时甚至可能实现“零应力”,但无一例外地会降低反射率。
最近,一种双堆栈的方法被广泛应用于极紫外多层膜的应力控制[40,41]。这种方法需要在镀正式的Mo/Si高反射率多层膜之前预先镀制另一个Mo/Si堆栈作为应力补偿堆栈,其 Mo,Si厚度比例值与正常Mo/Si高反射率多层膜不同。当应力补偿堆栈的厚度比例值选择合适时,两个堆栈能够具有大小相等、状态相反的应力,使两个堆栈的应力相互抵消,从而实现“零应力”。由于极紫外辐射穿透深度较浅,无法穿透到下面的应力补偿堆栈,因此整个膜系的反射率不会受应力补偿堆栈的影响,仅由靠近空气一侧的Mo/Si高反射率多层膜堆栈结构决定。
采用应力补偿堆栈的做法能够完全消除应力对基底面形产生的影响,但也有不利之处。因为在正常多层膜沉积之前额外镀制了一个用于应力补偿的多层膜堆栈,从膜厚空间分布控制角度考虑,等于增加了一个不确定的因素。因此,如何在膜厚空间分布的精确控制和消除多层膜应力之间取得平衡,是未来极紫外光刻系统光学元件面形保障需要解决的关键问题。
4.4 多层膜热稳定性的提高
多层膜的热稳定性取决于它们的理化性质。从实质上来看,多层膜是一种人造的亚稳态周期结构。在常温下两种材料虽然可以存在稳定的界面,但当温度升高时,膜层内原子被激活的概率极大增加,两种材料之间开始相互扩散,并趋于形成更为稳定的合金态,进而导致多层膜内部结构发生变化,造成光学性能的下降。
不同材料对所组成的多层膜系具有不同的扩散系数。因此,提高多层膜热稳定性的关键在于如何寻找合适的材料组合,这些组合需要在能够实现高反射率的前提下具有尽量小的扩散系数。选取合适的材料组合有两种方法,即材料置换法和添加亚层法[42]。
(1)材料置换法:在组成多层膜的两种材料中,将其中的一种替换成其它材料,构成新的膜系 ,如 Mo2C/Si、MoSi2/Si、Mo/SiC等。用这种方法提高热稳定性的关键在于材料中的 3种元素在扩散初期发生反应形成了三元合金,成为阻挡层,能够阻止膜层的进一步扩散。Mo2C/Si和 Mo/SiC在 13 nm附近的反射率分别可以达到 60%和55%,均能够在 500℃的高温下,在一定时间内保持周期性基本不变[43,44]。Mo/SiC组合能够在500℃的条件下经历 100 h的退火过程后,仍然保持大于 45%的反射率,但其反射率中心会产生0.4 nm的漂移。MoSi2/Si的组合则在高温下表现出另外一种特征:其在 13 nm附近最高反射率仅为 40%,但这种材料组合能够在较高温度下长时间地保持稳定的光学性能,比如当退火温度为500℃时,除在退火初期的 1 h内多层膜的周期膜厚度存在微小突变外,在接下来 100 h的退火过程内,多层膜反射率曲线无任何变化。
(2)添加亚层法:在常规膜层对之间添加厚度仅为零点几个纳米的极薄惰性亚层,形成如Mo/C/Si/C的结构。通过这种亚层的阻隔,能够降低多层膜的整体扩散系数,从而提高其热稳定性。Yulin等人[45]报道了一种新型的亚层材料,由这种材料组成的Mo/X/Si/X膜系,不仅具有高达 60%的反射率,而且能够在 500℃的环境下,在 100 h的退火过程内,反射率曲线没有任何变化,可以满足聚光镜的实际应用要求。
5 极紫外天文观测中的多层膜光学元件
5.1 极紫外天文望远镜中的多层膜
在多层膜出现之前,极紫外天文学的发展一直受限于光学元件种类的匮乏。仿照 X射线波段,利用入射角小于临界角时产生的全反射现象实现掠入射光学系统,一度成为了极紫外天文观测仪器的唯一选择。然而这并不是一个理想的选择,其原因在于掠入射光学系统的收集立体角很小,难以高效地收集空间观测中希望获得的微弱极紫外辐射信号。
因此,自从成功制备出多层膜以来,人们一直在积极寻求用其实现正入射光学系统的可能性。1985年,首个采用多层膜反射镜的正入射太阳望远镜被成功应用于日冕 4.4 nm辐射的观测,标志着极紫外天文学进入了一个新的时代。在这之后,人们开发了众多的多层膜望远镜,如TRACE[46]、SOHO[47]以及 SDO[48]等。这些正入射望远镜通常具有 10~30 cm2的集光面积,满足了极紫外波段微弱信号探测的需要。
从多层膜实际制备的角度来看,极紫外望远镜面临与极紫外光刻相同的问题,即如何在非球面基底上实现所需要的膜厚空间分布。在两种应用中,极紫外望远镜所采用的反射镜口径较小,因此其膜厚空间分布相对容易控制。前面所介绍的为极紫外光刻应用而开发的专用设备,均能够很好地满足极紫外望远镜所需多层膜的制备。
由于极紫外多层膜的带宽较为有限,例如在10~30 nm的工作波长内,通常只有 0.5~2 nm(FWHM)的带宽,无法满足宽波长光谱范围观测的需求。因此,极紫外望远镜最初只能工作于单一的波段。针对这一问题,在后继的应用中对镀膜工艺进行了改进,即将反射镜分区,每一区针对不同的波长通道镀膜。多层膜开发的最主要任务就是针对这些波段,选择合适的材料组合与膜系结构,实现尽量高的反射率[49]。
基于多层膜的正入射极紫外望远镜以其优异的性能,极大地满足了天文观测的需要。如 2010年 2月发射的 SDO上所搭载的 A IA(A tmospheric ImagingAssembly),其分为 4个通道,每一通道采用不同的多层膜材料组合,针对不同的工作波长,4个通道覆盖了 9.39~33.54 nm的光谱范围,能够以 1″的空间分辨率,针对 1.3倍的太阳直径的范围,每 10 s成像 1次,完成对 4个波段的同时成像。
由多层膜构成的望远镜存在的不足之处是其光谱分辨率较低,这是基于布拉格反射的光学元件所固有的缺点。为实现更高的光谱分辨率,必须采用具有色散能力的多层膜光栅结构。
5.2 高分辨率天文观测中采用的多层膜光栅
对于光谱仪器来说,光谱分辨率是最重要的性能指标。按这一标准衡量,常规的极紫外天文望远镜具有天然的劣势,其原因在于多层膜并不具有色散能力,所能够提供的光谱分辨率极其有限,λ/Δ λ比值通常不超过 100。这对于充满了各种谱线、相互间波长间隔极小的极紫外波段,显然是远远不够的。为获得足够的光谱分辨率,新型的极紫外光谱仪开始广泛采用多层膜光栅作为分光元件。
多层膜光栅是将多层膜镀制在刻有光栅槽型的基底上构成的复合式光学元件,其中多层膜结构保证高反射率,光栅结构提供高分辨率,这种结构在正入射条件下兼具高衍射效率与高光谱分辨率的优点。自从 1984年首次被成功制备出后[50],多层膜光栅得到了广泛的应用。如自 1989年开始发射的 SERTS(The Solar Extreme Ultraviolet Research Telescope and Spectrograph)系列 ,从1991年第二次发射起就采用多层膜光栅来提高光谱分辨率[51];又如 2006年在日本发射的用于研究太阳活动的航天器 Hinode(Solar-B),其最重要的载荷之一也是以多层膜光栅为核心的成像光谱仪EIS(Extreme Ultraviolet Imaging Spectrometer)[52]。
这些基于多层膜光栅的光谱仪具有极高的光谱分辨率,如 JPEX中采用 4块镀有 Mo/Si多层膜的多层膜闪耀光栅,在 22~24.5 nm的平均衍射效率达到了约 10%,实现了近 4 000的光谱分辨率,是常规极紫外光谱仪 EUVE的 20倍[53,54]。由于能够在光谱维度上提供更加丰富的信息,以多层膜光栅为核心的光谱仪器已经成为极紫外波段天文观测中新的热点。
高性能的多层膜光栅是实现此类光谱仪器的前提条件,其制备涉及高质量光栅基底的制作、光栅参数的精确提取、适用于光栅基底的多层膜沉积、多层膜光栅衍射特性分析等单元技术,需要多学科的协同攻关才能够实现。国外的研究从 20世纪 90年代起,就以美国海军实验室为主,联合Lawerence Live rmore实验室、Zeiss公司等,持续地开展了实用型多层膜光栅制备技术的研究。经过多年的积累,其大面积多层膜光栅的制备技术日趋成熟,满足了包括 SERTS、EIS、JPEX[54]与APEX[55]等一大批极紫外波段光谱仪的实际应用需求。
虽然多层膜光栅已经进入实用化阶段,但在实际的制备与应用过程中,仍然有一些亟待解决的问题,人们已针对这些问题进行了深入的研究:
(1)高质量光栅基底的制备。目前,全息 -离子束刻蚀方法是闪耀光栅基底制备的常规方法。该方法具有槽型好、闪耀角控制较精确、粗糙度低等优点,适合于高质量光栅基底的制备。然而,这种方法具有一个不利之处,即当制作应用波长在十几纳米的小闪耀角 (<3°)光栅时,光栅闪耀面就会变得弯曲,使衍射效率大幅度降低[56,57]。为解决这一问题,Osterried等人[58]发展了浸渍涂覆 (Dip-coating)修改光栅闪耀角的方法,即先采用离子束刻蚀出一块槽型良好的大闪耀角光栅 (7~11°),然后将其浸入特殊溶液后缓慢提拉出来。通过控制溶液浓度、提拉速度等参数,可以控制闪耀角。这种方法工艺难度较大,对加工人员的经验要求高,不适于大规模地采用。鉴于此,林慧等人[59]发展了一种新方法,通过Ar+与O2+混合离子束掠入射反应刻蚀的方法,直接在矩形掩模上刻蚀出小闪耀角的闪耀光栅,其闪耀角大小可以通过改变Ar+/O2+的比例实现精确控制。这种方法不需额外条件或加工过程,采用常规的离子束刻蚀设备即可一次实现,且工艺过程易于精确控制。采用该方法,已经制备出在13.62 nm处衍射效率 (-2级)为 36.2%的多层膜闪耀光栅[60]。这一结果不仅较 Dip-coating法制备出的 29.9%(工作波长 15.79 nm)[61]有较大提升,而且已经基本实现了目前制备技术所能达到的极限水平。
(2)多层膜光栅的可用光谱带宽受限。这一问题的产生根源于多层膜与光栅两种结构带宽的不匹配:多层膜的反射率带宽通常较窄 (FWHM值通常小于 1 nm),而光栅的沟槽衍射效率却具有较宽的带宽 (FWHM带宽大于几纳米)。在这种情况下,多层膜的带宽就自然成为了多层膜光栅可用光谱带宽的瓶颈。以往的多层膜光栅只有两个选择:或者只能应用于一个较窄的波段,或者将光栅基底分为几部分,在每一部分镀不同应用波长的多层膜[52]。但采用这样的做法会极大降低多层膜的可用面积,同时在一块光栅基底上进行多次沉积也会增加不确定因素。张立超等人[62]采用一种新方法解决了这一问题。该方法采用非周期型的多层膜代替传统的周期型多层膜。非周期膜系经过优化设计,可以在较宽的范围内具有高反射率,从而使多层膜反射率带宽与光栅的沟槽衍射效率很好地匹配,实现宽波长范围的高衍射效率。实际制备出的多层膜光栅在13~16 nm实现了约 10%的衍射效率。
从上述情况可见,多层膜光栅制备技术的发展,使得多层膜光栅的实用性得到了不断提高,这将在未来更好地满足高分辨率极紫外天文观测的需求。
6 结束语
多层膜是实现极紫外波段光学技术的基本光学元件。本文介绍了多层膜在极紫外光学技术中的应用及其发展情况。分析了多层膜技术中的关键问题,针对其在极紫外光刻与极紫外天文观测中的应用,阐述了实现多层膜光学元件所需满足的要求及其实现途径。无论对成像光学系统中所采用的常规多层膜,还是对于光谱仪器中采用的多层膜光栅来说,多层膜本身性能的不断提升,以及根据应用的具体要求,对多层膜光学元件进行不断的改进,都是使光学系统性能提升的根本推动力。目前,多层膜在极紫外波段的光学应用已从实验室研究阶段全面进入了以极紫外光刻与极紫外天文学为主的实用化阶段。未来的极紫外光学期待着性能更加优异、功能更加完善的新型多层膜光学元件。
[1] D.阿特伍德.软 X射线与极紫外辐射的原理和应用[M].张杰.北京:科学出版社,2003.ATT WOOD D T.Soft X-ray and Extreme U ltraviolet Radiation:Principle and Applications[M].ZHANG J.Beijing:Science Press,2003.(in Chinese)
[2] SP ILLER E.Soft X-ray Optics[M].Bellingham:SPIE Optical Engineering Press,1994.
[3] DUMOND J,YOUTZ J P.An X-raymethod for determining rate of diffusion in solid state[J].J.Appl.Phys.,1940,11(5):357-365.
[4] SP ILLER E.Low-loss reflection coatings using absorbing materials[J].Appl.Phys.Lett.,1972,20(9):365-369.
[5] BARBEE Jr TW.Sputtered layered synthetic microstructure(LS M)dispersion elements[J].A IP Conf.Proc.,1981,75:131-145.
[6] MONTCALM C,GRABNER R F,HUDY MA RM,et al..Atomic-precision multilayer coating of the first set of optics for an extreme-ultraviolet lithography prototype system[J].Appl.Opt.,2002,41(16):3262-3269.
[7] LOU IS E,van HATTUM E D,van der WESTERN S A,et al..High reflectance multilayers for EUVL HVM-projection optics[J].SPIE,2010,7636:76362T.
[8] 陈波,尼启良,王君林.软 X射线-极紫外波段光学研究[J].光学 精密工程,2007,15(12):1862-1868.CHEN B,N IQ L,WANG J L.Soft X-ray and extreme ultraviolet optics in C IOMP[J].Opt.Precision Eng.,2007,15(12):1862-1868(in Chinese).
[9] 林炳.软 X射线多层膜膜厚分布均匀性控制研究[D].长春:中国科学院长春光学精密机械与物理研究所,2002.L IN B.Study on thickness distribution uniformity control of soft X-raymultilayer mirrors[D].Changchun:Changchun Institute of Optics,Fine Mechanics and Physics,Chinese Academy of Sciences,2002.(in Chinese)
[10] 朱洪力.极紫外 /软 X射线多层膜热稳定性研究[D].长春:中国科学院长春光学精密机械与物理研究所,2008.ZHU H L.Researches of thermal stability of the EUV/SXR multilayers[D].Changchun:Changchun Institute of Optics,Fine Mechanics and Physics,Chinese Academy of Sciences,2002.(in Chinese)
[11] 尼启良,刘世界,陈波.小型高精度软 X射线-极紫外反射率计[J].光学 精密工程,2008,16(10):1886-1890.N IQ L,L IU SH J,CHEN B.Compact high-precision soft X-ay and extreme ultraviolet reflectometer[J].Opt.Precision Eng.,2008,16(10):1886-1890.(in Chinese)
[12] 向鹏.13 nm Mo/Si多层膜残余应力研究[D].长春:中国科学院长春光学精密机械与物理研究所,2002.X IANG P.Changchun:Changchun Institute of Optics,Fine Mechanics and Physics,ChineseAcademy of Sciences,2002.(in Chinese)
[13] 秦俊岭,邵建达,易葵,等.Mo/Si软 X射线多层膜的界面粗糙度研究[J].强激光与粒子束,2007,19(5):763-765.Q IN J L,SHAO J D,YI K,et al..Interface roughness ofMo/Si soft X-raymultilayer[J].High PowerLaser and Particle Beam s,2007,19(5):763-765.(in Chinese)
[14] 秦俊岭,邵建达,易葵,等.研究扩散屏障层对 Mo/Si多层膜软 X射线反射率影响的模拟 [J].光学学报,2007,36(2):300-303.Q IN J L,SHAO J D,YI K,et al..A simulation study of the influence of interdiffusion barrier on soft X-ray reflectivity of Mo/Simultilayers,Acta Opt.Sinica,2007,36(2):300-303.(in Chinese)
[15] 秦俊岭,邵建达,易葵.用不同的Mo靶溅射功率制备Mo/Si多层膜 [J].强激光与粒子束,2007,19(1):67-69.Q IN J L,SHAO J D,YIK.Mo/Simultilayer sprepared with different sputteringpowerofMo target[J].High PowerLaser and Particle Beam s,2007,19(1):67-69.(in Chinese)
[16] 朱京涛,黄秋实,白亮,等.不同本底真空度下 SiC/Mg极紫外多层膜的制备和测试 [J].光学 精密工程,2009,17(12):2946-2951 ZHU J T,HUANG Q SH,BA IL,et al..Manufacture and measurement of SiC/Mg EUV multilayer mirrors in different base pressures[J].Opt.Precision Eng.,2009,17(12):2946-2951.(in Chinese)
[17] 吴文娟.极紫外和软 X射线窄带多层膜的研究[D].上海:同济大学,2007.WU W J.The Study of extreme ultraviolet and softX-ray narrowbandmultilayers[D].Shanghai:TongjiUniversity,2007.(in Chinese)
[18] 王洪昌.极紫外与软 X射线多层膜偏振元件研究[D].上海:同济大学,2007.WANG H CH.The research of multilayer polarizing components in extreme ultraviolet and soft X-ray[D].Shanghai:TongjiUniversity,2007.(in Chinese)
[19] KA ISER N,YUL IN S,PERSKEM,et al..High-performance EUV multilayer optics[J].SPIE,2008:71010Z.
[20] SOUFL IR,SP ILLER E,SCHM IDTA M A,et al..Multilayer optics for an extreme ultraviolet lithography toolwith 70 nm resolution[J].SPIE,2001,4343:51-59.
[21] TAKAHARU M.Nikon EUVL development progress update[C].2006 EUVL Symposium Proceedings,Nikon T.Miura,16 Oct,2006.
[22] M IURA T,MURAKAM I K,SUZUKI K,et al..Nikon EUVL development progress summary[J].SPIE,2006,6151:615105.
[23] JEON C,KEARNER P,MA A,et al..Enabling defect-free masks for extreme ultraviolet lithography[J].SPIE,2007,6533:653310.
[24] YUL IN S,FEIGL T,KUHLMANN T,et al.. Interlayer transition zones in Mo/Si superlattices[J].J.Appl.Phys.,2002,92(3):1216-1220.
[25] STEARNSD G,GA INSD P,S WEENEYSD W,et al..Nonspecular X-ray scattering in a multilayer-coated imaging system[J].J.Appl.Phys.,1998,84(2):1003-1028.
[26] SCHRODER S,FEIGL T,DUPARRE A,et al..EUV reflectance and scattering ofMo/Simultilayers on differently polished substrates[J].Opt.Express,2007,15(20):13997-14012.
[27] HENKE B L,GULL IKSON EM,DAV IS J C.X-ray interactions:photoabsorption,scattering,transmission and reflection atE=50~30,000 eV,Z=1-92[J].A tom ic.Data and Nucl.Table,1993,54:181-342.
[28] ASCHENTRUP A,HACHMANN W,WESTERWALBESLOH,et al..Deter mination of layer-thickness fluctuations inMo-Simultilayers by cross-sectional HR-TE M and X-ray diffraction[J].Appl.Phys.A.,2003,77:607-611.
[29] YAKSH IN A E,Van de KRU IJS R W E,NEDELCU I,et al..Enhanced reflectance of interface engineeredMo/Simultilayers produced by ther mal particle deposition[J].SPIE,2007,6517:65170L.
[30] BAJT S,ALAMEDA J,BARBEE T,et al.. Improved reflectance and stability of Mo/Si multilayers[J].SPIE,2001,4506:65-75.
[31] BRAUN S,FOLTYN T,VAN LOYEN L,et al..Multi-component EUV multilayer mirrors[J].SPIE,2003,5037:274-285.
[32] SP ILLER E,BAKER S,PARRA E,et al..Smoothing ofmirror substrates by thin-fl im deposition[J].SPIE,1999,3767:143-153.
[33] BAKSH IV.EUV Lithography[M].Bellingham:SPIE Optical Engineering Press,2006.
[34] SP ILLER E.High performance multilayer coatings for EUV lithography[J].SPIE,2004,5193:89-97.
[35] FOLTA J A,BAJT S,BARBEE TW,et al..Advances in multilayer reflective coatings for extreme-ultraviolet lithography[J].SPIE,1999,3676:702-709.
[36] SOUFL IR,HUDY MA R M,SP ILLER E,et al..Sub-diffraction-l imited multilayer coatings for the 0.3 numerical aperture micro-exposure tool for extreme ultraviolet lithography[J].Appl.Opt.,2007,41(16):3262-3269.
[37] FREITAG JM,CLEMENSB M.Stress evolution inMo/Simultilayers for high reflectivity extreme ultraviolet mirrors[J].Appl.Phys.Lett.,1998,73:43-45.
[38] T INONEM,HAGA T,K INOSH ITA.Multilayer sputter deposition stress control[J].Electron Spectro.Relat.Phenom.,1996,80:461-464.
[39] SH IRA ISH IM,ISH IYAMA W,OSH INO T,et al..Low stressmolybdenum/siliconmultilayer coatings for extreme ultraviolet lithography[J].Jpn.J.Appl.Phys.,2000,39:6810-6814.
[40] SH IRA ISH IM,KANDAKA N,MURAKAM I K.Low-stress and high-reflective molybdenum/silicon multil ayers deposited by low-pressure rotary magnet cathode sputtering for EUV lithography[J].SPIE,2004,5374:104-111.
[41] ZOETHOUT E,SIPOS G,van de KRU IJS R W E,et al..Stressmitigation inMo/Simultilayers for EUV lithography[J].SPIE,2003,5037:872-878.
[42] BENO ITN,YUL IN S,FEIGL T,et al.EUV multilayer mirrors with enhanced stability.[J].SPIE,2006,6317:63170K.
[43] KA ISER N,YUL IN S,FEIGL T.Si-based multilayers with high thermal stability[J].SPIE,2000,4146:91-100.
[44] BAJT S,STEARNSD G.High-temperature stability multilayers for extreme-ultraviolet condenser optics[J].Appl.Opt.,2005,44:7735-7743.
[45] BENO ITN,YUL IN S,FEIGL T,et al.High-temperature multilayers[J].SPIE,2005,5751:1155-1161.
[46] DOM INGO V.Soho,Yohkoh,Ulysses and trace:the four solar missions in perspective and available resources[J].Astrophysics and Space Science,2002,282:171-188.
[47] DEFISE J M,MOSES J D,CATURA R C,et al..Calibration of EIT instrument for the SOHO mission[J].SPIE,1995,2517:29-39.
[48] SOUFL IR,W INDTD L,ROB INSON J C,et al.Development and testing of EUV multilayer coatings for the atomspheric imaging assembly instrument aboard the solar dynamics observatory[J].SPIE,2005,5901:59010M.
[49] W INDTD L,DONGUY S,SEELY J,et al..Experimental comparison of extreme-ultraviolet multilayers for solar physics[J].Appl.Opt.,2004,43(9):1835-1848.
[50] KESKI-KUHA R A M.Layer synthetic microstructure technology considerations for the ectreme ultraviolet[J].Appl.Opt.,1984,23(7):3534-3537.
[51] BROS IUS J W,DAV ILA JM,THOMAS R J.Solar active region and quiet-sun extreme-ultraviolet spectra from SERTS-95[J].Astrophysical J.Suppl.Series,1998,119:225-276.
[52] SEELY J F.Multilayer grating for the Extreme Ultraviolet Spectrometer(EUS)[J].SPIE,2000,4138:174-181.
[53] KOWALSKIM P,WOOD K S,BARSTOW M A,et al..It′s time for a new EUV orbitalmission[J].SPIE,2010,7732:77322E.
[54] KOWALSKIM P,BERENDSE F B,BARBEE TW,et al..The joint astrophysical plas madynamic experiment(J-PEX)high-resolution EUV spectrometer diffraction grating efficiency[J].SPIE,2006,41386266:62660W.
[55] KOWALSKIM P,CRUDDACE R G,WOOD K S,et al..Proposed multilayer-grating designs for the Astrophysical Plasmadynamic Explorer(APEX):an EUV high-resolution spectroscopic S MEX[J].SPIE,2004,5168:21-30.
[56] KOWALSKIM P,BARBEE Jr TW,CRUDDACE R G,et al..Efficiency and long-ter m stability of a multilayer-coated,ion-etched blazed holographic gratings in the 125-133Åwavelength region[J].Appl.Opt.,1995,34:7338-7346.
[57] SEELY J F,CRUDDACE R G,KOWALSKIM P,et al..Polorization and efficiency of a concave multilayer grating in the 135-250-Åregion and in normal-incidence and seya-namioka mounts[J].Appl.Opt.,1995,34:7347-7354.
[58] OSTERR IED K,H IDEMANN and NELLESB.Groove profile modification of blazed gratings by dip coating with hardenable liquids[J].Appl.Opt.,1998,37(34):8002-8007.
[59] HU IL,L IFENG L.Fabrication of extreme-ultraviolet blazed gratings by use of direct argon-oxygen ion-beam etching through a rectangular photoresistmask[J].Appl.Opt.,2008,47:6212-6218.
[60] HU IL,L ICHAO Z,L IFENGL,et al..High-efficiency multilayer-coated ion-beam-etched blazed grating in the extremeultraviolet wavelength region[J].Opt.Lett.,2008,33(5):485-487.
[61] KOWALSKIM P,SEELY J F,HUNTER W R,et al..Dual waveband operation of a multilayer-coated diffraction grating in the soft X-ray range at near-nor mal incidence[J].Appl.Opt.,1993,32:2422-2425.
[62] L I CHAO Z,HU IL,CHUNSHU IJ,et al..Broadband multilayer-coated normal incidence blazed grating with~10% diffraction efficiency through the 13-16 nm wavelength region[J].Opt.Lett.,2009,34(6):818-820.

