HEDTA对甲基磺酸盐镀液中锡-银-铜三元合金共沉积的影响
高学朋,张莹莹,贺岩峰*
(长春工业大学化学工程学院,吉林 长春 130012)
随着无铅化的实施,电子领域提出并采用了多种无铅化的镀层,如纯锡、锡银、锡铜和锡铋。但目前这些无铅化镀层依然存在锡晶须、相容性差、熔融温度高等问题。Sn-Ag-Cu 三元合金由于具有锡晶须风险低、与无铅焊料相容性好、可焊性好和熔融温度较低等优点,在电子电镀领域具有良好的发展前景。由于锡(-0.137 5 V)、银(0.799 1 V)和铜(0.340 V)的电极电位[1]相差很大,为实现Sn-Ag-Cu 的共沉积,必须采用适宜的配位剂。目前已有几种配位剂体系用于Sn-Ag-Cu 共沉积,包括碘化钾-焦磷酸钾-三乙醇胺体系[2-3]、碘化钾-焦磷酸钾体系[4]等。
笔者提出了一种以HEDTA(N-β-羟乙基乙二胺三乙酸)为主的新配位剂体系[5]。该配位剂体系以HEDTA为主配位剂、少量硫脲(0.06 mol/L)为辅助配位剂,具有镀液稳定性好、Sn-Ag-Cu 镀层可焊性好、易操作及易维护等优点。HEDTA 作主配位剂时,其含量对Sn-Ag-Cu 的电沉积过程和镀层的性能都有很大影响,而辅助配位剂硫脲在很大范围内(0.2~1.2 mol/L)变动都不会影响镀层性能。因此,本文重点研究镀液中HEDTA 含量对镀液电化学性能,镀层组成、表面形貌及晶体结构的影响。
1 实验
1.1 基体及试剂
电镀基体为铁镍42 合金引线框架(牌号SOT23),阳极为纯锡板。HEDTA,由日本东京化成工业株式会社(TCI)生产;甲基磺酸、甲基磺酸锡和甲基磺酸铜,均由上海新阳半导体材料股份有限公司生产;烷基糖苷(APG),由上海发凯精细化工有限公司生产;其他试剂,均为国药集团上海化学试剂公司的分析纯试剂。
1.2 电镀
电镀在自制的1 L 电镀槽中进行,采用IT6123 型高速高精度可编程电源(美国Itech Electronics)。电镀的工艺流程为:除油─水洗─去氧化─水洗─电沉积─水洗─中和─水洗─吹干。
除油液组成为:Na2CO330 g/L,Na3PO430 g/L,壬基酚聚氧乙烯醚5 g/L,60 °C,2 min。
去氧化液组成为:硫酸10%(体积分数),H2O25% (体积分数),常温,30~60 s。
中和液组成为:Na2CO33 g/L,50 °C,1 min。
电镀液采用甲基磺酸体系,其基础组成为:Sn(CH3SO3)20.18 mol/L,Ag2O 0.006 mol/L,Cu(CH3SO3)20.001 2 mol/L,硫脲0.06 mol/L,APG 1 g/L,HEDTA根据需要量加入,pH 4.0~6.0,温度25 °C,电流密度7 mA/cm2,时间30 min。镀液的配制为:依次加入HEDTA、甲基磺酸银(由甲基磺酸与氧化银反应制备)、硫脲、甲基磺酸锡、甲基磺酸铜和APG,用去离子水定容至所需体积,用甲基磺酸溶液和氢氧化钠溶液调节至所需的pH。
1.3 性能测试
采用北京普析通用的XD-2 型X 射线衍射仪(XRD)分析镀层构相,Cu 靶,电压35 kV,步长0.02°。采用日本电子的JEOL JSM-5600 型扫描电子显微镜(SEM)观察镀层表面形貌。采用美国热电的Thermo iCAP 6300 型电感耦合等离子体发射光谱仪(ICP)测定镀层各组分的质量分数。
极化曲线的测定在CHI660D 型电化学工作站(上海辰华仪器公司)上进行,采用三电极体系,工作电极为直径2 mm 的铂盘电极,对电极为铂丝电极,参比电极为饱和甘汞电极(SCE),扫描速率0.01 V/s,扫描范围为-0.3~-1.4 V。
2 结果与讨论
2.1 镀液的极化曲线
图1是在基础镀液中加入不同浓度HEDTA 时Sn-Ag-Cu 共沉积的极化曲线。

图1 镀液中HEDTA 含量不同时Sn-Ag-Cu 合金共沉积 极化曲线Figure 1 Polarization curves for codeposition of Sn-Ag-Cu alloy with different HEDTA contents in plating bath
由图1可见,随镀液中HEDTA 浓度的增大,起始沉积电位负移,但负移的幅度不明显。从局部放大图看,起始沉积电位从HEDTA 含量为0.6 mol/L 的-1.00 V 负移至HEDTA 含量为1.6 mol/L 时的-1.05 V。对比不加配位剂的单金属锡(-0.46 V)、银(0.35 V)和铜(0 V)的起始沉积电位[5],当镀液中HEDTA 为0.6 mol/L 时,3 种金属共沉积的起始沉积电位发生明显的负移。但当HEDTA 的含量从0.6 mol/L 增大至1.6 mol/L 时,起始沉积电位仅负移0.05 V。这说明在HEDTA 浓度为0.6~1.6 mol/L 的范围内(即HEDTA 与Sn 的摩尔比为3.3~8.9 时),HEDTA 浓度的波动对Sn-Ag-Cu 共沉积电位的影响很小。
在-1.03 V 至-1.07 V 的范围内,不同HEDTA 含量的曲线均存在1 个还原峰,这些还原峰是由金属离子在阴极上沉积析出而产生。随金属离子的还原析出,电极表面的金属离子被消耗,当金属离子向电极表面的扩散速率不足以维持一定的还原速率时,电流密度下降,曲线上便出现1 个电流峰。从-1.1 V 开始,析氢反应的发生使电流进一步增大,曲线又开始上升。
约-1.2 V 开始,极化曲线受镀液中HEDTA 含量变化的影响很大。随HEDTA 含量增大,曲线明显向电流密度减小的方向移动,这可能与HEDTA 吸附于电极表面有关。
镀液中HEDTA 的含量较低时的极化曲线见图2。

图2 镀液中HEDT含量低时的Sn-Ag-Cu 合金共沉积极化曲线Figure 2 Polarization curves for codeposition of Sn-Ag-Cu alloy with low HEDTA contents in plating bath
从图2可知,HEDTA 含量为0.4 mol/L、0.6 mol/L时,对应的起始沉积电位分别为-0.97 V、-1.0 V,较为接近。HEDTA 为0.2 mol/L 时,起始沉积电位为-0.51 V,与无配位剂时锡的起始沉积电位(-0.46 V)接近,此时n(HEDTA)∶n[Sn(II)]为1.1∶1.0,HEDTA的配位能力不足,沉积电位负移较小。HEDTA 的浓度大于0.4 mol/L 时,即n(HEDTA)∶n[Sn(II)]大于2.2∶1.0 时,才能达到一定的配位要求,使电位产生较大的负移。
2.2 镀层的元素组成
镀液中HEDTA 的浓度对镀层成分的影响见图3。从图3可知,HEDTA 为0.6~1.2 mol/L 时,即n(HEDTA)∶n[Sn(II)]为(3.3~6.7)∶1.0 时,镀层中Sn、Ag 和Cu 的含量受HEDTA 含量变化的影响较小。结合2.1 结果分析可知,HEDTA 的浓度大于0.6 mol/L时,HEDTA 对金属离子的配位能力受HEDTA 含量变化的影响不大,这可能是镀层中各元素含量基本维持不变的原因。这一特征对其工业应用非常重要,因在长期的工业操作中,配位剂的含量总会有一定的波动,若这种波动在很大范围内不影响镀层的组成,那么工艺窗口就宽,生产过程就容易维持。
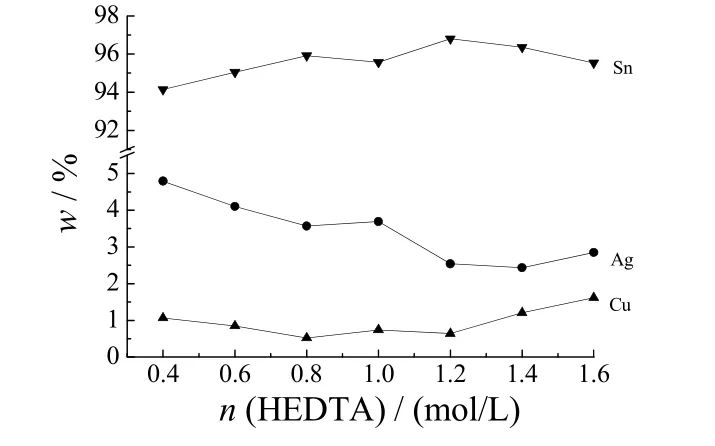
图3 镀液中HEDTA 含量对Sn-Ag-Cu 合金镀层成分的影响Figure 3 Effect of HEDTA content in plating bath on composition of Sn-Ag-Cu alloy coating
从图3还可看出,HEDTA 大于1.2 mol/L 时,镀层中的Cu 含量增大,Sn 含量则下降,银含量变化较小。结合上文分析可知,HEDTA 含量的增加并不会引起配位能力的变化,所以镀层组成的变化可能是由HEDTA在电极表面的吸附引起。HEDTA 对锡电沉积的抑制作用比铜强,因而镀层中锡含量降低,铜含量相应增大。HEDTA 的吸附作用对银的电沉积影响小,所以银含量变化不大。
当HEDTA 的浓度低于0.4 mol/L 时,镀层中银含量增加,锡含量下降,但此时得到的镀层发黑、粗糙,镀层各组分含量波动大,重现性差,故没有列出。这可能是因为HEDTA 含量减少引起配位不足。从图2可知,HEDTA 为0.4 mol/L 时,起始沉积电位已负移至-0.97 V 附近,此时HEDTA 对锡和铜的配位已经足够,但对银来说可能仍然不足。所以,随HEDTA 的减少,银含量增加,铜含量近似不变,锡含量相应减少。
2.3 镀层的表面形貌
图4为从含不同浓度 HEDTA 镀液中制得的Sn-Ag-Cu 合金镀层的SEM 照片。由图4可见,当HEDTA 为1.0 mol/L,即n(HEDTA)∶n[Sn(II)]为5.6∶1.0 时,镀层结晶颗粒细小、均匀,镀层表面平整、致密。HEDTA 为0.6~1.2 mol/L 时,镀层表面形貌相似,均有光亮而均匀的外观。
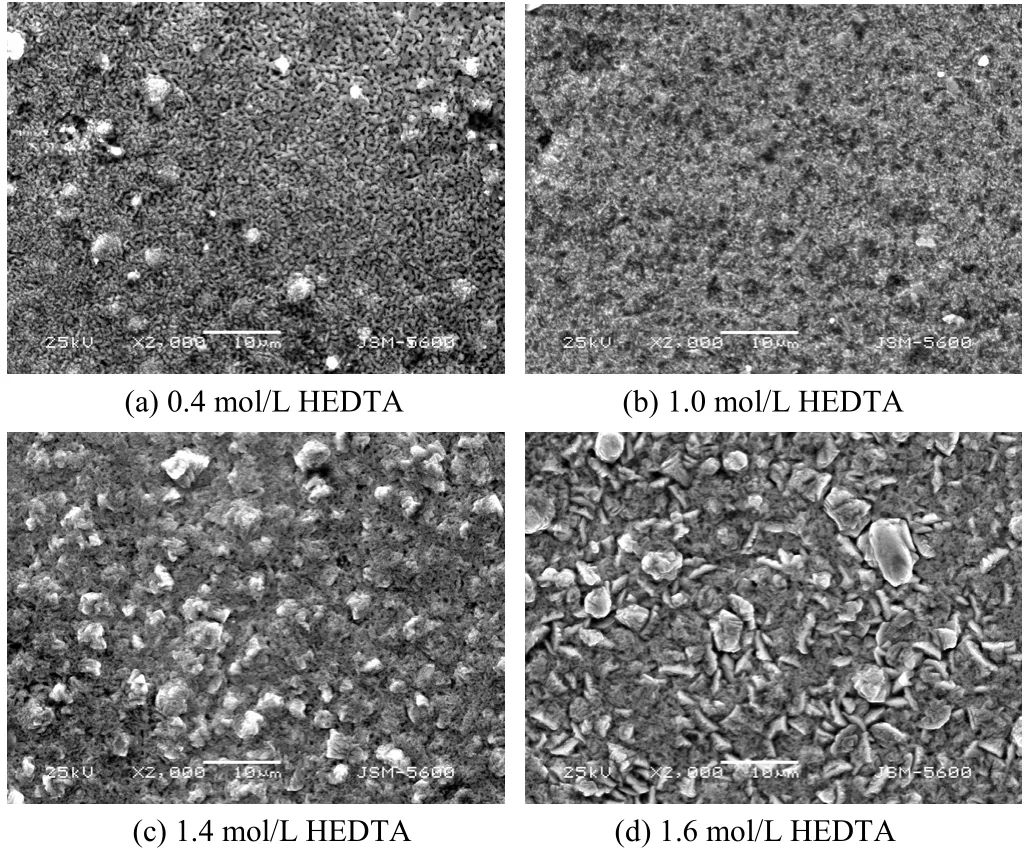
图4 镀液中HEDTA 含量对Sn-Ag-Cu 镀层表面形貌的影响Figure 4 Effect of HEDTA content in plating bath on surface morphology of Sn-Ag-Cu alloy coating
但在上述HEDTA 浓度范围以外,镀层的表面形貌发生变化。HEDTA 为0.4 mol/L(图4a)时,镀层结晶颗粒不均匀,出现大的颗粒;1.4 mol/L 和1.6 mol/L (图4c、图4d)时,结晶颗粒粗大,且呈不均匀堆积,表面也不平整,有孔隙出现。另外,镀层外观也较暗。
2.4 镀层的相结构
图5为不同浓度的HEDTA 下所得镀层的XRD 谱图。由图5可知,Sn-Ag-Cu 合金镀层主要由Sn、Ag3Sn和Cu6Sn5组成,不存在游离态的银和铜。在Sn-Ag-Cu镀层中的金属间化合物相(Ag3Sn 和Cu6Sn5)可能与银、铜和锡发生的固相反应有关[6]。

图5 镀液中HEDTA 含量对Sn-Ag-Cu 合金镀层结构的影响Figure 5 Effect of HEDTA content in plating bath on structure of Sn-Ag-Cu alloy coating
不同HEDTA 浓度下所得镀层的ICP 结果表明,镀液中含0.4 mol/L HEDTA 时,镀层为94.14%Sn-4.79%Ag-1.07%Cu;1.0 mol/L 时,镀层为95.57%Sn-3.69%Ag-0.74%Cu;1.4 mol/L 时,镀层为96.36%Sn-2.43%Ag-1.21%Cu。各国对Sn-Ag-Cu 共晶合金的组成有着不同规定,日本电子信息技术产业协会(JEITA)规定为Sn-3.0%Ag-0.5%Cu,欧洲IDEALS 协会规定为Sn-3.8%Ag-0.7%Cu,美国电子机器制造者协会(NEMI)规定为Sn-3.9%Ag-0.6%Cu。通常公认的近共晶组成为Sn-(3.0%~4.1%)Ag-(0.5%~0.9%)Cu[7]。可见,镀液中HEDTA 的浓度为1.0 mol/L 时,镀层具有近共晶组成;HEDTA 为0.4 mol/L 时,镀层中Ag 含量稍高;HEDTA 为1.4 mol/L 时,镀层中Ag 含量稍低。
镀液中HEDTA 的浓度不同时,镀层的结晶取向也有较大差别。由于金属锡在整个合金镀层中为主要组成部分,因此XRD 谱图主要由锡的衍射峰构成。由于镀层是在水溶液中和非平衡条件下(金属离子的还原及晶核的长大在电化学极化和浓差极化下进行,受扩散影响)得到,因此镀层的相结构往往与块状的同类金属不同。由图5可见,HEDTA 为0.4 mol/L 时,Sn的结晶取向以(101)和(220)晶面占优;HEDTA 大于1.0 mol/L 时,Sn(101)峰消失;HEDTA 为1.0 mol/L时,Sn 的结晶取向以(220)、(211)和(321)晶面占优;HEDTA 为1.4 mol/L 时,以Sn(220)晶面占优。
显然,镀液中HEDTA 的浓度对镀层的结晶取向有较大影响。其原因可能为:HEDTA 含量不同时,HEDTA 的配位和吸附作用不同,使电化学条件改变,从而影响了电化学结晶成核和生长过程。
3 结论
(1) 随镀液中HEDTA 浓度增大,Sn-Ag-Cu 的沉积电位负移。n(HEDTA)∶n[Sn(II)]为1.1∶1.0 时,HEDTA 的配位能力不足,电位的负移较小;n(HEDTA)∶n[Sn(II)]大于2.2∶1.0 时,才能达到一定的配位要求,使电位产生较大的负移;HEDTA 为0.6~1.6 mol/L 时,即n(HEDTA)∶n[Sn(II)]为3.3~8.9 时,HEDTA 浓度的波动对Sn-Ag-Cu 共沉积电位的影响很小。
(2) HEDTA 为0.6~1.2 mol/L 时,镀层中Sn、Ag 和Cu 的含量随HEDTA 浓度的变化较小。
(3) HEDTA 为0.6~1.2 mol/L 时,不同浓度下得到的镀层表面形貌相似,结晶颗粒细小、均匀,表面平整、致密。HEDTA 浓度过高或过低都出现镀层结晶颗粒粗大、不均匀堆积、表面不平整等现象。
(4) Sn-Ag-Cu 合金镀层主要由Sn、Ag3Sn 和Cu6Sn5组成,改变镀液中HEDTA 的浓度,镀层的结晶取向也改变。
[1]SPEIGHT J G.Lange’s Handbook of Chemistry [M].16th ed.New York:McGraw-Hill,2005:1380-1392.
[2]张锦秋,安茂忠,常立民,等.主盐浓度和工艺条件对Sn-Ag-Cu 合金镀层组成和形貌的影响[J].无机化学学报,2008,24 (7):1056-1061.
[3]ZHANG J Q,AN M Z,CHANG L M,et al.Efect of triethanolamine and heliotropin on cathodic polarization of weakly acidic baths and properties of Sn-Ag-Cu alloy electrodeposits [J].Electrochimica Acta,2008,53 (5):2637-2643.
[4]QIN Y,WILCOX G D,LIU C Q.Electrodeposition and characterisation of Sn-Ag-Cu solder alloys for flip-chip interconnection [J].Electrochimica Acta,2010,56 (1):183-192.
[5]HE Y F,GAO X P,ZHANG Y Y,et al.Electrodeposition of Sn-Ag-Cu ternary alloy from HEDTA electrolytes [J].Surface and Coatings Technology,2012,206 (19/20):4310-4315.
[6]FUJIWARA Y,ENOMOTO H.Intermetallic phase formation in electrochemical alloy deposition [J].Journal of Solid State Electrochemistry,2004,8 (3):167-173.
[7]ABTEW M,SELVADURAY G.Lead-free solders in microelectronics [J].Materials Science and Engineering R:Reports,2000,27 (5/6):95-141.

