新型复合盖层延伸波长InGaAs红外探测器结构优化设计
赵 旭,缪国庆,张志伟,曾玉刚
(1.发光学及应用国家重点实验室中国科学院长春光学精密机械与物理研究所,吉林长春 130033;2.中国科学院大学,北京 100049)
新型复合盖层延伸波长InGaAs红外探测器结构优化设计
赵 旭1,2,缪国庆1*,张志伟1,曾玉刚1
(1.发光学及应用国家重点实验室中国科学院长春光学精密机械与物理研究所,吉林长春 130033;2.中国科学院大学,北京 100049)
设计并模拟计算了延伸波长至2.6μm的复合盖层材料PIN结构In0.82Ga0.18As红外探测器,即PNN型盖层、PIN结构的In0.82Ga0.18As红外探测器。研究了不同厚度及载流子浓度的PNN盖层对探测器性能的影响。研究结果表明:在In0.82Al0.18As厚度为200 nm且载流子浓度为2E18、InAs0.6P0.4厚度为50 nm且载流子浓度为2E17、In0.82Ga0.18As厚度为50 nm且载流子浓度为2E16时,探测器表现出最佳的性能。与传统PIN结构探测器相比,其相对光谱响应度仅降低10%,暗电流降低了1个数量级。计算分析了不同工作温度下的暗电流,结果显示:在120~250 K时,暗电流主要为缺陷隧穿电流;在250~300 K时,暗电流主要为带间隧穿电流;当温度大于300 K时,暗电流主要为产生-复合电流和扩散电流。
红外探测器;APSYS;盖层;光谱响应度;暗电流
1 引 言
工作在1~3μm的近红外探测器件在空间遥感、大气监测、资源勘探等领域都有重要的应用[1]。InGaAs材料可以覆盖1~3μm近红外波段,具有高吸收系数、高迁移率、高工作温度下高探测率(轻量化)、良好的均匀性和稳定性(高可靠)、优秀的空间抗辐照性能(长寿命)等优点,因此,InGaAs探测器是近年来最具发展前景的近红外探测器[2]。但是,较高的暗电流是制约InGaAs探测器发展和应用的主要问题。由于PIN结构红外探测器制作工艺简单、响应度高,所以目前在设计器件时一般都采用该结构[3]。在器件实际制作之前,对其结构和性能进行模拟、优化,能大大节约资源,提高效率。对于通信用的In0.53Ga0.47As探测器和APD结构InGaAs红外探测器,已经有了大量的研究报道。一种模拟的方法是使用SPICE电路模型模拟器[4]对材料、结构不同的光电探测器建立对应的电路模型,研究其光电特性;另外一种就是基于载流子连续性方程和泊松方程建立器件模型,利用数值计算工具进行器件特性的分析[5-6]。
利用模拟计算的方法优化延伸波长InGaAs探测器的器件结构,从而有效提高器件光电性能是一项非常有意义的工作。本文在验证了APSYS可靠性的基础上,开展了高性能延伸波长InGaAs近红外探测器的研究。首次采用APSYS软件建立了完整的PNN复合盖层InGaAs红外探测器单元器件模型,通过调整盖层材料、厚度、载流子浓度等参数,优化了PIN型延伸波长至2.6 μm的InGaAs红外探测器器件结构。优化后的器件暗电流可以降低一个数量级,而光谱响应度仅降低10%。在此基础上,通过模拟不同工作温度下的暗电流曲线,分析和解释了不同工作温度下的暗电流机制。
2 实 验
采用Crossright公司设计的APSYS对InGaAs红外探测器进行模拟计算。APSYS是一款2D/ 3D有限元分析软件,它包括了许多物理模型,例如热载流子输运、异质结模型、热分析等,拥有强大的模拟功能。这里我们基于漂移-扩散模型,通过求解自洽解泊松方程、电流连续性方程来得到较为精确的模拟曲线[7-9],对器件进行优化及设计。
首先在APSYS中建立器件结构模型,调用物理模型(泊松方程、电流连续性方程、光子波动方程、光子速率方程、光子增益方程等),参考软件数据库设置详细的控制条件(各层载流子迁移率、载流子寿命、电压、复合速率等),编辑输出命令集合(暗电流、光电流、光谱响应度等),得到暗电流和光谱响应度的模拟结果。然后,通过调整盖层(P、N1、N2)厚度和载流子浓度等来使暗电流和光谱响应度的综合指标达到最佳。
3 结果与讨论
3.1 模拟结果与实验结果的对比
为了验证APSYS模拟PIN型延伸波长In-GaAs近红外探测器的可靠性,我们对InP盖层和InAs0.6P0.4盖层的InGaAs探测器进行了模拟,并与实验结果进行了对比。两种探测器衬底均为InP,掺杂浓度为2E18;缓冲层分别为100 nm和80 nm的In0.82Ga0.18As,掺杂浓度为2E18;吸收层分别为2.9μm和3.1μm的In0.82Ga0.18As,本征载流子浓度为3E16;盖层为0.9μm InAs0.6P0.4和3.1μm InP,掺杂浓度为2E18[10-12]。
图1为模拟计算和实验测得的器件相对光谱响应度的对比,从图中可以看出二者较为接近。实验测得的相对光谱响应度略小于模拟计算出的值,这是因为模拟计算是在理想条件下进行的,而实验制作的器件要受到实际工艺技术水平的制约。另外,实验测得的相对光谱响应度在1.38μm和1.9μm处出现了波动,这主要是由于红外辐射中的一部分被空气中的CO2和H2O吸收所致。
图2为模拟计算和实验测得器件暗电流的对比,由图可知二者极为接近。同样,实验暗电流略大于模拟计算所得暗电流,这是由实际工艺条件造成的。综合上面的比较,我们可以得出结论,用APSYS对PIN延伸波长探测器进行模拟计算是精确、可靠的。
3.2 新型复合盖层InGaAs红外探测器优化设计
在验证模型之后,我们设计了一种新的结构:复合型盖层延伸波长InGaAs探测器。即盖层中采用PNN结构,以期提高器件性能。
使用InGaAs盖层不仅容易生长而且可以减少与吸收层之间的晶格失配,减少位错,降低暗电流;而采用InAsP、InAlAs作为盖层,则会使In0.82-Ga0.18As材料的表面钝化,从而降低表面复合率。为了提高器件的量子效率,减少晶格失配带来的位错,我们用Vegard定律计算得到与In0.82Ga0.18As晶格匹配的两种盖层应为In0.82Al0.18As/InAs0.6P0.4。另外,本征的In0.82Ga0.18As吸收层相对于重掺杂的盖层和N型缓冲层与衬底来说是高阻层,可以有效抑制载流子热扩散电流,从而降低器件的暗电流,提高器件的灵敏度。根据Piotrowski[13]提出的理论模型,吸收层的厚度在2~3μm时,探测器的探测率[14]最大。因此,综合探测器的探测率和量子效率等各方面的因素,我们设计 In0.82-Ga0.18As本征吸收层的厚度为2.5μm,这样可以在保证响应速度的同时尽可能提高量子效率。

图1 相对光谱响应度对比。(a)InP盖层InGaAs探测器的模拟结果;(b)InP盖层InGaAs探测器的实验结果;(c) InAs0.6 P0.4盖层InGaAs探测器的模拟结果;(d)InAs0.6 P0.4盖层InGaAs探测器的实验结果。Fig.1 Comparison of the response.(a)Simulation resultof InGaAs detectorwith InP cap.(b)Experiment resultof InGaAs detector with InP cap.(c)Simulation result of InGaAs detector with InAs0.6 P0.4 cap.(d)Experiment result of InGaAs detector with InAs0.6 P0.4 cap.

图2 暗电流对比Fig.2 Comparison of the dark current
综上所述,计算中采用的模拟参数为:衬底为1μm的N型InP材料,载流子浓度为2E18;缓冲层为1μm的N型InxAl1-xAs(x=0.52~0.82)渐变组分缓冲层,载流子浓度为2E18;吸收层为2.5 μm的Ⅰ型In0.82Ga0.18As材料,载流子浓度为3E16;在盖层的PNN结构中,P层为In0.82Al0.18As,N型分别为InAs0.6P0.4和In0.82Ga0.18As。
PNN盖层各层厚度模拟计算数值如表1所示。在确定最佳厚度后,我们进一步调整载流子浓度取值范围,载流子浓度从1E16到2E18,每隔1E16(1E17、1E18)取一个值。
通过比较暗电流和相对光谱响应度,我们得出优化后的器件结构如图3所示。
图4所示为PNN复合盖层InGaAs探测器在最佳载流子浓度下的相对光谱响应度曲线。在外加反向偏压为0~0.1 V时,优化后的器件暗电流密度为10-5数量级,比常规的(10-4)小一个数量级。图5为优化后器件的相对光谱响应度曲线,由图可知它的长波截止波长为2.6μm,短波截止波长约为0.9μm。相对光谱响应度的峰值出现在2.0μm处,比常规的PIN型InGaAs红外探测器峰值小10%,对器件性能影响不大。综上所述,图3所示的器件结构大大提高了InGaAs红外探测器的性能。
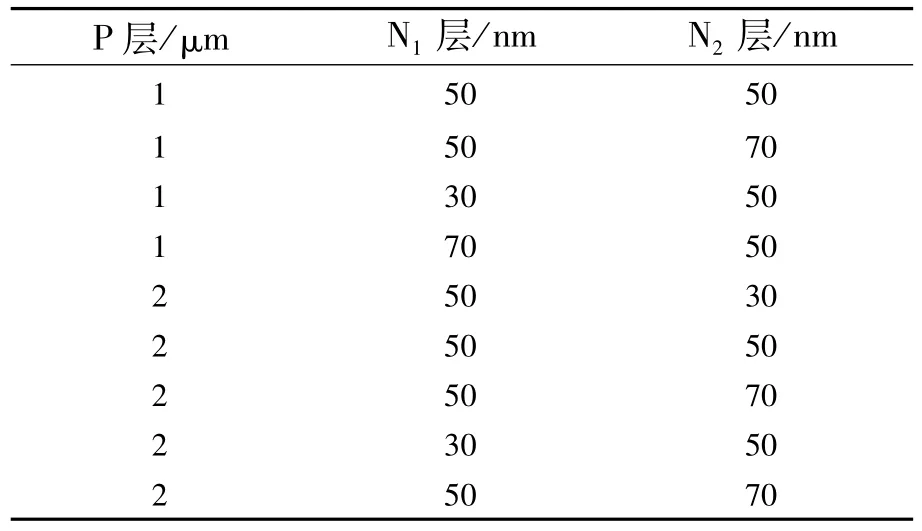
表1 InAlAs/InAsP/InGaAs盖层厚度Table 1 Thickness of InAlAs/InAsP/InGaAs cap

图3 优化后的PNN复合盖层InGaAs探测器结构Fig.3 InGaAs detector device structure with optimized PNN cap
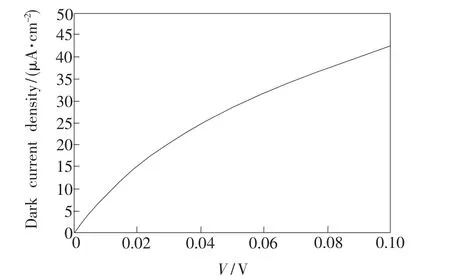
图4 PNN复合盖层InGaAs探测器在最佳载流子浓度下的暗电流I-V曲线Fig.4 I-V characteristic(dark)of the detector with PNN cap at the optimum concentration
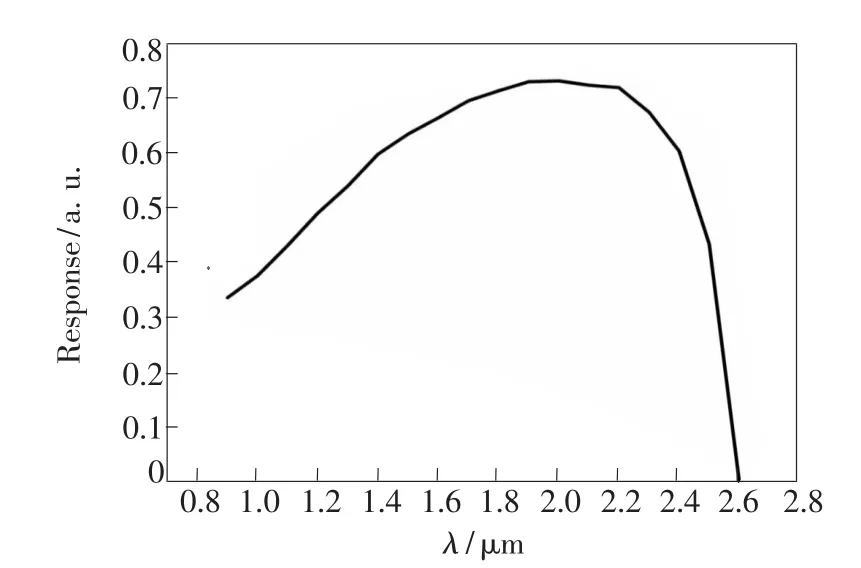
图5 PNN复合盖层InGaAs探测器在最佳载流子浓度下的相对光谱响应度曲线Fig.5 Relative spectral responisivity of the detector with the PNN structure at the optimum concentration
3.3 暗电流机制的分析
为了探究暗电流机制,我们模拟计算了优化后的InGaAs探测器在不同工作温度下的暗电流。图6为暗电流随1 000/T的变化关系。我们知道,产生-复合电流、扩散电流、界面复合电流和隧穿电流[15]为InGaAs红外探测器暗电流的4种机制。扩散电流[16]主要为耗尽层边缘的热激发产生的少数载流子从P区、N区向耗尽层扩散形成的电流;产生-复合电流[17]主要为热激发产生的载流子在电场的作用下由势垒区向势垒两边漂移而形成的电流;界面复合电流主要为由于材料体系的失配位错而产生的界面电流;隧穿电流主要为隧道效应而产生的电流,按照载流子穿越禁带方式的不同,分为带间隧穿电流和缺陷隧穿电流[18]。

图6 器件暗电流随温度(1 000/T)的变化关系Fig.6 Reverse current curve of the detector vs.temperature (1 000/T)
扩散电流和产生-复合电流都与1 000/T成线性关系。所以在温度大于300 K(图中Ⅰ区)时,暗电流主要为扩散电流和产生-复合电流;在250~300 K区间(图中Ⅱ区),接近线性变化,但斜率小于Ⅰ区,此时暗电流主要为带间隧穿电流;当温度低于250 K(图中Ⅲ区)时,曲线几乎不变,此时暗电流主要为缺陷隧穿电流。
4 结 论
通过一系列模拟计算,得到了性能优于常规延伸波长的InGaAs红外探测器新结构——PNN复合盖层的PIN型InGaAs探测器结构。该结构PNN盖层分别为0.2μm厚的载流子浓度为2E18的In0.82Al0.18As,50 nm厚的载流子浓度为2E17的InAs0.6P0.4,50 nm厚的载流子浓度为2E16的In0.82Ga0.18As。与常规InGaAs探测器相比,设计并优化后的新器件的暗电流小了一个数量级,而相对光谱响应仅下降10%。在工作温度低于280 K时,新器件暗电流主要为缺陷隧穿电流;工作温度在280~300 K之间时,暗电流主要为带间隧穿电流;工作温度在300 K以上时,暗电流主要为产生-复合电流和扩散电流。
[1]Hoogeveen RW M,Vander RW A,Goede A P.Extended wavelength InGaAs infrared(1.0-2.4μm)detector arrays on SCIAMACHY for space-based spectrometry of the earth atmosphere[J].Infrared Phys.Technol.,2001,42(1):1-16.
[2]Wada M,Hosomatsu H.Wide wavelength and low dark current lattice-mismatched InGaAs/InAsP photodiodes grown by metalorganic vapor-phase epitaxy[J].Appl.Phys.Lett.,1993,64(10):1265-1267.
[3]Li P.InGaAs/InP photoelectric detector[J].Infrared(红外),2004,10:10-14(in Chinese).
[4]Webb P P.Properties of avalanche photodiodes[J].RCARev.,1974,35(4):34-78.
[5]Chen W.PIN avalanche photodiodesmodel for circuit simulation[J].IEEE J.Quant.Electron.,1996,32(12):2105-2111.
[6]Ma F.Monte Carlo simulation of low noise avalanche photo diode with hetero junction[J].Appl.Phys.Lett.,2002,92 (6):4791-4795.
[7]Karam N H.Triple-junction solar cell efficiencies above 32%:The promise and challenges of their application in highconceniration-ratio PV systems[J].IEEE Trans,2000:955-960.
[8]Christol P,EIGazouli M,Bigenwald P,et al.Performance simulation of 3.3μm interband laser diodes grown on InAs substrate[J].IEEE J.,2002,14(4):375-384.
[9]Jeon SR,Cho M S,Yu M A.GaN-based light-emitting diodes using tunnel junctions[J].IEEE J.Select.Top.Quant. Electron.,2002,8(2):739-743.
[10]Liu X,Song H,Miao G Q,et al.Effect of buffer layer annealing temperature on the crystalline quality of In0.82Ga0.18As layers grown by two-step growth method[J].J.Alloys Compd.,2011,509(24):6751-6755.
[11]Liu X,Song H,Miao GQ,etal.Influence of buffer layer thickness and epilayer's growth temperature on crystalline quality of InAs0.6P0.4/InP grown by LP-MOCVD[J].Solid State Commun.,2011,151(12):904-907.
[12]Miao G Q,Zhang TM,Zhang ZW,et al.Extended spectral response in In0.82Ga0.18As/InP photodetector using InP as a window layer grown by MOCVD[J].Cryst.Eng.Comm.,2013,15:8461-8462.
[13]Caniou J.Passive Infrared Detection:Theory and Application[M].Boston:Kluwer Academic Publishers,1999:78-81.
[14]Piotrowski J.Film-type infrared photoconductors[J].Proceedings of IRE,1959,47:1471-1475.
[15]Forrest SR.Voltage tunable integrated infrared imager[J].IEEEQuant.Electron.,1981,17(2):217-221.
[16]Caniou J.Passive Infrared Detection:Theory and Application[M].Boston:Kluwer Academic Publishers,1999:620.
[17]Forrest SR,Leheny R F,Nahory R F,etal.In0.53Ga0.47As photodiodeswith dark current limited by generation-recombination and tunneling[J].Appl.Phys.Lett.,1980,37(3):322-325.
[18]Forrest SR,DiDomenico M,Smith R G,etal.Evidence for tunneling in reverse-biasedⅢ-Ⅴphotodetector diodes[J]. Appl.Phys.Lett.,1980,36(7):580-582.
Structural Design and Optim ization of Novel Com posite Cap Extended W avelength InGaAs Infrared Detector
ZHAO Xu1,2,MIAO Guo-qing1*,ZHANG Zhi-wei1,ZENG Yu-gang1
(1.State Key Laboratory of Luminescence and Applications,Changchun Institute of Optics,Fine Mechanicsand Physics,Chinese Academy of Sciences,Changchun 130033,China;2.University of Chinese Academy of Sciences,Beijing 100049,China) *Corresponding Author,E-mail:miaogq@ciomp.ac.cn
The near-infrared detector of In0.82Ga0.18As with PIN structure was designed and simulated by APSYS.The long-wave cutoffwavelength was extended to 2.6μm.Three doped layerswere deposited on the absorption layer,which contained P type N type,N type and by growth order.The thickness and concentration of each doped layer in cap layer were analyzed.The results show that In0.82Ga0.18As,InAs0.6P0.4and In0.82Al0.18As layers by growth order are determined to obtain the excellent performance.The relative spectral responsivity of the detector keeps almost the same,and dark current decreases by onemagnitude compared with the PIN structure.The defect tunneling current predominates when the detector works at 120-250 K,the inter-band tunneling current dominates the dark currentwhen the detector works at 250-300 K,and the G-R current and diffusion current dominates the dark currentwhen the detector works above 300 K.
infrared detector;APSYS;cap layer;responsivity;dark current
“973”国家重点基础研究发展计划(2012CB619201)资助项目
O472.3
A
10.3788/fgxb20153601.0075
1000-7032(2015)01-0075-05
2014-08-12;
2014-09-11

赵旭(1986-),男,吉林松原人,硕士研究生,2010年于吉林大学获得学士学位,主要从事Ⅲ-Ⅴ族半导体光电器件模拟方面的研究。E-mail:zhaoxu8137@163.com

缪国庆(1964-),男,吉林德惠人,研究员,博士生导师,1992年于中国科学院长春物理研究所获得博士学位,主要从事半导体光电子材料和器件方面的研究。E-mail:miaogq@ciomp.ac.cn

