开关电源SiP技术应用研究
袁柱六,张 崎,袁宝山,曲明山,王 宁,刘云鹏
(1. 中国电子科技集团公司第四十三研究所,安徽 合肥 230088;2. 成都宏明电子科大新材料有限公司,四川成都 610100)
开关电源SiP技术应用研究
袁柱六1,张 崎1,袁宝山1,曲明山2,王 宁1,刘云鹏1
(1. 中国电子科技集团公司第四十三研究所,安徽 合肥 230088;2. 成都宏明电子科大新材料有限公司,四川成都 610100)
通过对开关电源内部标准单元电路构成和内部元器件的特性分析研究,结合SiP技术,采用LTCC/HTCC工艺技术制作多层3D结构,实现开关电源电路中标准单元电路3D结构设计,有效提高了空间利用率,减小了体积。同时对该结构的热力载荷进行了可靠性分析,最后通过实际产品设计验证,证明SiP技术在开关电源中应用的可行性。
SiP;LTCC;HTCC;标准单元电路;可靠性;开关电源
微系统技术包含系统级封装(System in Package-SiP)和系统级芯片(System on Chip-SoC),他们是当今电子系统发展趋向小型化、高性能、多功能、高可靠性和低成本等强力需求驱动下的产物,共同点是最终都以一只集成芯片的形式实现不同功能模块的集成,不同的是实现方式,SoC是在芯片上实现,而SiP则是在封装上实现。近年来SoC正面临极大的技术发展瓶颈,如研发周期、费用和风险等急剧增加,特别是异质元件的集成。由此,兼具尺寸与开发灵活性优势的 SiP跃然而起,成为后摩尔定律时代的典型代表[1]。
SiP英文全称是“System in Package”,指在一个封装体内能够实现一个系统或子系统功能,能把多个集成电路芯片和无源元器件以及其他支撑元器件综合于一体。SiP技术是以“异质异构集成、高密度互连、三维封装”为主要技术手段,主要包括芯片堆叠技术、埋置元器件技术、IPD(Integrated Passive Device)技术、TSV(Through-Silicon-Via)硅通孔技术、POP(Package on Package)技术等。使得它比标准的SMT体积更小、性能更优,而和SoC相比,SiP可降低一次性设计费用,缩短新产品开发和推广使用的周期,降低成本[2]。美国、欧洲以及日本、韩国、新加坡等国家对SiP技术的研究始于20世纪90年代,美国将其列为重点发展的十大军民两用高新技术之一。国内华为、中兴等厂商走在 SiP技术发展的前列。由此,SiP技术广泛应用于RF无线电、传感器、网络及计算机技术和高速数字等手机、穿戴设备消费市场等产品领域。
SiP技术在高可靠混合集成开关电源产品领域尚处于研究阶段,鲜见相关的报道。为了实现开关电源小型化设计,缩短研发周期和降低成本,作者通过对开关电源单元电路标准化设计以及元器件特性分析研究,提出单元电路标准化、通用化和模块化设计思路,同时采用 SiP技术对标准单元电路的微型化提出一种三维结构设计方法,旨在提高空间利用率,减小体积,缩短设计周期和降低设计成本,同时对该结构开展了热力载荷可靠性仿真分析,最后通过实际产品设计验证,证明 SiP技术在混合集成开关电源产品中应用的可行性。
1 SiP总体架构设计思路
开关电源的基本单元电路组成框图如图1所示。

图1 基本单元电路组成框图Fig.1 Circuit diagram of basic unit
总体架构设计思路:充分发挥 SiP技术优势,研究分析开关电源电路内部标准单元电路构成和内部元器件的规格特性,将磁性器件等以“面积”换取“高度”和控制类器件以“高度”换取“面积”的思路。
SiP总体架构设计剖面如图2所示,通过分析内部标准单元电路构成和内部元器件的规格特性,将开关电源电路标准划分为标准控制单元电路(如反馈控制电路、控制电路、辅助功能电路以及辅助源电路等)及标准功率单元电路(如功率MOS管、功率变压器、功率电感、功率整流管等)。因开关电源属功率电路,在总体架构设计时,充分考虑散热、功率器件的规格特性和内部立体空间,将标准功率转换电路直接布局在散热热沉上,利用3D多腔体结构将微功耗的标准控制单元电路布局于成膜基板或功率器件上(如MOS管、整流管)。

图2 SiP总体架构设计剖面示意图Fig.2 Scheme of SiP overall architecture
标准控制单元电路采用LTCC/HTCC工艺3D多层或多腔体结构、厚膜光刻技术、微组装技术(包含0402、0201及01005小尺寸阻容器件、芯片间互连、芯片堆叠、多温度梯度焊接、基板堆叠、BGA焊接)等技术方式,充分利用立体空间来减小体积,提高组装密度和功率密度,达到“一体化设计架构”或与系统“融合式(嵌入式)设计架构”。结构上以轻、薄为主,最大限度不占用系统的体积和质量,满足系统的“微、小、轻、薄”需求。
2 单元电路标准化设计
由图1所示开关电源电路的基本组成,依据SiP总体架构设计思路,将开关电源电路划分为标准控制单元和功率单元电路。
标准控制单元电路如图3所示,主要是以脉宽调制器为核心,包含其外围电路、供电电源、辅助功能单元电路等。

图3 标准控制单元电路Fig.3 Standard control unit circuit
标准反馈控制单元电路如图4所示,主要是以运算放大器为核心,包含其外围阻容器件构成的比例、积分和微分网络、供电电源、辅助功能单元电路等。

图4 反馈控制电路Fig.4 Feedback control circuit
两个标准控制单元电路基本是以集成芯片为核心,外围一些阻、容器件及部分三极管和二极管构成,通过电路分析和器件特性研究,单元电路功耗小,器件体积小,易于集成,同时具有较强的通用性,可形成开关电源标准单元电路模块,后期整体设计形同“堆积木”。
3 标准单元三维立体结构设计
传统混合集成DC/DC变换器是基于Al2O3成膜基板多芯片组件(Multi-Chip Module, MCM),即在Al2O3成膜基板上组装元器件,实现电路性能指标,如图5所示。但在封装腔体的内部空间的利用率小,难以提高功率密度。由此通过对开关电源内部标准单元电路划分,由平面向空间转换(由 2D—MCM向3D—MCM转换),三维立体结构应用设计如图6,有效面积将减小达75%以上。

图5 MCM平面结构Fig.5 MCM plane structure
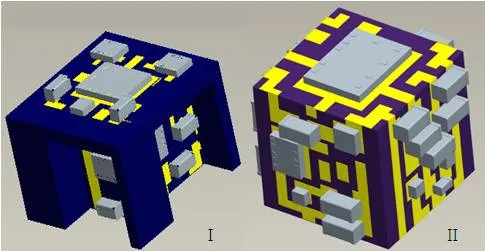
图6 SiP 3D多层结构Fig.6 SiP 3D multilayer structure
三维立体结构是基于LTCC/HTCC多层基板实现六面体结构,将芯片、电阻以及电容等电子元器件布局于结构件六个面上,通过表面及内部的金属化连线,实现电子元器件的电气连接,底部设计BGA(或焊接面),实现与Al2O3成膜基板上功率电子元器件的电气连接。图6所示是设计的两种立体结构,从工艺制作和工艺组装等方面综合考虑,优选第二种。在微组装工艺技术上,应用了多温度梯度组装技术、多层次功能基板一次焊接技术、基于热沉的多器件焊接技术、芯片堆叠技术、芯片与芯片间的互连技术、小尺寸元器件高密度组装技术(以0402/0201/01005器件为代表)、三维立体结构件BGA互连技术等。
4 热与力仿真分析
SiP技术在高可靠混合集成开关电源产品应用尚处于研究阶段,产品的质量可靠性,需满足GJB2438A—2002《混合集成电路通用规范》和GJB548B—2005《微电子器件试验方法和程序》要求,为此对三维立体结构件集成化的设计需要结合力学进行结构分析,结合热学进行热平衡设计,提高产品可靠性和环境适应性[3-4]。
运用PRO-E软件对三维立体结构件进行建模,如图7所示,图中材料组成:三维立体结构件材料为氮化铝(AlN)、陶瓷电容器材料为钛酸钡(BaTiO3)、电阻材料为氧化铝(Al2O3)、厚膜陶瓷基板材料为氧化铝(Al2O3)、封装外壳材料为10#钢、集成芯片材料为硅(Si),借助 Ansys仿真软件对三维立体结构件进行力、热结构可靠性有限元分析[5-6]。
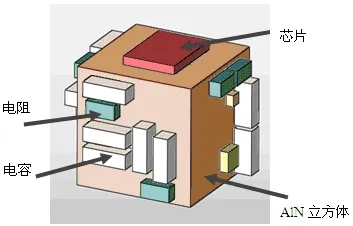
图7 结构模型图Fig.7 Structure model
GJB548B—2005规定H级混合集成电路的力、热环境试验项目和条件要求如下[3-4]:
(1)温度循环:条件C,–65~+150 ℃,100次,t1=(20±1)min,t2≤1 min;
(2)机械冲击:14.7 N(1500 g),半正弦波,持续时间1 ms,y1方向5次;
(3)恒定加速度:49 000 m/s2,y1方向1 min。
4.1 温度循环仿真分析
温度循环试验主要是考核三维立体结构件与表贴元器件之间以及三维立体结构件与厚膜 Al2O3基板之间的热匹配性和器件所承受极端温度的能力[4]。150 ℃是整体结构影响最大的温度点,图8是150 ℃等效应力云图和形变大小云图。
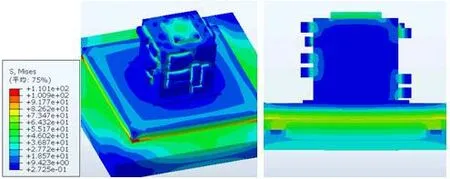
图8 等效应力云图(左)和形变大小云图(右)Fig.8 Equivalent stress nephogram(left) and deformation size nephogram(right)
由于BaTiO3热膨胀系数为(10~12)×10–6/℃,Si热膨胀系数为 2.5×10–6/℃,与 AlN热膨胀系数(4.4×10–6/℃)接近,同时电容、电阻选用最大尺寸为 1 mm×0.5 mm(0402),多为 0.6 mm×0.3 mm(0201),集成芯片最大尺寸为2.5 mm×1.8 mm,仿真结果等效应力最大值约为18 MPa,远小于其断裂模量。厚膜 Al2O3基板热膨胀系数为 6.7×10–6/℃,与AlN相差较小,仿真结果等效应力最大值约为9.4 MPa,远小于其断裂模量。封装材料10#钢热膨胀系数为(10~12)×10–6/℃,从仿真的结果看,等效应力最大位置为 Al2O3基板与封装管壳接触面约为 110 MPa,小于Al2O3陶瓷的抗压强度1500 MPa、抗拉强度300 MPa,该结构件基体本身强度可靠,不会碎裂。实际工程中采用软固定连接方式(粘接和焊接工艺),为此,满足温度循环试验考核要求。
4.2 机械冲击仿真分析
机械冲击试验主要是考核三维立体结构件与表贴元器件之间以及三维立体结构件与厚膜 Al2O3基板之间所承受突然受力或运动状态突然变化而产生冲击力的能力[4],图9是14 700 m/s2最大加速度时等效应力云图和形变大小云图。

图9 最大加速度时等效应力云图(左)和形变大小云图(右)Fig.9 Equivalent stress nephogram(left) and deformation size nephogram(right)at maximum acceleration
三维立体结构件标贴元器件尺寸小,最大质量仅为2.3 mg,仿真得到最大应力值约为12 MPa,小于元器件的粘/焊接强度(不小于24 MPa)。三维立体结构件尺寸小(为4 mm×4 mm×4 mm),整体质量约0.3 g,仿真得到最大应力值约为69 MPa,集中于三维立体结构件的角点处,远小于AlN陶瓷的断裂强度,为此,满足机械冲击试验考核要求。
4.3 恒定加速度
恒定加速度试验主要是考核冲击和振动试验时不一定能检测出的结构和机械类型的缺陷,此应力试验是测定三维立体结构件与表贴元器件之间以及三维立体结构件与厚膜 Al2O3基板之间的机械强度极限值[4]。图10是294 000 m/s2最大加速度时等效应力云图。

图10 等效应力分布云图Fig.10 Equivalent stress distribution nephogram
由于设计的三维立体结构件尺寸小,所设计选用的元器件尺寸小,整体质量小,同时采用软固定连接方式(粘接和焊接工艺),仿真的最大等效应力约为1.35 MPa,小于元器件的粘/焊接强度,为此,满足恒定加速度试验考核要求。
4.4 热仿真分析
通过对电路元器件的功率损耗计算,运用软件对元器件进行热耗分析,结果满足三维立体结构件材料选择合理性和元器件在结构件上热源布局合理性要求。图11所示为模拟仿真该结构温度分布情况。
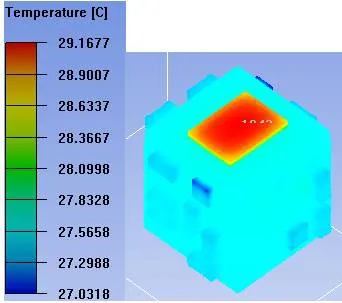
图11 温度分布云图Fig.11 Temperature distribution nephogram
电路分析标准单元电路的各元器件的功耗,通过计算,脉宽调制器功耗最大约为0.2 W,考虑其在整体电路中尺寸最大,制约三维立体结构的整体尺寸,为此布局于结构件的顶部,在结构件的材料选用上,在考虑导热率同时兼顾工艺实施,选用 AlN材料,其导热率达140~230 W/(m·℃),仿真在环境温度25 ℃时,最高温度约29.16 ℃,温升为4.16 ℃,在125 ℃环境温度下,其温度达130 ℃,满足热设计合理性和器件布局合理性要求。
5 应用验证
本实例应用是在37 mm×28 mm×8 mm的体积内集成两路独立输出的DC/DC变换器,将开关电源电路中的标准单元电路划分为标准控制单元电路、标准反馈控制单元电路,采用AlN多层基板,实现六面金属化互连,尺寸为≤4 mm×4 mm×4 mm,在基板表面进行组装芯片等元器件,实物如图12所示。
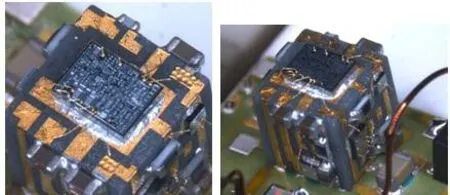
图12 产品实物图Fig.12 Product picture
应用样品电性能测试如表1所示。

表1 样机电性能测试结果Tab.1 Electrical measurements of a prototype
通过对原理样机的电性能测试,对比设计指标,达到研制目标要求。应用样品环境试验结果如表2所示。

表2 样机环境试验Tab.2 Environmental tests of a prototype
对原理样机按H级环境实验条件验证,达到环境试验考核要求。
6 结论
采用 SiP技术对混合集成开关电源的微型化提出一种三维结构设计方法,通过融合设计、集成化设计、减小系统中的过渡和连接,从而降低了寄生参数的影响,提高产品的性能指标,通过优化设计合理布局,结合热力学分析,解决结构的环境应力问题,最后通过实际产品设计验证,证明了 SiP技术在混合集成开关电源产品中应用的可行性。通过SiP技术将混合集成电路设计由平面向空间转换,可以提高空间利用率,减小产品体积。通过标准单元电路模块化设计,可以缩短设计与加工周期,降低成本。
[1] PEDDER D J. System-in-package: a guide for electronics design engineers [R]. London: TWI Ltd, 2009.
[2] 李扬, 刘杨. SiP系统级封装设计与仿真 [M]. 北京: 电子工业出版社, 2012: 21-24.
[3] 中国人民解放军总装备部. GJB2438A—2002: 混合集成电路通用规范 [S]. 北京: 中国标准出版社, 2003.
[4] 中国人民解放军总装备部. GJB548B—2005: 微电子器件试验方法和程序 [S]. 北京: 中国标准出版社, 2005.
[5] 黄志新, 刘成柱. ANSYS Workbench 14.0: 超级学习手册 [M]. 北京: 人民邮电出版社, 2013.
[6] 钟日铭. Pro/ENGINEER Wildfire 5.0从入门到精通 [M].北京: 机械工业出版社, 2015.
SiP technology application research in switch power supply
YUAN Zhuliu1, ZHANG Qi1, YUAN Baoshan1, QU mingshan2, WANG Ning1, LIU Yunpeng1
(1. The 43thResearch Institute of CETC, Hefei 230088, China; 2. Chengdu Hongming & UESTC New Materials Co.,Ltd, Chengdu 610100, China)
By means of studying characteristics of the inner standard unit circuit and the components of switch power supplies with SiP technology, multiple three-dimensional structure was made by LTCC or HTCC techniques, fulfilling IP core circuit 3D structure design in switch power supplies with small size and high space efficiency. Meanwhile, the thermal and force loads reliabilities of this 3D structure were analyzed. Then the verification of an actual product design was passed, and the feasibility of SiP technologies in switch power supplies were testified.
SiP; LTCC; HTCC; standard unit circuit; reliability; switch power supply
10.14106/j.cnki.1001-2028.2018.01.013
TN405
A
1001-2028(2018)01-0066-05
2017-12-01
袁柱六
袁柱六(1980-),男,安徽庐江人,高级工程师,主要研究混合集成开关电源与微系统电源。
(编辑:陈渝生)

