二维h-BN材料p型可掺杂性研究*
肖文君,刘天运,刘雪飞,罗子江
(1. 贵州师范大学 物理与电子科学学院,贵阳 550001;2. 贵州财经大学 信息学院,贵阳 550025)
0 引 言
二维材料由于具有优异的电学,光学,热学和力学特性而受到广泛关注。以sp2杂化形成的石墨烯单层结构于2004年被成功制备[1- 2],其展示出强烈的双极性电场效应激发人们相继成功制备出过渡金属二硫化物[3-6],磷烯[7-8],碳氮化合物[9- 10]。实验上,二维h-BN 被证明具有较好的力学、电学性能[11-13]。然而,在制备单层h-BN过程中不可避免的会引入各种点缺陷,因此对h-BN缺陷相关性质进行研究非常必要。在过去几年来,关于二维h-BN缺陷计算的理论文章被大量报道[ 14-20]。在理论上,预测某种半导体材料是否容易实现n型或p型掺杂,比较有效的方法是对相关缺陷进行带电缺陷计算[21],然而,据文献调研表明,关于二维h-BN中引入各种替位杂质原子的带电缺陷计算鲜有报道。因此,本文基于第一性原理方法,结合带电缺陷计算理论及二维缺陷形成能校正理论,系统计算了在二维h-BN中引入多种潜在p型杂质的带电缺陷体系,计算结果系统解释了难以实现二维h-BN材料的p型掺杂的内在机制。
1 计算结构与方法
1.1 计算结构
计算所用结构如图1所示。图中较大原子为B, 较小原子为N, p-type替位点缺陷被标为XB, 缺陷附近的键长标为l′,远离缺陷的键长被标为l,原始h-BN原胞对应菱形虚线框,正交化以后的原胞对应虚线长方形框,晶格常数被标注为a和b。对二维h-BN 体系掺入各种原子后,先进行结构优化,结果表明各体系在各价态下,远离缺陷处的B-N键几乎与完美h-BN中的键长一致,说明我们所选的超胞尺寸比较合理。除此之外,我们发现缺陷近邻键长将会随替位原子增大而增大,而几乎不受缺陷所带电荷态影响。
1.2 计算方法
本文基于第一性原理方法,使用(Vienna Ab initio Simulation Package,VASP)代码完成计算。所有计算均考虑自旋极化,所选泛函为(Perdew John P., Burke Kieron, Ernzerhof Generalized gradient approximation,GGA-PBE)[22],并采用投影增强波(Projector Augmented Wave,PAW)赝势[23-24]。

图1 二维正交5×5 BN 超胞(100个原子)示意图
为克服PBE方法低估带隙的问题,我们用杂化泛函(Heyd-Scuseria-Ernzerhof,HSE06)[25]进行能带计算。截断能为450 eV,倒空间K点采样密度为2×1×1,并使用Monkhorst-Pack方法。计算中部分结果后处理借助于VASPKIT代码。在结构优化中,所有原子上的Hellman-Feynman受力均小于0.1 eV/nm,能量收敛判据为10-6eV。在计算过程中,为使用Freysoldt和Neugebaue (FN)提出的校正方法对缺陷形成能进行校正,我们将h-BN原胞晶格重新定义为正交形式,并在x-y平面内进行5×5扩胞,在z方向的真空层厚度为3.75 nm,体系包括100个原子。
在超胞中引入一个电荷态q的点缺陷形成能可由下式表达[26-27]
(1)

ΔV0/p=V0|far-Vp
(2)
ΔVd0/p为中性态缺陷远离缺陷位置时的静电势V0|far与完美超胞中静电势Vp之差。μi(i=B,N,Be,Mg,Ca,Sr,C,Si,Ge)是稳定相原子化学势,在平衡态BN体系中满足:
EBN=μB+μN
(3)
其中,EBN表示一个BN原胞的能量。其它杂质原子化学窗口由Pymatgen进行确定[28]。研究表明,现实材料中缺陷数量是很低的,因此缺陷是近似孤立的,式(1)计算了一个有限大超胞的缺陷形成能,缺陷浓度显著高于真实情况,从而引入误差[29-30],因此有必要对形成能进行校正或外推,在本文中我们应用FN方法进行校正:
(4)
(5)


电荷转移能级可表达为:
(7)
其中,Ef(q;Ef=0)和Ef(q′;Ef=0)分别表示q和q′价电态时的形成能。 在缺陷形成能关于电子化学势函数图像中表示斜率发生变化的拐点(见后文),转移能级到CBM和VBM的能量差分别定义为施主和受主离子化能:
ID=CBM-E(q/q′)
(8)
IA=E(q/q′)-VBM
(9)
ID以及IA值越小,表示相应缺陷能级越浅。深能级将俘获载流子,表现为复合中心,将影响半导体材料的掺杂效率。浅能级施主或受主可以为半导体材料提供电子或空穴,从而显著提高半导体材料导电率。
2 结果与讨论
2.1 XB体系缺陷形成能
图2是在h-BN中掺入Be原子后,缺陷形成能(式1)随费米能级(或电子化学势)变化关系图。为克服PBE泛函对带隙(4.64 eV)的低估问题,我们计算了HSE杂化泛函下的h-BN能带,得到其带隙值为5.67 eV,PBE 和HSE 带隙分别用箭头标注在图2中。基于式(1),在给定价态q时,其缺陷形成能随电子化学势变化的图像应该是直线,直线的斜率对应所带点荷价态。我们对各缺陷体系从-2价到+2价进行计算,得到5条类似的直线,所谓最稳定价态是指在给定电子化学势(横坐标)时,缺陷形成能最小的所有价态,如图2 中粗实线所示。另外,由于热力学生长过程中形成能将受到原子化学势的影响,我们分别对富氮条件(a)和贫氮条件(b)进行计算,结果表明BeB体系在富氮体系具有更小的形成能,即在富氮条件下更容易将Be原子掺入h-BN中替换B原子。电荷转移能级是指从某种价态变化到另一种价态所对应的费米能级,体现在图中的直线斜率发生变化的拐点处。结果表明E(0/-1)转移能级在HSE精度下处于价带顶2.61 eV,表现为典型的深能级受主,从而很难为h-BN贡献空穴导电率。相反,在靠近导带底附近,BeB体系具有负的形成能,意味着BeB缺陷将自发的从导带捕获电子进而降低BN的n型掺杂效率,影响其n型导电率。
图3~5分别对应MgB,CaB和SrB缺陷体系的形成能在富氮和贫氮条件下随电子化学势变化的图形。对比可发现,由于替位杂质原子与Be具有类似价电子结构,因此其相应的最稳定价态以及电荷转移能级的分布也都具有相似之处。即最稳定价态均为+1, 0和-1价,只是对应的缺陷形成能随杂质原子半径增大而增大,其原因是Be原子具有和B差异较小的原子半径,因此用Be替换B时,将会引起更小的局部应力。从这个变化趋势来看,我们的计算结果是比较合理的。需要指出的是,后三种缺陷体系在整个电子化学势变化范围内都具有相对较高的缺陷形成能,因此在实际掺杂过程中将很难将相应杂质与B 原子进行替换,因此不再进一步做深入讨论。

图2 BeB体系的缺陷形成能随电子化学势变化图像
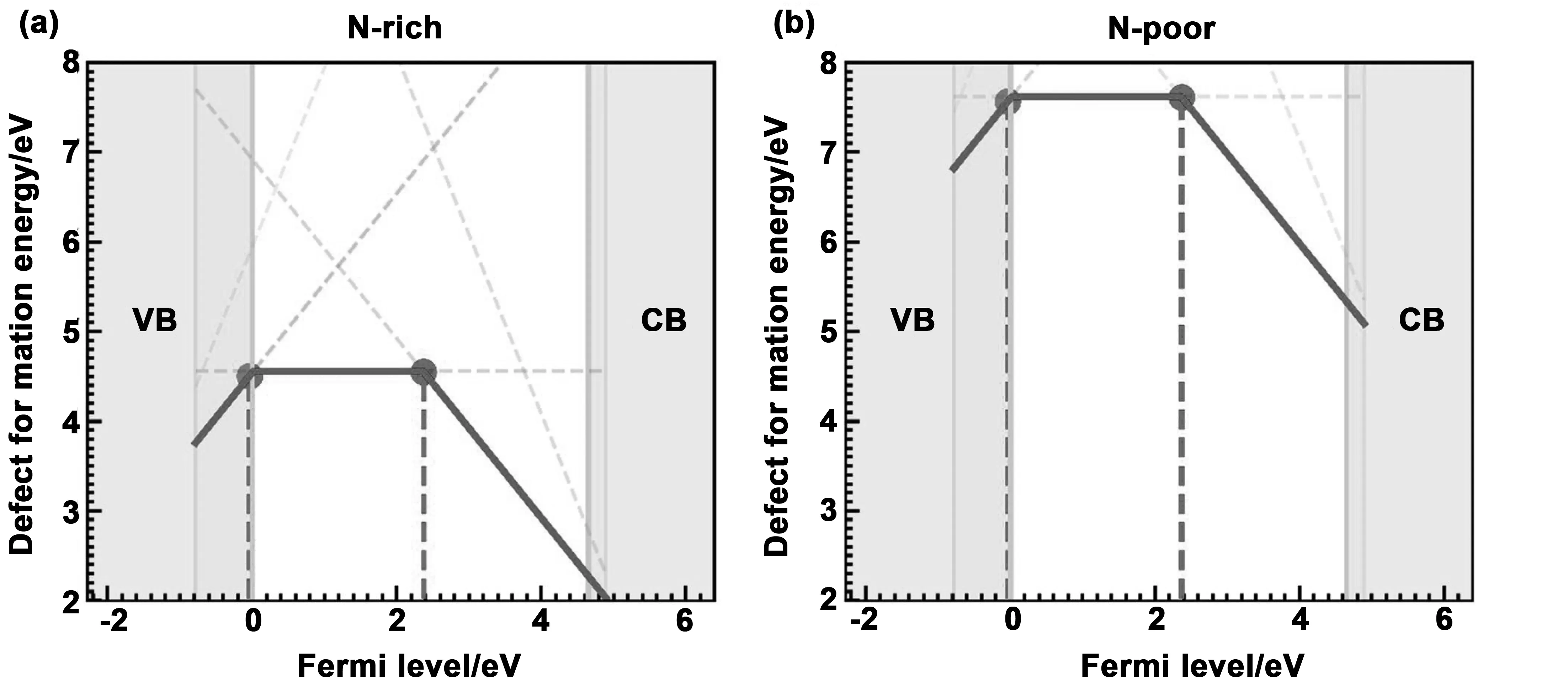
图3 MgB体系的缺陷形成能随电子化学势变化图像
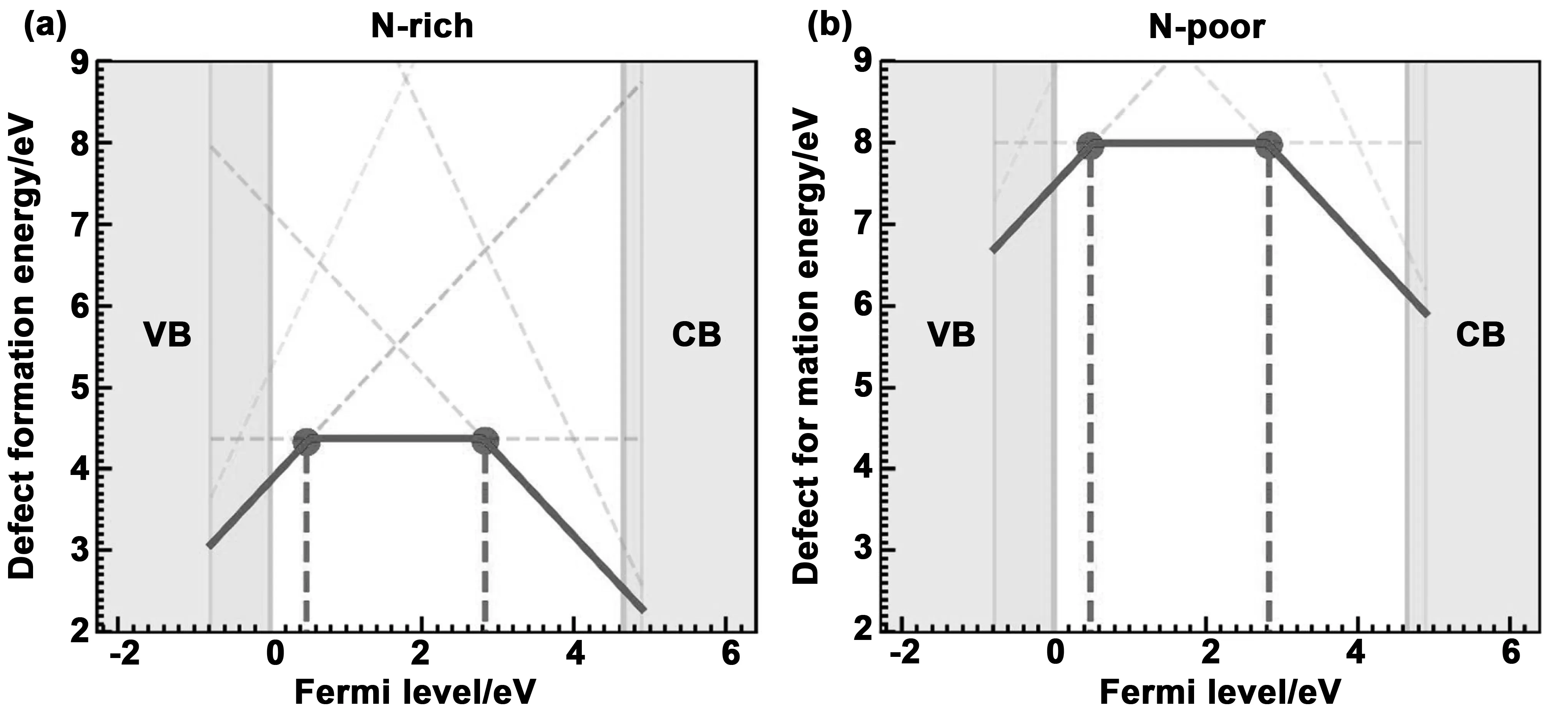
图4 CaB体系的缺陷形成能随电子化学势变化图像

图5 SrB体系的缺陷形成能随电子化学势变化图像
2.2 YN体系缺陷形成能
从原子的价电子排布来看,欲实现h-BN的p型掺杂,除了将II族原子(Be,Mg,Ca,Sr)去替换B引入空穴外,还可考虑将Ⅳ族原子(C, Si, Ge)去替换N原子产生空穴。因此,我们继续计算YN(Y=C,Si,Ge)缺陷体系。其缺陷形成能随费米能级变化的函数关系如图6 到图8所示。结果表明,在对N元素进行替换时,三种缺陷体系的缺陷形成能均是在贫氮的条件更低,这是因为在热力学生长平衡条件下,只有当N原子浓度较低时,其被替换的可能性更大,表明我们计算的结果是合理的。另外,由于C原子具有和N原子更加接近的原子半径,因此是三种缺陷中形成能最小的缺陷。其受主离子化能为3.65 eV,是典型的深能级受主,意味着CN体系将很难为BN贡献空穴载流子。在费米能级处于价带顶附近(p型掺杂BN),CN具有相对较小的缺陷形成能,且对应的价态为+1价,说明CN缺陷将有一定可能从加大捕获空穴或者说将失去电子到价带中复合空穴,从而降低宿主BN的空穴导电率,类似的,当宿主为n型掺杂时(费米能级靠近导带),CN具有-价,且具有较低的缺陷形成能,容易捕获导带中的价电子,从而影响n型载流子导电率。因此,实验上欲实现n型掺杂h-BN,应尽量避免C原子的掺入。当用Si原子替换N时,如图7所示,其受主离子化能相比CN体系变小了,但相应的缺陷形成能有较大幅度的提高,意味着Si原子很难掺入h-BN中对N原子进行替换。另外,SiN体系的最稳定价态只有+1价和-1价,也就是说,一旦通过非平衡方式(比如离子化注入)将Si原子掺入h-BN中成功替换了N原子,SiN缺陷就会带电,从而会对掺杂BN体系载流子进行捕获或补偿,一定程度上影响其掺杂效率。如图8所示,将Ge原子与N 原子进行替换时,其深能级特性比CN更加明显,由于其原子半径比N原子大很多,因此缺陷形成能在整个电子化学势范围内都非常大。
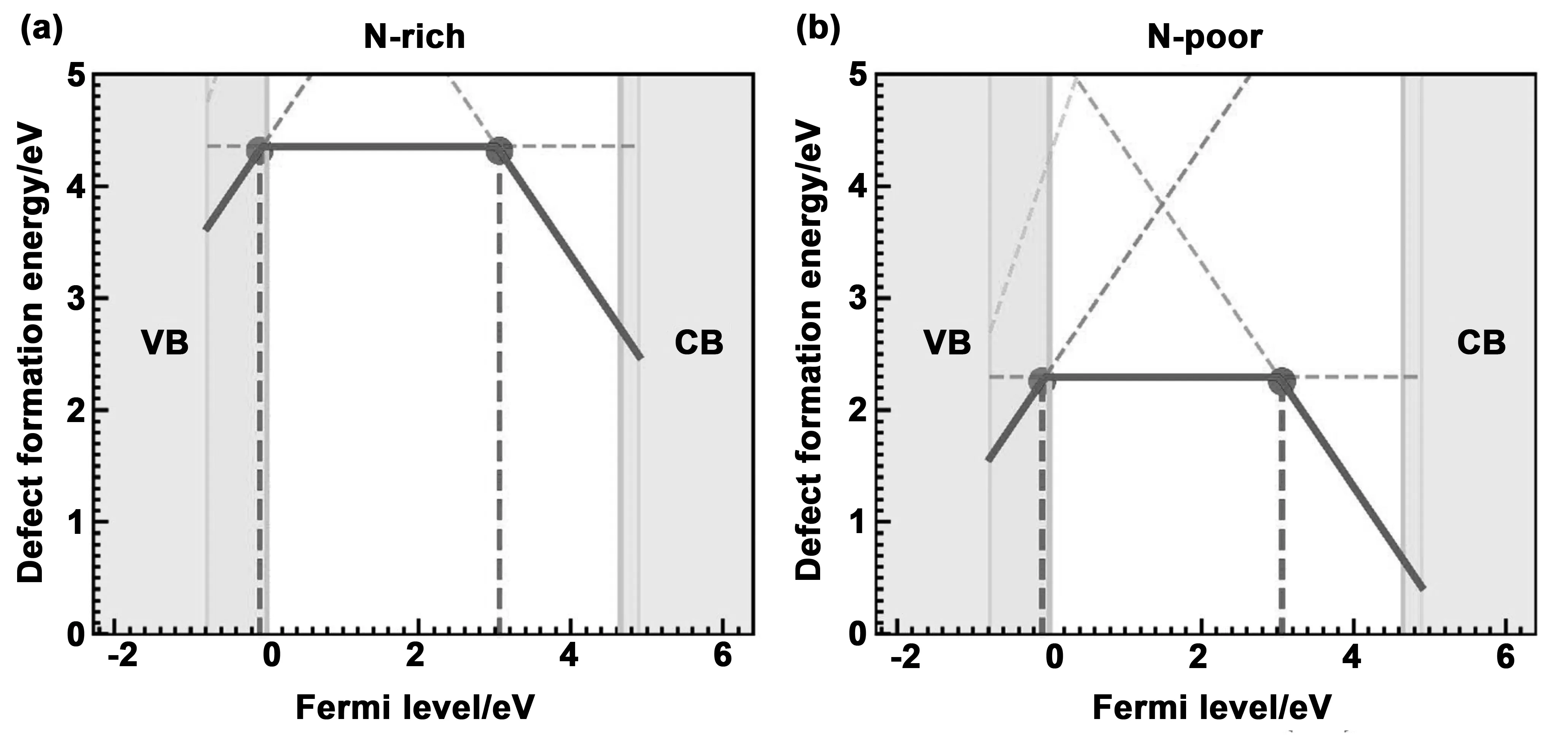
图6 CN体系的缺陷形成能随电子化学势变化图像

图7 SiN体系的缺陷形成能随电子化学势变化图像

图8 GeN体系的缺陷形成能随电子化学势变化图像
2.3 最稳定价态及电荷转移能级
为了方便对比各体系的缺陷形成能的相对大小,图9 对7种缺陷体系的最稳定价态缺陷形成能相对于费米能级的函数关系进行绘制,(a)对应富氮体系,(b)对应贫氮体系。总体来说,BeB体系在富氮条件下在整个电子化学势区间具有最小的缺陷形成能,其中MgB,CaB和CN在富氮条件下具有非常类似的最稳定价态性质。在贫氮条件下,从价带顶到费米能级为4.05 eV时,CN体系是相对容易实现的掺杂缺陷,而费米能级高于4.05 eV 时则CN和BeB具有相同的缺陷形成能,成为BN中主要的可掺杂缺陷。图10进一步总结了本文涉及的两类共7种潜在p型掺杂的电荷转移能级分布规律。对于第一类(XB,X=Be,Mg,Ca,Sr),其两个电荷转移能级均随替位原子半径增大而逐渐靠近导带底,对于第二类(YN,Y=C,Si,Ge)则规律性相对复杂。整体来说,SiN体系的受主离子化能级在PBE泛函精度下小于1 eV,可看成是准浅能级缺陷,考虑到浅能级倾向于跟随带边的变化而变化[31],因此我们推测在HSE真实计算(而非等效转换)时,SiN有可能成为浅能级受主,从而为BN提供一定的空穴。需要提醒的是SiN具有较高的缺陷形成能,需要借助于非平衡掺杂方式实现掺杂。

图9 7种n-type缺陷体系最稳定价态对应的缺陷形成能随电子化学势变化图像

图10 7种p-type体系的电荷转移能级分布图
3 结 论
本文从密度泛函理论出发,借助于VASP软件及二维带电缺陷校正技术系统计算了二维h-BN中的两类共7种潜在p型掺杂体系的缺陷性质。结果表明,BeB是富氮条件下缺陷形成能最低的缺陷,而CN则是贫氮条件下整个电子化学势范围内更容易形成的缺陷。从电荷转移能级来看,除SiN缺陷表现出准浅能级受主外,其它缺陷均为深能级受主,因此无法为二维h-BN体系提供有效的空穴载流子。SiN由于具有较高的缺陷形成能,很难在热力学平衡条件下掺杂到h-BN中,需要借助于非平衡掺杂方式。另外,所有缺陷在n型掺杂宿主h-BN中都表现为电子捕获性,将抑制h-BN的n型掺杂效率,在p型掺杂宿主h-BN中表现为空穴补偿中心,同样会抑制空穴导电率。我们的研究从理论上预测了h-BN中通过单原子掺杂实现空穴导电比较困难,对相关的实验具有非常好的理论指导价值。

