VO2/GaAs异质结的制备及其光电特性研究
李军显,李 毅,2,周建忠,田 蓉,刘 进
(1.上海理工大学 光电信息与计算机工程学院,上海 200093;2.上海理工大学 上海市现代光学系统重点实验室,上海 200093)
引 言
二氧化钒(VO2)是一种具有独特相变特性的半导体材料,其相变温度(Tc)为341 K,当T<Tc时,VO2呈低温半导体态的单斜晶体结构(M1),空间群为P21/c,晶格常数分别为a≈5.75×10-10,b≈ 4.53×10-10,c≈ 5.38×10-10,α=γ=90°,β= 122.6°;当T>Tc时,低温半导体态 VO2向高温正方金红石结构的金属态转变,此时VO2的空间群为P42/mnm,晶格常数分别为a≈ 4.56×10-10,b≈ 4.56×10-10,c≈ 2.85×10-10,α=β=γ=90°,相变进程在纳秒级时间内就能完成[1-2]。相变前后,VO2的光学、电学、磁学等物理特性都将会发生显著变化,利用这种独特的特性使VO2材料能广泛应用于红外智能窗、光学存储器、红外吸收器以及智能辐射器等光电集成器件领域,相关材料和器件受到国内外广大学者的研究[3-6]。
由于钒氧化物具有多种价态和复杂的物相结构,例如常见的有VO、VO2、V2O3以及V2O5等[7],晶体取向、化学组分以及晶粒大小等方面难于控制,因此制备高纯度VO2难度较大。同时,纯净的VO2的相变温度为341 K,远高于室温条件,导致实际应用受到了一定限制,这促使科研人员在降低VO2相变温度方面做了大量研究工作。目前,降低VO2相变温度的方法主要有两种:第一种是通过掺杂阳离子半径比V4+大的金属离子,比如W6+、Nb5+、Mo6+等;第二种是利用复合薄膜的方式来降低VO2的相变温度,比如VO2/AZO、VO2/FTO和VO2/ITO等复合结构。佟国香等[8]利用磁控溅射在FTO导电薄膜上制备钨钒金属膜,再通过退火氧化成功制成W掺杂VO2/FTO复合薄膜,结果表明在FTO导电薄膜上生长的VO2具有较高的晶面取向性,结晶程度高,膜层致密性好等优点,并将VO2的相变温度降低至35 ℃,热滞回线收窄至4 ℃,相变前后红外透过率变化为28%。Soltani等[9]通过反应性脉冲激光沉积在硅、石英、蓝宝石玻璃上成功制备了VO2薄膜和V1-xWxO2薄膜,实验结果表明掺W的VO2薄膜相比于纯VO2薄膜相变温度降低了32 ℃,并且每掺入原子百分比为1%的钨,VO2相变温度减少约22.85 ℃。在1.55 μm波长下,掺钨VO2薄膜相变前后的光隔离度达28 dB,证明了VO2在光纤组件上的应用。袁文瑞等[10]采用直流磁控溅射和热氧化法在AZO上成功制备了VO2/AZO复合薄膜,相变温度下降至43 ℃,热值回线收窄至6 ℃,相变前后电阻值突变达3个数量级。Wang等[11]通过离子束溅射方法在Si3N4/Silica衬底上制备了VO2,结果表明VO2的相变温度降低至34 ℃,在波长为1.55 μm时,VO2薄膜相变前后的光隔离度达15 dB。
目前为止,关于降低VO2相变温度的工艺方法已经有了大量研究并取得了很好的进展,但基于VO2的相变特性去制备异质结器件的研究较少。Zhou等[12]利用化学气相沉积法在Mg掺杂的p型GaN上成功制备VO2/GaN异质结器件并对其能带和光电特性进行分析,结果表明VO2发生半导体-金属相变时,功函数将降低至0.2 eV,同时器件在高低温下均能展现出良好的整流特性,为基于氮氧化物p-n异质结来研究强电子关联系统提供了一个新的维度。Eguchi等[13]利用光电发射光谱研究了基于VO2热致相变特性的n-VO2/p-TiO2:Nb异质结的光载流子注入电子结构,结果表明在光注入时,VO2的价带向更高的能带偏移,在绝缘态时,能量移动作为辐照功率的函数与表面光电压有关,而在金属态中,能量移动与光电流注入相关,该研究提供了利用光电流注入效应将TiO2:Nb的空穴掺杂至VO2的依据。Patel等[14]利用热蒸发技术成功制备了n-VO2/n-MoSe2异质结二极管,不仅在303 K展现了优异的整流特性而且在60 mW/cm2辐照度和正向偏压下展现出最大光响应度和探测率分别为26.24 A/W 和 3.29×1013Jones。Wang等[15]通过氧化物分子束外延技术成功制备了VO2/GaN/sapphire异质结器件,研究了VO2膜层厚度对生长的n-VO2/p-GaN异质结相变性能的影响。实验结果表明VO2薄膜的相变特性对薄膜厚度的依赖性与厚度的增加而产生的拉伸应变松弛有关,同时器件在高低温下所展示出的良好整流特性归因于VO2与GaN界面在低温形成的p-n异质结和高温形成的肖特基结。
众所周知,GaAs材料具备电子迁移率大、高频、耐高低温以及噪声低等优点而被广泛应用于集成电路、红外探测器、光电集成器件。目前,对基于VO2相变特性的VO2/GaAs异质结器件的研究较少,为此,本文通过直流磁控溅射和热氧化工艺在p-GaAs单晶衬底上制备出了性能较好的VO2/GaAs异质结器件,测试和分析了VO2/GaAs异质结器件的微结构、薄膜化学组分和光电特性,从机理上分析了VO2相变特性对VO2/GaAs异质结光电特性所产生的影响。
1 实验方法
n-VO2/p-GaAs异质结的结构示意图如图1所示。其制备工艺流程具体如下。首先,将面积1.5 cm×1.5 cm和厚度0.35 mm的GaAs单晶衬底依次放入丙酮、乙醇、去离子水中利用超声波清洗机各清洗20 min,随后,利用洗耳球将清洗好的样品表面上所附着的残留水珠吹落,再送入电热恒温干燥箱中烘干,设定烘干温度为343 K,干燥时间为40 min;其次,将清洗和干燥完成的样品放入型号为JC500/3-D型溅射镀膜机的溅射腔中进行真空溅射,溅射所采用的靶材是纯度为99.95%金属钒靶,并且溅射是在高纯氩气气氛中进行的,氩气流量和薄膜厚度则可以通过气体质量流量计和FTM-V膜厚检测器进行实时监控,在溅射前,先将溅射腔的压强抽至2.5×10-3Pa,再以80 sccm的流量通入高纯氩气使溅射腔内的工作压强稳定在3×10-1Pa,溅射电压和电流值分别设置为400 V和2 A,溅射时间为2.5 min,全程溅射均在室温下进行;最后,将制备好的样品送入SX2-4-10箱式电阻炉中利用空气进行退火氧化处理,退火时间和退火温度设置范围分别为1~3 h和653~693 K。

图1 n-VO2/p-GaAs异质结的结构示意图Fig.1 The structure diagram of n-VO2/p-GaAs heterojunction
利用多功能X射线衍射仪(DX-2100)和扫描电子显微镜(FEI INSPECT F50)对n-VO2/p-GaAs异质结的晶体结构和表面形貌进行表征。利用X射线光电子能谱仪(PHI 5000 C ESCA)对样品表面上每种元素的相对含量比进行测试。采用UV/VIS/NIR分光光度计(Lambda1050)测量样品的光学性能。精密恒温控制系统(KER3100-08S)则是用于对样品的精确控温,其中控温精度为±0.1 K。采用半导体参数测试仪(Keithley 4200-SCS)来测量n-VO2/p-GaAs的电学特性。
2 结果与讨论
由于磁控溅射所制备的仅仅是金属钒膜,还需高温氧化才能形成VO2薄膜和异质结。不同退火环境下形成的膜层质量也参差不齐,因此需要通过比较不同的退火温度和退火时间下器件的光学特性和相变特性来筛选出最佳退火条件。表1所示为在不同退火温度和退火时间下VO2/GaAs异质结的相变温度和特定波长1 550 nm处相变前后的红外透过率差,由于本文主要是研究具有相变特性VO2的异质结器件,而相变温度和红外透过率差不仅能体现制备工艺的有效性还能反映其是否具备相变特性。从表1中不难发现,样品的最佳相变温度和相变前后的红外透过率差为338 K和10%,最终获得制备VO2/GaAs异质结器件的最佳退火温度和退火时间分别为2 h和693 K。反观其他退火条件下的样品性能都有着较高相变温度和较低的红外透过率差,造成这些较差性能的原因可能是由于退火温度低和退火时间不足等导致VO2无法充分氧化,因此无法形成相变性能优异的膜层,而退火温度过高和退火时间较长都可能会造成VO2过度氧化,导致钒氧化物的化学组分产生变化,使红外透过率变低,相变温度升高。

表1 不同退火温度和退火时间下的相变温度和相变前后1 550 nm红外透过率差Tab.1 Infrared transmittance difference at 1 550 nm and phase transition temperature under different annealing temperatures and annealing times
图2给出GaAs单晶衬底和VO2/GaAs异质结在θ~2θ扫描模式下的X射线衍射(XRD)谱图。其中,图2(a)为GaAs衬底的XRD谱,峰位角2θ位于 32.6°和64.92°的衍射峰分别对应的是(200)和(400)晶面。64.92°峰位角的衍射峰相比于32.6°峰位角的衍射峰具有更高的衍射强度,说明GaAs晶粒在(400)晶面方向的生长具有很高的取向性。图2(b)为 VO2/GaAs异质结的XRD 谱,图中分别给出了(011)、(200)、(220)和(400)四个晶面的衍射峰,与之所对应的峰位角 2θ分别为 28.02°、32.6°、55.64°和 64.92°。根据标准衍射卡和之前的报道可知[16],(011)与(220)代表的是VO2的晶面,而谱中没有发现其他材料的晶面,表明GaAs单晶衬底没有因高温退火而发生降解,并且在(011)晶面上呈现出较高的晶体取向性,最终结果说明GaAs衬底上所制备的VO2薄膜具有较好的结晶度和方向单一性。

图2 θ~2θ 扫描模式 XRD 谱图Fig.2 θ~2θ scan mode XRD

图3 VO2/GaAs 异质结表面扫描电镜图Fig.3 SEM micrograph of VO2/GaAs heterostructure surface
为了进一步研究VO2/GaAs异质结的结构特征,图3展示的是通过扫描电子显微镜(SEM)获得的VO2/GaAs异质结的VO2薄膜形貌图。从图中可以观察到在GaAs衬底上生长的VO2薄膜,其晶粒呈片状结构排列且具有致密性好、尺寸大、缺陷少以及晶界明显等优点,而这些优点都归结于VO2与GaAs单晶衬底有着相似的晶格常数和热膨胀系数,因此GaAs衬底上生长VO2薄膜所需的成核界面能较低,有效促进了VO2原子在GaAs衬底上不断扩散与迁移,通过晶界形成小晶粒,随着小晶粒之间不断联结与合并形成较大的晶粒,而晶粒尺寸的增大则降低了表面自由能并减小了表面态之间的空隙等缺陷。从电镜的结果与分析来看,VO2薄膜具有较好的结晶度与生长质量,表明GaAs单晶衬底在一定程度上促进了VO2薄膜的生长,与XRD图所给出的结果较为一致。
图4为VO2/GaAs异质结的X射线光电子能谱(XPS)分析图。其中,VO2/GaAs异质结的宽程扫描如图4(a)所示,结合能286.4 eV处所对应的是由碳污染引入的C1s,因此测试前需要先对其进行结合能校准。通过标准结合能数据库可知,516.3 eV和530 eV峰位所对应的化学元素分别是V2p3/2和O1s,由此可以推断薄膜内主要以钒氧化物形式存在。此外,图中并未发现其他化学元素,说明VO2/GaAs异质结未因高温退火氧化导致VO2与GaAs衬底之间发生相互渗透和化学反应。图4(b)为VO2/GaAs异质结的窄程扫描,结合能524.5 eV附近对应的V2p1/2峰代表的是V5+,说明薄膜内存在因高温退火而引入的微量 V2O5。图4(c)和(d)分别表示的是在扣除Shirley背景之后对O1s和V2p3/2峰进行的分峰拟合,不难发现,VO2的拟合面积要远大于V2O5的拟合面积,说明所制备的薄膜中主要含量是VO2。与此同时,相比于V2p1/2峰和O1s峰,V2p3/2峰对V元素价态变化最敏感,因此通过公式(2IV4++ 2.5 IV5+)/(IV4++ IV5+)对V2p3/2中IV4+和IV5+的拟合面积可大致估算出VO2薄膜表面中氧与钒的比值为2.04。这稍高的钒氧比值进一步证实了VO2薄膜内主要是以V4+价态的VO2存在并伴随少量因退火过程所引入表面微氧化的V5+价态的V2O5。
图5给出了VO2/GaAs异质结的电学特性。图5(a)为VO2电阻随升、降温变化的曲线,升温初始阶段的VO2薄膜电阻稳定在1.64×106Ω,随着温度升至336 K时,电阻开始急剧下降并最终稳定在9.7×103Ω。降温时,342~368 K区间内VO2薄膜电阻仍保持着较低的电阻,值约为104Ω,当温度降低至342 K时,电阻值发生急剧增加,最终稳定在约106Ω。上述电阻随温度升降所发生急剧性变化的原因是由于低温VO2是半导体态,大量的电子都被束缚在原子周围,导致膜内载流子浓度很低,因此薄膜具有较高电阻率。但温度的升高促使VO2由半导体态向金属态发生相变,由于热激发促使晶格发生振动产生热电子,导致VO2薄膜内电子浓度变高而呈现低电阻态,电阻率急剧减小。反之,温度下降使VO2由金属态向半导体态的转变时,因V 3d轨道的d能带分裂而产生了0.7 eV的禁带宽度,导致热激发效应减弱,降低了膜内载流子浓度,使VO2渐渐还原成高阻态。值得注意的是,升温与降温的相变温度存在差异,而且R-T曲线并不重合而是存在一定的迟滞现象。

图4 VO2/GaAs异质结构的 X 射线光电子能谱图Fig.4 X-ray photoelectron spectroscopy of VO2/GaAs heterostructures
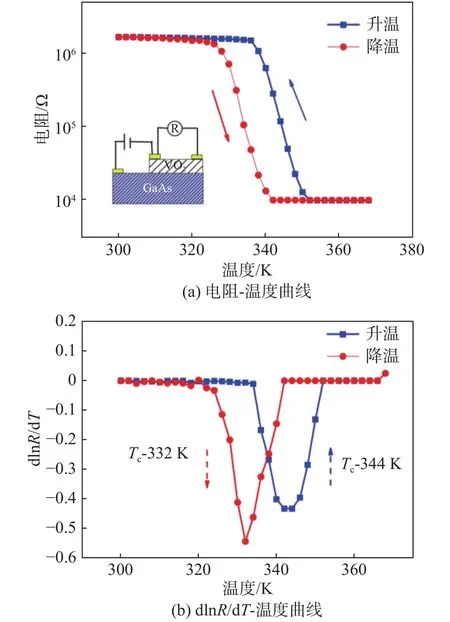
图5 VO2/GaAs 异质结的电学特性Fig.5 Electrical properties of VO2/GaAs heterostructures
通过对图5(a)数据进行高斯拟合绘制出dlnR/dT与温度曲线,如图5(b)所示。图中可以确定的是升温与降温的相变温度Tc分别是332 K和344 K,为了准确说明VO2/GaAs异质结的相变温度,故将器件的相变温度确定在升温与降温的热致回线中间值338 K。此外,升温与降温的相变温度之间的热致回线宽度约为12 K,产生这种热滞回线的原因是升温相变所需的能量高于降温相变时所需的能量。
图6表示的是VO2/GaAs异质结在-9 ~9 V偏压范围内不同温度下的I-V曲线。VO2/GaAs异质结在308 K、318 K和328 K温度下,8 V偏压所对应的电流值分别为126 μA、135 μA和144 μA,而-8 V偏压所对应的电流值分别为1.34 μA、2.12 μA 和 4.31 μA,不难看出正向偏压下的电流值远大于反向偏压下的电流值。同时,对I-V曲线进行线性拟合,从斜率上能够发现正向偏压的电流变化率要高于反向偏压下的电流变化率。上述现象是由于VO2薄膜与GaAs衬底界面形成p-n异质结而产生整流特性,正向偏压的增加导致势垒高度的下降,促进了载流子的扩散和热发射,因此电流快速增加;而反向偏压将会使势垒升高,阻止载流子的扩散和热发射而出现微小电流。值得关注的是,308 K、318 K和328 K温度下的I-V曲线在6.9 V、6.6 V和6.2 V电压处均出现了约一个数量级的电流跳变现象,这可能是由于以下两个效应共同作用产生的:其一,电压促使VO2的晶格发生振动进而产生焦耳热[17],同时叠加的温度导致VO2薄膜到达相变点,发生半导体-金属相变,造成电流的瞬间增加;其二,根据Shockley公式可知,由于VO2/GaAs异质结的存在导致正向电流随着外加电压呈现指数增加。特别地,电流跳变幅度随温度升高而逐渐降低,这是因为当温度不断接近相变温度时,VO2中晶粒已经发生局部热致相变,导致测试电压范围内电流变大,电流跳跃幅度降低。

图6 不同温度下的VO2/GaAs异质结的I-V曲线图Fig.6 I-V curves of VO2/GaAs heterojunction at different temperatures
VO2/GaAs异质结在348 K温度下展示出相变后的I-V曲线与相变前的I-V曲线存在一定差异。相变后的I-V曲线在-8 V和8 V偏压下的电流值分别为48.3 μA和165 μA,均大于相变前的电流值,但未发现电流跳变现象,这是因为此时VO2薄膜是金属态,膜内载流子浓度较大,电阻率较低。从I-V曲线的正反向电流变化率也能明显发现相变后的VO2/GaAs异质结仍具有整流特性,但效果并不明显,这可能是因为高温促使VO2/GaAs异质结转变成金属-半导体的肖特基结,但成结效果欠佳,因此反向漏电流较大[18]。
3 结 论
本文利用磁控溅射在GaAs单晶衬底上制备金属钒膜,再通过在693 K的空气气氛中退火氧化2 h形成相变特性最佳的VO2薄膜,最终成功制成VO2/GaAs异质结。通过对XRD、XPS和SEM的测试结果进行分析并得出结论:GaAs单晶上制备的VO2薄膜具有晶粒紧凑、缺陷少、方向性好、尺寸大以及化学组分单一等优点,说明VO2在GaAs衬底能形成高质量膜层。VO2/GaAs异质结的R-T曲线和I-V曲线表明,该器件在相变前后的电阻值突变约两个数量级,并在308 K、318 K和328 K温度下都具有较好的整流特性,对应温度下的阈值跳变电压分别为6.9 V、6.6 V和6.2 V。与Zhou等[11]和Abhishek等[12]所制备的VO2异质结器件相比,本论文所制备的VO2/GaAs异质结器件不仅具有较好的光电特性,同时还呈现出独特的正向电流跳变现象。该研究结果为基于VO2相变特性的异质结集成光电器件奠定了一定基础。

