首饰基材表面反应磁控溅射SiO2薄膜工艺
袁军平,陈绍兴,金莉莉,代司晖,郭礼健
(1.广州番禺职业技术学院珠宝学院,广东 广州 511483;2.深圳昊翀珠宝科技有限公司,广东 深圳 518000)
表面脏污是佩戴首饰时令人厌烦的问题,而在首饰表面沉积防指纹膜(俗称AF膜)可以有效改善抗脏污性能[1]。用作防指纹膜的材料通常是表面能低的自我限制类有机氟化物,可以与基材表面的羟基等进行缩合反应而成膜[2]。但是对金、银等贵金属及大部分宝石材料而言,它们的表面本身并不能直接与AF膜材料形成稳定的化学键接,必须首先在其表面镀覆一层起到桥接作用的SiO2底膜,才能使得AF膜顺利地沉积到首饰表面并获得一定的结合力[3]。
SiO2薄膜的制备方法有很多种,如物理气相沉积法、化学气相沉积法、氧化法、溶胶凝胶法、液相沉积法等[4],其中物理气相沉积法不仅绿色环保,而且可以与真空蒸镀AF膜在一个腔体中完成,实现无缝衔接。物理气相沉积主要有射频溅射、反应磁控溅射等工艺。前者采用高纯石英做靶材,在低温下制备的SiO2薄膜具有多孔、致密度低等缺点;而当衬底温度较高(300 ~ 600 °C)时,膜层具有均匀致密、纯度高、附着力强、光学特性良好等优点,但是高温易对衬底造成热伤害和电子轰击损伤,且存在设备复杂、运行费用高、沉积速率低等缺点[5]。反应磁控溅射法采用单晶硅靶,可以在较低的温度实施,薄膜厚度的可控性、重复性及均匀性与其他制备方法相比都有明显的改善,因此得到了广泛应用[6]。
目前有关反应磁控溅射SiO2薄膜工艺的研究都是针对微电子器件、集成器件、光学薄膜器件、传感器等的制造,尚未见其在首饰行业中应用的报道。电子器件主要关注薄膜的电绝缘性、击穿电压等介电性能;光学膜层主要关注减反射效果;传感器主要关注负电荷充电与存储能力。而对于首饰行业,不仅基材有别于上述行业,而且薄膜是作为基材与表面防指纹膜的连接桥梁,更关注其键接作用。本文采用反应磁控溅射工艺在S950首饰材料表面镀覆SiO2薄膜,探讨了该工艺在首饰行业的应用。
1 实验
1.1 材料
将S950银合金制成20 mm × 20 mm × 1 mm的试片,经打磨抛光后,用贴纸屏蔽试样边缘以便检测膜层厚度。
1.2 SiO2薄膜的制备
对试样除油、清洗、烘干后放入磁控溅射镀膜室中,抽真空到4.5 × 10−3Pa,充入99.999%的高纯氩气作为工作气体,令气压保持在0.6 Pa,对试样进行等离子清洗,时间为2 min。采用纯度为99.9999%的单晶硅板作为溅射靶材,以纯度为99.999%的氧气作为反应气体。采用正交试验法,通过调整氧气流量、氩气流量、氧气体积分数、溅射电流、镀膜时间等参数在S950银合金基材表面沉积SiO2薄膜,各因素及其水平见表1。

表1 SiO2底膜制备工艺参数Table 1 Parameters for preparing SiO2 base coating
1.3 表征与性能测试
采用OLS5000型激光共聚焦显微镜测量SiO2膜层的厚度,其中镜头倍数选择100×,再测量各试样遮蔽台阶处不同部位的SiO2膜层的平均厚度,计算膜层沉积速率。采用Thermo ESCALAB 250Xi型X射线光电子能谱仪(XPS)检测SiO2膜层表面的化学组成。采用划痕法评价SiO2膜层与基材的附着力,采用Hitachi S3400N扫描电镜(SEM)和Bruker微区能谱仪(EDS)分析划痕区域的形貌和元素组成。
2 结果与讨论
2.1 制备条件的优化
从表2可知,各因素对膜层沉积速率的影响程度从高到低排序为:因素C > 因素A > 因素B > 因素D。随着溅射电流增大,膜层沉积加快。随着氧气流量增大,沉积速率出现先略微上升后下降的趋势。随着氧气体积分数增加,沉积速率先略微上升后基本稳定。而随着镀膜时间延长,膜层沉积速率略微降低。从膜层沉积速率的角度出发,优化工艺为A2B2C3D1,即溅射电流10 A,氧气流量50 mL/min,氧气体积分数30%,镀膜时间90 s。该条件下的膜层沉积速率最快,为12.43 nm/min。

表2 正交试验结果Table 2 Result of orthogonal test
究其原因,高纯氩需要一定的工作气压才能正常启辉放电,在溅射过程中又逐渐被消耗,需要保持一定的氩气流量才能令溅射过程稳定进行下去[7]。本文同时调节氧气流量和氩气流量来达到设定的氧气体积比,当氧气流量小且体积占比小时,氩气流量也小,如3#试样的氩气流量就只有25 mL/min时,只有当氩气流量提高到30 mL/min后,溅射过程才得以连续进行。在反应溅射过程中,靶材表面在被溅射出硅原子的同时,也会与氧发生反应而形成氧化膜。氧气流量小时,硅靶表面氧化成膜速率低;随着氧气流量增大,靶面的氧化成膜速率也增大,影响到溅射产额,但也有利于促进SiO2薄膜的形成;当氧气流量增至75 mL/min时,靶面氧化成膜的速率明显增加,增大了靶材被溅射出来的难度,使得溅射速率下降。随着溅射电流提高,两极之间的电场增强,等离子体产生的电流密度增加,溅射离子的能量和轰击靶材的概率增大,沉积速率随之增加[8]。
2.2 膜层的组成结构
对试样表面进行宽能量范围扫描,通过做全谱分析以确定其元素组成,结果显示各试样表面的元素种类相同,有O、C、Ag、Si、Cu、N、Na等,区别在于不同试样中它们的峰强度有所不同(峰高大致对应其含量)。以1#试样为例,其全谱分析结果如图1所示。其中Ag、Cu为基底的组成元素,C、Na来自污染物,Si来自溅射靶材,O主要来自反应气体,N来自空气残余。不同试样对应的元素峰值强度有差别,表明镀膜工艺参数会影响表面膜层的化学组成。由于是SiO2薄膜,后文只针对硅和氧元素分析具体价态和物质组成。

图1 1#试样表面的全元素谱图Figure 1 XPS survey scan on the surface of sample No.1
如图2所示,各试样的氧元素的结合能峰值基本一致,处于532.1 ~ 532.9 eV范围,其谱图如图3所示。该范围的氧结合能特征峰对应的是氧化硅中的结合氧,说明氧在膜层中的存在方式均为结合氧。

图2 各试样中氧元素的结合能Figure 2 Binding energy of oxygen in samples

图3 氧元素的典型XPS谱图Figure 3 Typical XPS spectrum of oxygen
从图4可知,所有试样的硅元素结合能的起始值和终止值一致,但是峰值有一定的差别,3#、2#和6#试样相对低些。除2#和3#试样外,其余试样只有一个硅峰,位置和形状基本一致。以4#试样为例,对Si元素的谱线进行拟合和分峰处理,得到如图5所示的谱图,可以看出实际峰形与理想峰形的重合度很高,峰位对应的结合能为103.5 ~ 103.7 eV,这是氧化硅的特征光电子峰,它是由Si2p轨道电子引起的。电子的自旋−轨道耦合使得Si2p能级分解为2个能级──Si2p1/2(记作Si2p1)和Si2p3/2(记作Si2p3)。Si2p1峰对应的电子结合能为104.18 eV,Si2p3峰对应的电子结合能为103.38 eV,两者的差为0.80 eV,与这2个能级的标准差值0.62 eV非常接近。

图4 各试样中硅元素的结合能Figure 4 Binding energy of silicon in samples

图5 4#试样的硅元素XPS谱图Figure 5 XPS spectrum of silicon in sample No.4
从2#和3#试样的Si2p谱图(见图6)中可观察到多峰特性,除了具有与4#相同的特征峰外,还在结合能稍低的位置出现了较明显的特征峰,其结合能分别是99.7 eV和99.1 eV,这是单质硅的2p轨道电子被激发而产生的谱峰[9]。因此2#和3#试样的膜层组成包括氧化硅和单质硅。
利用XPS设备的Advantage专业分析软件,根据氧、硅元素的谱峰起点和终点,扣除本底后计算各自的峰面积,以及对应原子灵敏度因子之比,进行归一化处理,得到各元素的归一化面积,从而计算出它们的原子含量的比例[10],结果如图7所示。可以看出2#和3#试样的O/Si原子比明显低于其余试样,只有1.85,其余试样则均超过2,其中9#试样的O/Si原子比达到了2.84。结合图6中金属Si的谱峰,算得2#试样中单质硅原子数占总硅量的26.3%,3#试样则达到了41.95%。

图6 2#(a)和3#(b)试样的硅元素XPS谱图Figure 6 XPS spectra of silicon in samples No.2 (a) and No.3 (b)

图7 各试样表面膜层的O/Si原子比Figure 7 O/Si atomic ratios of the films on different samples
计算各因素及水平下的O/Si原子比偏差之和、各水平下的偏差平均值以及极差,绘制因素水平与膜层O/Si原子比关系的趋势图,如图8所示。可见O/Si原子比随着氧气流量增加而快速增大,随着氧气体积分数增加而略有增加,随着溅射电流及沉积时间增加而降低。
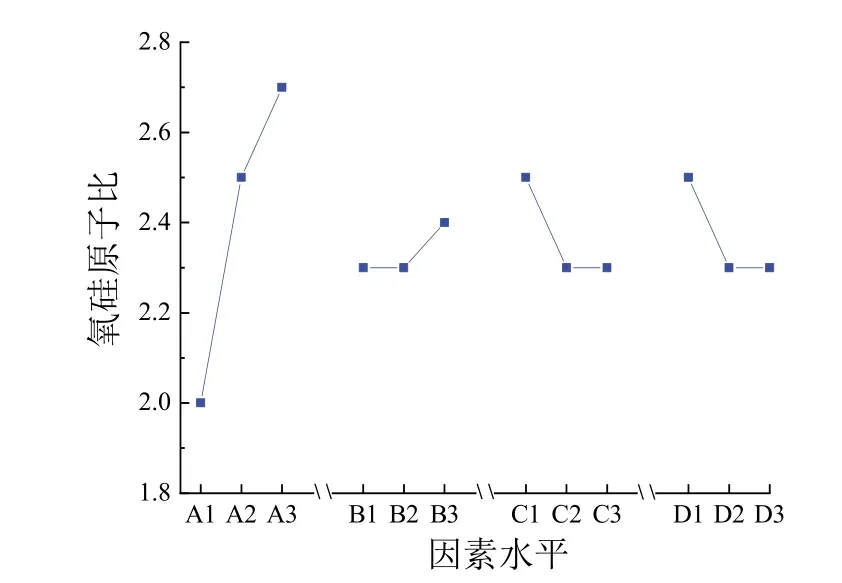
图8 各因素水平对膜层O/Si原子比的影响Figure 8 Effects of levels of factors on O/Si atomic ratio of the film
究其原因,氧气流量与氩气流量需保持在合适的比例才能使反应溅射过程持续进行,同时也对膜层的化学组成产生影响。当氧气流量小且氧气占比小时,靶面处于金属态。如果溅射电流小,则被溅射出来的硅可以被充分氧化,使得薄膜组成接近SiO2的化学计量比;如果溅射电流大,被溅射出来的硅没有得到充分氧化,使得膜层中的O/Si原子比小,甚至出现相当比例的单质硅。当氧气流量达到50 mL/min后,靶面的状态发生很大改变,特别是当氧气体积分数达到30%时,膜层的O/Si原子比偏离正常的化学配比,呈现较明显的富氧态[11]。
反应磁控溅射SiO2薄膜是非晶态的,在理想状态下其内部应无悬挂键、断键、扭曲键、杂质离子等缺陷,但实际制备时,工艺因素的变化将影响膜层结构。在2#和3#试样中,O/Si原子比低于2,膜层中出现了单质硅,会形成Si悬挂键,同时由于O原子缺失,使Si─O四面体中的Si相互作用,形成Si─Si弱键。另外,Si悬挂键还会与Si─O四面体中的O相互作用而形成Si─O弱键,如图9所示。而在9#试样中,O/Si原子比大大高于理想化学配比2,薄膜内由于Si原子缺失而呈现富氧态,形成O悬挂键。这些弱键的存在将在不同程度上影响薄膜性能,也将对表面防指纹膜的镀覆产生影响。

图9 反应磁控溅射SiO2薄膜的化学键类型[12]Figure 9 Types of chemical bonds in SiO2 film deposited by reactive magnetron sputtering
由于膜层达到一定厚度后会影响首饰外观,膜层沉积速率会影响基材本身的氧化程度,而膜层的化学组成和结构将影响防指纹膜的附着力,因此在制定工艺参数时应综合考虑它们的影响。
2.3 膜层结合力
采用划痕法测试5#试样的SiO2膜层与基材之间的结合力,在扫描电镜下观察划痕形貌(见图10)。由于银合金硬度较小,因此在划针划过的地方有明显犁沟,但在2条犁沟之间未出现膜层脱离和剥落。进一步在高倍下观察发现,沟槽边缘出现凸起,并在凸起表面有明显的褶皱,直至正常区域。采用微区能谱半定量检测各部位的组成及含量,结果如图11和表3所示。在沟槽区,膜层被全部划除,因此检测不到硅和氧,只有Ag和Cu这2种元素;在正常区和沟槽边缘区均检测到Si和O元素,且边缘区的Si、O含量略低于正常区。究其原因,由于银合金基材的硬度较小且表面SiO2膜层的厚度非常薄,划针在载荷作用下刺穿SiO2膜层,并进入银合金内一定深度,随着划针移动,基材发生塑性流动,形成犁划沟槽。材料从沟槽中被推挤到了两侧,在边缘堆积挤压而产生褶皱,表面的SiO2膜层随同基材发生流变。由于SiO2膜层的塑性变形性能比基材差,在局部应力集中的地方难免发生开裂脱落。但是在边缘堆积区仍然能检测到Si和O元素,且只比正常区的检测结果略低。这说明SiO2膜层与基材之间有较好的结合力,没有因为犁划而出现整体剥落的问题。

表3 划痕区域的微区能谱分析结果Table 3 EDS results in the scratching area

图10 试样表面划痕形貌Figure 10 Morphology of the scratches on sample surface
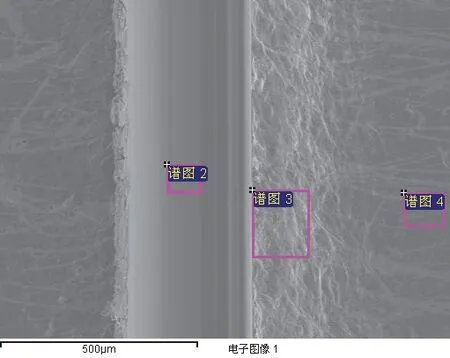
图11 划痕区域的能谱取样位置Figure 11 EDS sampling locations at the scratch area
3 结论
采用反应磁控溅射工艺在S950首饰基材表面沉积SiO2薄膜。溅射工艺会影响所制薄膜的结构和成分,工艺因素匹配不合理时,O/Si原子比偏离理想化学配比,使SiO2膜层中出现金属单质硅或者富氧态,并形成弱键结构缺陷。生产中应根据首饰基材和防指纹膜的要求来相应地设置工艺参数。

