抛光液组分对3D微同轴中铜和光刻胶化学机械抛光速率选择性的影响
李森 ,王胜利 , ,李红亮,王辰伟 ,雷双双 ,刘启旭
(1.河北工业大学电子信息工程学院,天津 300130;2.天津市电子材料与器件重点实验室,天津 300130;3.天津市计量监督检测科学研究院,天津 300192)
目前,射频系统中广泛使用的传输线有波导、同轴线、平面印制电路板(PCB)传输线等,它们都具有技术成熟和成本低廉的特点,但应用于高性能、高集成度射频系统中时都存在一些难以避免的问题。因此,急需一种新型传输系统来取代现有的常规传输体系[1]。为了实现新型超宽带、低插损和高密度集成射频系统集成技术,在DARPA的资助下,2004年Nuvotronics公司提出以微电子机械系统(MEMS)工艺为基础,在矩形铜质外导体中引入内导体及其介质支撑结构,从而获得空气填充的同轴传输线,并将其命名为PolyStrataTM结构。微同轴结构由悬空的中心内导体、接地外导体和周期性介质支撑结构组成[2]。微同轴的加工流程包括光刻、电镀、平坦化、光刻、多次叠层、去胶等。由于微同轴加工采用多层工艺,其中的平坦化处理需要为后续光刻提供光滑的表面,以保证光刻匀胶工艺的稳定性。此外,电镀后每层大于10 μm的高度差并不能满足微同轴的精度要求,必须除去多余的铜,加之光刻胶旋涂时存在误差,在将铜大量去除后还需将铜和光刻胶同时去除5 μm左右,而化学机械抛光(CMP)是目前微电子技术领域唯一能够实现全局和局部平坦化的方法。因此,为满足微同轴的结构精度和性能要求,应对铜/光刻胶软质复合材料进行两步CMP[3]:第一步是去除电镀后多余的铜,第二步是以接近1∶1的去除速率选择比同时去除铜和光刻胶。
微同轴加工所用的光刻胶是重氮萘醌系的正性胶,以酚醛树脂为光刻胶树脂,重氮萘醌为感光剂。酚醛树脂通常以苯酚和甲醛为原料,在催化剂作用下经缩聚反应得到,图1是常见的酚醛树脂合成反应式。目前国内关于光刻胶CMP的研究鲜见报道,大多数是关于光刻胶剥离液的研究[4-5],而光刻胶剥离液大多由有机溶剂、有机碱和/或水组成。目前微同轴铜/光刻胶复合材料CMP的主要问题是没有合适的抛光液。采用铜抛光液抛光时,pH和磨料浓度低,铜的去除速率较高,但是光刻胶难以去除,选择性较差,容易产生铜的凹坑;采用碱性阻挡层抛光液可以实现高的光刻胶去除速率,但是铜的去除速率低,容易产生铜凸起的问题[6-8]。

图1 酚醛树脂合成反应式Figure 1 Formula representing the synthesis reaction of phenol-formaldehyde resin
本文针对微同轴铜/光刻胶复合材料的CMP,采用平均粒径为60 nm的硅溶胶为磨料,以甘氨酸为配位剂,30%的双氧水为氧化剂,氢氧化钾为pH调节剂,研究了各自用量和pH对铜和光刻胶去除速率的影响,以获得较优的抛光液。
1 实验
在法国Alpsitec公司生产的E460E抛光机上采用美国陶氏化学公司的IC1010抛光垫进行CMP试验。以直径76.2 mm、厚1 μm的电镀铜镀膜片以及厚6.5 μm的AZ9260正性光刻胶片(见图2)为抛光对象。抛光工艺参数为:抛光压力1.5 psi(约10.34 kPa),抛头转速57 r/min,抛盘转速63 r/min,流量300 mL/min,时间60 s。

图2 AZ9260光刻胶的金相显微镜照片Figure 2 Metallograph of AZ9260 photoresist
使用美国4D公司的333A四探针测试仪测量抛光前后铜镀膜片上81点的厚度,取平均值后计算铜的抛光速率。使用美国Ambios Technology公司的XP-300台阶仪测量抛光前后光刻胶上5个点的厚度,取平均值后计算光刻胶的抛光速率。
2 结果与讨论
2.1 纳米SiO2磨料的质量分数对铜和光刻胶去除速率的影响
图3是固定pH = 10,甘氨酸质量分数为2%,双氧水体积分数为20 mL/L时铜和光刻胶的去除速率随SiO2磨料质量分数的变化曲线。随着SiO2磨料质量分数的增大,光刻胶的去除速率快速上升,铜的去除速率缓慢增大。这是因为SiO2磨料质量分数的增大使抛光垫和晶圆之间的有效粒子增多,加强了CMP过程的机械作用,而光刻胶的硬度较低,其去除速率随机械作用增强有较大的提升。铜的去除主要通过化学反应,受机械作用的影响较小[9]。当SiO2磨料的质量分数为5%时,两种材料的去除速率最接近,因此选择SiO2磨料质量分数为5%。

图3 SiO2质量分数对铜和光刻胶去除速率的影响Figure 3 Effect of mass fraction of SiO2 on removal rates of Cu and photoresist
2.2 pH对铜和光刻胶去除速率的影响
图4为pH不同,SiO2磨料质量分数为5%,甘氨酸质量分数为2%,双氧水体积分数为20 mL/L时铜和光刻胶的去除速率。光刻胶的去除速率随着抛光液pH升高而快速增大。如图5[10]所示,正性光刻胶以酚醛树脂作为感光树脂,酚醛树脂中的羟基与苯环直接相连,由于共轭效应,氧原子上的未共享电子对会移向苯环,使氢原子易变成H+,在碱性溶液中与OH−作用,令酚醛树脂发生水解反应,致使整个酚醛树脂分子链被破坏,最终由高分子物质分解生成小分子物质,硬度随之减小,也就更容易被SiO2磨料去除[11]。铜的去除速率随着pH升高而略降。CMP过程中铜表面发生的化学反应如式(1)至式(6)[12]所示。可知当抛光液pH升高时,其中的氢氧根浓度升高,使得Cu(OH)2的电离平衡向左移动,溶液中的Cu2+减少,减缓了Cu2+与甘氨酸的配位反应,故铜的CMP去除速率略降。当pH = 10时,铜与光刻胶的去除速率最接近,因此选择pH为10。

图4 pH对铜和光刻胶去除速率的影响Figure 4 Effect of pH on removal rates of Cu and photoresist

图5 高pH影响光刻胶去除速率的机理示意图Figure 5 Schematic diagram showing the mechanism of the effect of high pH on removal rate of photoresist

2.3 H2O2的体积分数对铜和光刻胶去除速率的影响
图6为pH = 10、SiO2磨料质量分数为5%及甘氨酸质量分数为2%的条件下,光刻胶和铜去除速率随H2O2体积分数的变化。从中可知,当抛光液中无H2O2时,光刻胶的去除速率为5 427 Å/min,加入5 mL/L H2O2后光刻胶的去除速率增大,并且随H2O2体积分数增大,光刻胶的去除速率稳定增大。这是由于H2O2中过氧键的键能比普通碳氧键的键能低很多,在CMP过程中产生•OH(羟基自由基)。•OH会与光刻胶中的酚醛树脂发生游离基链锁反应(如图7所示),•OH会抢夺酚醛树脂苯环上的H,从而生成新的自由基和水,新生成的自由基再与体系中的分子作用,生成一个新的分子和一个新的自由基,周而复始,直到2个自由基互相结合形成分子。因此在CMP过程中,酚醛树脂分子链易发生断裂或过度交联,其晶格结构会发生改变,导致硬度降低[13],令光刻胶的去除速率显著提高。铜的去除速率在H2O2体积分数较小时呈增长趋势,增长幅度比光刻胶更大,当H2O2体积分数由0 mL/L增大至20 mL/L时,去除速率由132 Å/min增大到6 663 Å/min,之后随着H2O2体积分数的升高,铜的去除速率逐渐降低。由式(1)至式(6)可知,当溶液中没有双氧水时,铜无法与之反应生成Cu2O、CuO和Cu(OH)2,高硬度的铜很难被SiO2磨料通过机械作用去除,所以铜的去除速率很低。而当双氧水浓度过高时,Cu2+与甘氨酸配位的速率小于铜被双氧水氧化的速率,部分Cu(OH)2附着在铜表面,在一定程度上抑制了化学反应,使铜的去除速率降低[14]。当H2O2的体积分数为20 mL/L时,铜和光刻胶的去除速率更接近1∶1,因此H2O2的体积分数定为20 mL/L。
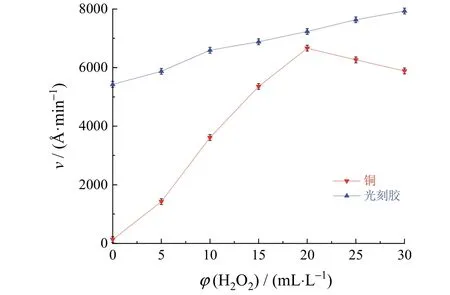
图6 H2O2体积分数对铜和光刻胶去除速率的影响Figure 6 Effect of volume fraction of H2O2 on removal rates of Cu and photoresist

图7 CMP过程中光刻胶与H2O2的反应方程式Figure 7 Reaction equation between photoresist and H2O2 during CMP process
2.4 甘氨酸的质量分数对铜和光刻胶去除速率的影响
抛光液pH = 10,SiO2磨料质量分数为5%及双氧水体积分数为20 mL/L时,铜和光刻胶去除速率随甘氨酸质量分数的变化见图8。从中可知,随甘氨酸质量分数增大,光刻胶的去除速率较稳定,始终保持在7 000 ~7 500 Å/min之间,表明甘氨酸质量分数对光刻胶去除速率的影响较小。铜的去除速率则随着甘氨酸质量分数的升高而快速增大,在甘氨酸质量分数高于2.5%后趋于平缓。由式(6)可知,当甘氨酸浓度过高时,没有足够的Cu2+与之配位,因此铜的去除速率基本不变。当甘氨酸质量分数为2.5%时,铜的去除速率为7 415 Å/min,光刻胶的去除速率为7 226Å/min,两者的去除速率之比接近1∶1,满足3D微同轴CMP的要求。

图8 甘氨酸质量分数对铜和光刻胶去除速率的影响Figure 8 Effect of mass fractions of glycine on removal rates of Cu and photoresist
3 结论
研究了抛光液的pH、SiO2磨料质量分数、甘氨酸质量分数和H2O2体积分数对3D微同轴加工中铜和光刻胶去除速率的影响。结果表明,SiO2质量分数、pH或H2O2体积分数的升高能有效提升光刻胶的去除速率,其中SiO2质量分数的影响最大,甘氨酸质量分数对光刻胶去除速率的影响不明显。当SiO2或甘氨酸的质量分数增大时,铜的去除速率先增大后趋于平缓,而pH的升高使得铜的去除速率略降。当H2O2体积分数增大时,铜的去除速率快速增大后逐渐减小。较佳的抛光液组成为5%(质量分数)的SiO2磨料、2.5%(质量分数)的甘氨酸和20 mL/L的H2O2,pH = 10。此时铜和光刻胶的抛光速率非常接近,分别为7 415 Å/min和7 226 Å/min,满足3D微同轴CMP的要求。

