机械磨抛对CdZnTe薄膜阻变特性的影响
孔 帅,吴 敏,聂 凡,曾冬梅
(北京石油化工学院新材料与化工学院,北京 102617)
0 引 言
CdZnTe晶体材料由于原子序数大、电阻率高、禁带宽度大等优点在核辐射探测、太阳能电池器件等领域有着广阔的应用前景[1-4]。与CdZnTe单晶相比,CdZnTe薄膜制备方法简单,容易大面积成膜,使其在大面积医用CT成像、薄膜阻变存储器等领域引起了广泛的关注。CdZnTe薄膜的制备方法主要有金属有机物化学气相沉积法、电化学沉积法、真空蒸发镀膜法、近空间升华法、磁控溅射法。磁控溅射法制备CdZnTe薄膜具有制备工艺重复性好、可在大面积衬底上获得厚度均匀的薄膜、薄膜与基片的结合力好、不易脱落、致密性较好等优势[5-7],适用于商业化生产。然而,制作CdZnTe薄膜器件对薄膜的品质要求很高,特别是薄膜的结晶质量和表面态对薄膜器件的性能有着极其重要的影响[8]。通常在制备CdZnTe薄膜器件的过程中,薄膜的表面处理过程会在其表面引入表面损伤层和非化学组分比,降低器件性能[9]。因此,探索合适的方法和工艺条件对CdZnTe薄膜表面进行处理,对于CdZnTe薄膜器件的制备具有重要的意义。
目前,对CdZnTe薄膜表面处理研究的相关文献较少,Yang等[10]采用不同粒径Al2O3抛光粉和对CdZnTe厚膜进行1~3 h的机械磨抛,发现采用粒径为50 nm的Al2O3对CdZnTe厚膜进行3 h磨抛,制备的CdZnTe厚膜探测的漏电流最小,紫外灵敏度最高。Li等[11]用化学抛光的方法对CdZnTe薄膜进行表面处理,发现合适的化学抛光时间可以降低CdZnTe薄膜的表面粗糙度、表面缺陷和漏电流,提高CdZnTe薄膜的光电性能。为了深入理解表面处理影响器件物理性能的内在原因,研究机械磨抛对磁控溅射法制备的CdZnTe薄膜结构及性能的影响,揭示CdZnTe薄膜器件未来可能的发展方向,本文采用20 nm粒径Al2O3对CdZnTe薄膜进行机械磨抛表面处理,探究机械磨抛对CdZnTe薄膜形貌、结构和阻变特性影响及物理机制。
1 实 验
1.1 实验原料与制备方法
采用射频磁控溅射法在ITO玻璃衬底上沉积CdZnTe薄膜。沉积过程采用Cd0.9Zn0.1Te(纯度99.99%)晶体靶,靶材的直径为54 mm,厚度为2 mm。溅射前真空腔室的本底真空为6.0×10-9Pa,溅射气体为纯度99.999%的Ar气,靶材与衬底之间的距离为40 mm。依次使用丙酮、甲醇和去离子水超声清洗ITO玻璃衬底,用氮气吹干燥,在磁控溅射制备CdZnTe薄膜过程中,溅射工艺参数为:工作气压1.5 Pa,氩气流量15 mL/min,溅射功率40 W,溅射时间1 h,衬底温度维持在100 ℃。薄膜沉积完成后在氩气的氛围下100 ℃退火1 h,制备的CdZnTe薄膜厚度约为580 nm。
将粒径尺寸为20 nm的Al2O3配制成质量分数为2%的磨抛液,采用磨抛机对CdZnTe薄膜进行10 min机械磨抛,在磨抛过程中连续添加抛光液。磨抛完成后,在CdZnTe薄膜上涂敷导电银浆作为顶电极。
1.2 性能测试与表征
采用德国Bruker D8型X射线衍射仪(XRD)分析CdZnTe薄膜结构。X射线源为Cu靶,波长为1.540 56 nm,采用θ/2θ扫描,扫描步长为0.02°,停留时间为1 s,衍射角范围为10°~60°。CdZnTe薄膜的表面形貌采用日本岛津SPM-9500 J3型原子力显微镜(AFM),在轻敲模式(tapping mode)下表征。利用UV-2600(日本岛津)紫外可见分光光度计测试薄膜的透过率,检测波长范围为300~1 200 nm,阈值为1 T,狭缝宽为2.0 nm,检测单元为外置,光源检测波长为362 nm,检测器转换波长为880 nm。薄膜的Raman光谱采用RM2000(英国雷尼绍)拉曼光谱仪测试,测试波长范围为100~1 200 nm,激光功率为160 W。利用KEITHLEY4200-SCS(英国吉时利)半导体分析测试系统表征CdZnTe薄膜的电学特性。
2 结果与讨论
磨抛前后CdZnTe薄膜的XRD图谱如图1所示。CdZnTe晶体为立方相闪锌矿结构,晶粒沿(111)晶面择优生长。与标准PDF卡片比对发现,薄膜试样在2θ=24°、40°、47°处分别为CdZnTe的(111)、(220)和(311)晶面衍射峰。对XRD检测结果通过Jade软件进行物相检索,确定CdZnTe薄膜在(111)、(220)和(311)的衍射峰及各衍射峰的半峰全宽(full width at half maximum, FWHM)。表1为机械磨抛前后CdZnTe薄膜的XRD数据,结果表明CdZnTe薄膜(111)晶面的FWHM由磨抛前的1.606°减小到磨抛后的0.952°,且磨抛后(111)晶面衍射峰强度明显增强,表明CdZnTe薄膜经机械磨抛后结晶质量提高。值得注意的是,磨抛前CdZnTe(111)衍射峰位为24.367°,磨抛后(111)晶面衍射峰偏移到24.606°,这可能是由于薄膜内部晶格畸变。
根据衍射峰FWHM及衍射峰位计算CdZnTe薄膜的应变(ε)[12]:
(1)
式中:w为衍射峰的FWHM;θ为掠射角。将磨抛前后CdZnTe(111)晶面衍射峰FWHM及衍射峰位数据代入式(1),可知磨抛前薄膜的应变为0.402,大于磨抛后的应变(0.238)。

图1 机械磨抛前后的CdZnTe样品的XRD图谱Fig.1 XRD patterns of CdZnTe samples before and after mechanical grinding and polishing
利用谢乐公式计算CdZnTe薄膜的晶粒尺寸,获得磨抛前后CdZnTe膜晶粒尺寸的平均值分别为28 nm和56 nm。位错密度(δ)定义为晶体单位体积内位错线的长度,由式(2)来计算[13]:
(2)
式中:D为晶粒尺寸。将磨抛前后晶粒尺寸的平均值28 nm和56 nm代入式(2),可得磨抛前后CdZnTe薄膜的位错密度分别为1.27×10-9nm和3.19×10-10nm。磨抛后的CdZnTe薄膜具有较小的应变和位错密度,可能是磨抛过程中的研磨压力在薄膜表面产生了塑性变形,释放了CdZnTe薄膜内部的残余应力,使得抛磨后CdZnTe薄膜的位错密度减小。

表1 机械磨抛前后CdZnTe薄膜XRD数据Table 1 XRD data of CdZnTe thin films before and after mechanical grinding and polishing
图2为磨抛前后CdZnTe薄膜的AFM照片。可以发现薄膜磨抛前表面呈现岛状凸起,薄膜粗糙度(Ra)为3.42 nm;磨抛处理后,岛状晶粒合并成片状大晶粒,表面平整,薄膜粗糙度(Ra)下降至1.73 nm。
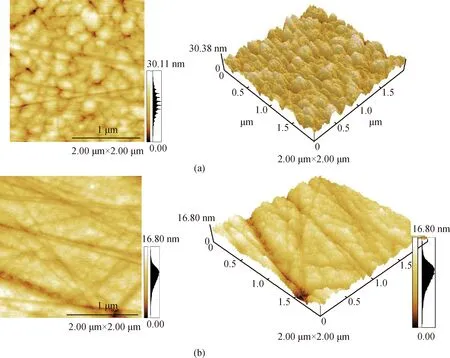
图2 CdZnTe样品的AFM照片。(a)磨抛前;(b)磨抛后Fig.2 AFM images of CdZnTe sample. (a) Before grinding and polishing; (b) after grinding and polishing
图3是磨抛前后CdZnTe薄膜Raman图谱,位于162 cm-1处的振动峰对应于类CdTe的纵声子峰[14]。磨抛后CdZnTe薄膜缺陷减少,结晶质量提高,完美的CdZnTe晶胞数量增多,表现为162 cm-1处Raman峰增强,这与XRD的结果一致。

图3 磨抛前后CdZnTe薄膜Raman图谱Fig.3 Raman spectra of CdZnTe thin films before and after grinding and polishing
图4是机械磨抛前后CdZnTe薄膜透过率图。可以看到,CdZnTe薄膜磨抛前后在350~650 nm波段透过率均为零,在750~850 nm出现吸收边。在650~1 200 nm波段,磨抛后CdZnTe薄膜的透过率要高于磨抛前的透过率。磨抛前CdZnTe薄膜中存在大量缺陷,红外波段入射光波被CdZnTe薄膜中的缺陷吸收,红光及红外波段CdZnTe薄膜透过率较低;CdZnTe薄膜在机械磨抛过程中,由于垂直于表面的分力使Al2O3抛光粒度砂嵌入表面,在薄膜表面产生大量密集的压痕,反复作用后产生疲劳,疲劳区的晶粒通过连续旋转的方式再结晶,晶界或亚晶界合并产生新的晶粒,发生再结晶,形成较高质量的CdZnTe薄膜,透过率提高。

图4 磨抛前后CdZnTe薄膜透过率图Fig.4 Transmission curves of CdZnTe thin films before and after grinding and polishing
图5为磨抛前后CdZnTe薄膜I-V曲线图。磨抛前CdZnTe薄膜的Set电压和Reset电压分别为-0.75 V、0.75 V,磨抛后Set电压和Reset电压分别为-1.35 V、1.45 V。磨抛后Set电压和Reset电压均增大,且磨抛后CdZnTe的开关比约为磨抛前的4倍。从磨抛后CdZnTe薄膜I-V曲线(见图5(b))可以看到,当对器件顶电极施加0 V到0.8 V的正向偏压时,器件处于低阻态(箭头1所示);当偏压从0.8 V增加到2 V时,I-V曲线中的一小部分处于高阻态(箭头2所示);当施加2 V到0 V的反向偏压,器件处于中间阻态(箭头3所示)。施加扫描电压从0 V向-2 V变化时,器件仍处于中间阻态(箭头4所示)。施加扫描电压从-2 V向-1.2 V变化时,器件处于高阻态(箭头5所示);施加扫描电压从-1.2 V向0 V变化时,重新变为低阻态(箭头6所示)。由于银离子被催化,正向电压的高偏压区域器件表现出明显的互补型阻变(complementary resistive switching, CRS)行为[15]。

图5 CdZnTe薄膜的I-V曲线。(a)磨抛前;(b)磨抛后Fig.5 I-V curves of CdZnTe thin films. (a) Before grinding and polishing; (b) after grinding and polishing
为了分析CdZnTe薄膜的导电机理,将薄膜试样I-V特性曲线取对数。图6(a)是磨抛前CdZnTe薄膜正向偏压双对数坐标的I-V曲线。当薄膜处于高阻态时,施加较低电压,双对数I-V曲线斜率为0.9,偏压增加到0.6~1 V时,I-V曲线斜率为4.8。左上角插入的是高阻态ln(I/V)-V1/2关系曲线,磨抛前CdZnTe薄膜高阻态电流呈现Poole-Frenkel行为。当施加高电压时,CdZnTe薄膜内的Cd空位或Te空位与电子相互作用形成的库伦势垒能降低,势能的降低会增加电子被热激发的概率,从而增大被陷阱捕获的载流子进入到CdZnTe导带的几率,此时自由电子增多,电流增大。图6(b)是磨抛后CdZnTe薄膜正向偏压双对数坐标的I-V曲线。磨抛后CdZnTe薄膜高阻态的I-V曲线斜率为1,这主要归因于CdZnTe薄膜的铁电极化效应。磨抛前CdZnTe薄膜缺陷较多,自由电子被缺陷俘获和释放的概率较高,形成了以Poole-Frenkel效应为主的导电机制。磨抛后的CdZnTe薄膜结晶质量显著提高,晶体内的缺陷明显减少,由于Zn2+(0.074 nm)的离子半径小于Cd2+(0.095 nm),在CdZnTe薄膜产生的偶极矩增强,电偶极距对自由电子的影响起主导作用,CdZnTe薄膜的阻变机制转变为铁电极化效应。
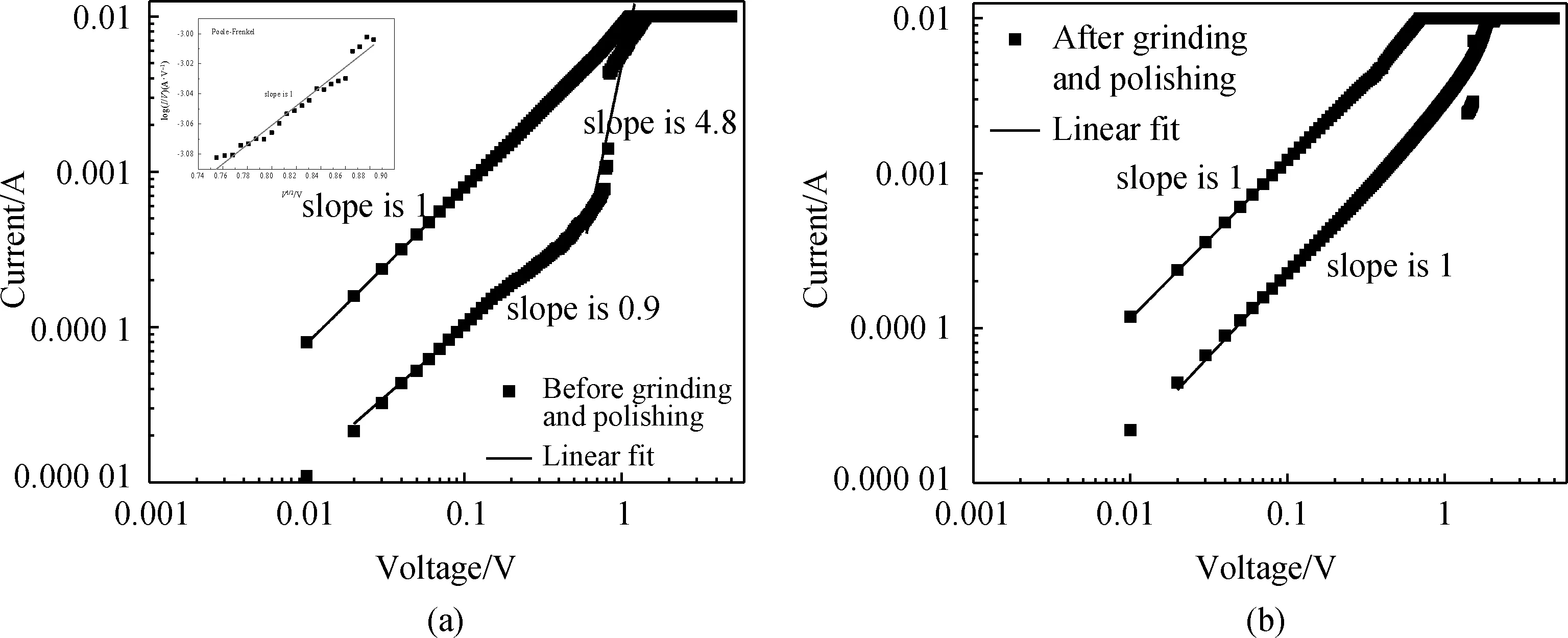
图6 CdZnTe薄膜正向电压双对数I-V曲线。(a)磨抛前;(b)磨抛后Fig.6 Double logarithmic I-V curves of forward voltage of CdZnTe thin films. (a) Before grinding and polishing; (b) after grinding and polishing
3 结 论
用射频磁控溅射法在ITO玻璃衬底上沉积CdZnTe薄膜,获得机械磨抛处理后的CdZnTe阻变器件。CdZnTe(111)晶面的半峰全宽由磨抛前的1.606°变小为磨抛后的0.952°,CdZnTe薄膜中的位错密度由磨抛前的1.27×10-9nm减少到磨抛后的3.19×10-10nm。磨抛后薄膜开关比约为磨抛前的4倍,且在正向电压区薄膜表现出互补阻变行为。CdZnTe薄膜的阻变机制由磨抛前的Poole-Frenkel机制转变为磨抛后铁电极化效应。发生这种转变的主要原因可能是CdZnTe薄膜在机械磨抛过程发生了再结晶,提高了薄膜结晶质量。

